
内存封装市场分析
2020年内存封装市场价值为236.1亿美元,预计到2026年将达到324.3亿美元,在预测期内(2021-2026年)复合年增长率为5.5%。
最近的 COVID-19 爆发预计将在所研究市场的供应链中造成严重失衡,因为亚太地区,特别是中国,是所研究市场的主要影响者之一。此外,亚太地区许多地方政府都对半导体行业进行了长期投资,因此有望恢复市场增长。例如,中国政府筹集了约23至300亿美元的资金,用于支付2030年国家集成电路投资基金第二期的费用。由于市场从疫情中恢复的时间存在不确定性,部分地区的经济受到影响。预计世界还将给半导体市场的增长带来重大挑战,直接影响全球先进内存封装市场所需的关键原材料的供应。
- 存储器件采用了多种封装技术,包括倒装芯片、引线框架、引线键合、硅通孔 (TSV)。随着尺寸的减小和芯片功能的增加,必须对外部电路进行更多数量的电连接。
- 这也带动了封装技术的发展。倒装芯片、TSV 和晶圆级芯片级封装 (WLCSP) 是有前途的技术,可满足更宽的带宽、更快的速度和更小/更薄的封装。易于理解的程序调整、低工程成本和轻松转换正在推动对引线键合内存封装平台的需求。
- 此外,由于封装设计的变化,引线键合存储器封装平台因其灵活性、可靠性和低成本而继续被用作最优选的互连平台。倒装芯片于 2016 年开始进军 DRAM 内存封装领域,由于高带宽要求的推动,倒装芯片在 DRAM PC/服务器中的采用率不断提高,预计该技术将会增长。
- 在众多应用中对高性能计算的高带宽和存储芯片低延迟需求的推动下,硅通孔 (TSV) 正在被用于高带宽存储设备。
内存封装市场趋势
DRAM 预计将占据重要份额
- 所研究的市场见证了来自移动和计算(主要是服务器)的需求。平均而言,到 2022 年,每部智能手机的 DRAM 内存容量预计将增加三倍以上,达到 6GB 左右。
- 最近,研究市场的主导厂商之一三星电子有限公司宣布量产针对高端智能手机的新型内存封装,通过将 DRAM 和 eMMC 放在一起可以节省空间。
- 对于移动应用,存储器封装预计将主要保留在引线键合平台上。然而,它将很快开始转向高端智能手机的多芯片封装(ePoP)。随着企业架构和云计算的改进,预计计算 DRAM 封装在预测期内将出现显着增长。
- 三星的 HBM2 技术由 8 个 8Gbit DRAM 芯片组成,使用 5,000 个 TSV 进行堆叠和连接。最近,该公司还推出了新的 HBM 版本,可堆叠 12 个 DRAM 芯片,这些芯片使用 60,000 个 TSV 进行连接,非常适合 AI 和 HPC 等数据密集型应用。
- 随着新设备提供至少 4 GB 空间,每部智能手机的 DRAM 内存容量有所增加,预计到 2020 年将达到至少 6 GB 至 8 GB 空间,而每部智能手机的 NAND 容量已增加到 64 GB 以上,并且正在增加。预计到2020年将达到150GB以上。对于服务器来说,到2020年,每块DRAM容量预计将增加到1TB左右,企业市场每块SSD的NAND容量预计年底将达到5TB以上预测期间的

汽车行业将占据重要份额
- 在自动驾驶和车载信息娱乐不断增长的趋势的带动下,使用低密度(低 MB)内存的汽车市场可能会发现 DRAM 内存的接受度有所提高。由于NOR闪存在触摸显示驱动IC、AMOLED显示和工业物联网等新领域的应用,预计NOR闪存封装市场也将增长。
- 作为增长战略的一部分,众多 OSAT 厂商正在与存储芯片制造商建立战略联盟,而区域厂商正在与全球技术提供商合作,以扩大其市场影响力。
- 市场上的制造商正在扩大其生产设施。例如,SK 海力士公司正在扩大其在韩国的半导体封装和检测设施的产能。预计此类发展将有助于为现有参与者创造更多机会,并削弱竞争对手在所研究市场中的优势。
- 封装技术中引入的创新与大型片上系统 (SoC) 解决方案功能密度的增长相关。然而,汽车环境中严格的可靠性要求和不断变化的 OSAT 行业格局预计将阻碍预测期内所研究市场的增长。
- 近年来,硅基传感器技术在各种应用中的使用不断增长,包括生物识别传感器、CMOS 图像传感器和加速度计等 MEMS 传感器。传感器设备越来越多地集成到便携式设备中,例如手机和 PDA。在这些应用中,小尺寸、低成本和易于集成对于成功整合这种传感器技术至关重要。
- 一般来说,原始设备制造商更喜欢即插即用模块或完整的子系统,这也是有助于存储芯片市场的一个因素,进而推动增强技术应用对存储封装的需求。

内存封装行业概况
内存封装市场竞争适度。随着DRAM内存价格的不断上涨,内存封装市场的供应商越来越多地投入到3D NAND的开发上。根据SK海力士公司发表的一篇文章,企业已无法满足3D NAND的需求,需要扩大其制造能力。此外,许多公司正在扩大其制造单位,以满足不断增长的需求。总体而言,由于上述所有因素,市场在预测期内可能会变得竞争激烈。
内存封装市场领导者
Lingsen Precision Industries Ltd.
Hana Micron Inc.
ASE Kaohsiung
Amkor Technology Inc.
Powertech Technology Inc...
- *免责声明:主要玩家排序不分先后
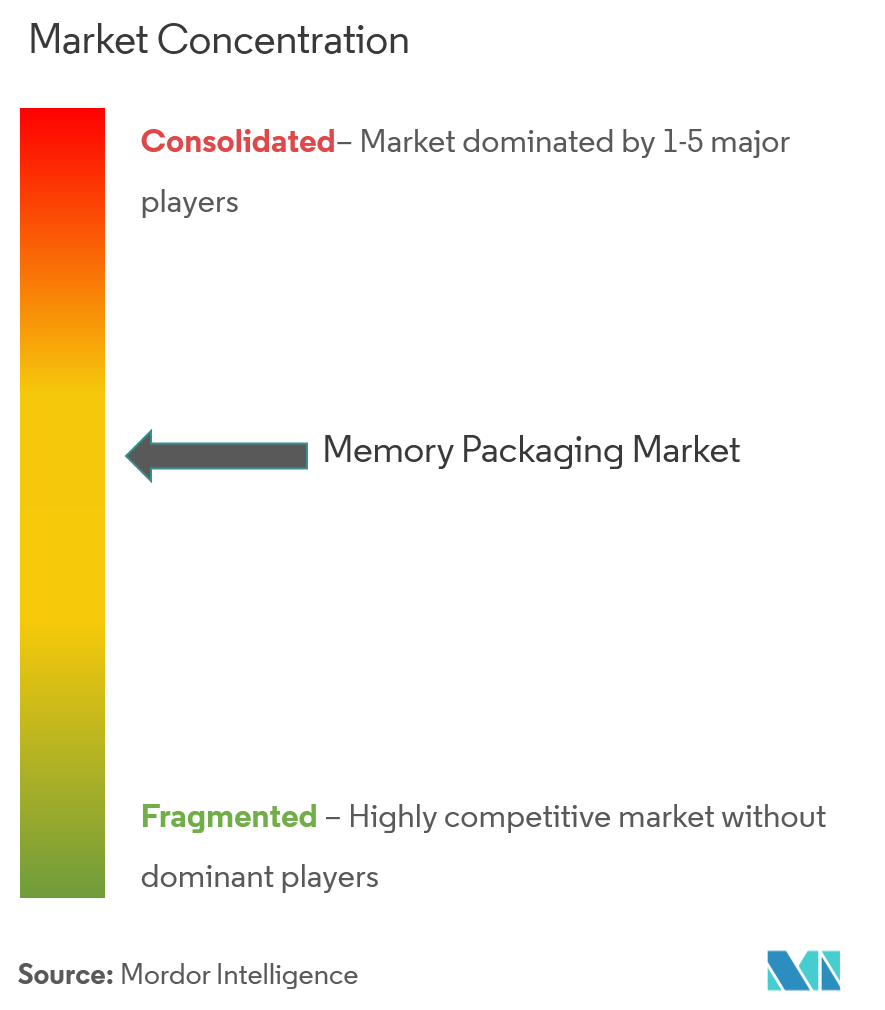
内存封装行业细分
内存模块由微小的半导体芯片组成,这些芯片的封装方式必须能够轻松集成到系统的其余部分。根据要求安装存储器集成电路,使模块正常工作。报告的范围包括基于平台、不同内存类型的应用、最终用户行业和地理位置的分类。该研究还简要分析了 COVID-19 对市场及其增长的影响。
| 倒装芯片 |
| 引线框架 |
| 晶圆级芯片级封装(WLCSP) |
| 硅通孔 (TSV) |
| 引线键合 |
| NAND闪存封装 |
| NOR闪存封装 |
| 内存封装 |
| 其他应用 |
| 信息技术和电信 |
| 消费类电子产品 |
| 汽车 |
| 其他最终用户行业 |
| 北美 |
| 欧洲 |
| 亚太 |
| 世界其他地区 |
| 按平台 | 倒装芯片 |
| 引线框架 | |
| 晶圆级芯片级封装(WLCSP) | |
| 硅通孔 (TSV) | |
| 引线键合 | |
| 按申请 | NAND闪存封装 |
| NOR闪存封装 | |
| 内存封装 | |
| 其他应用 | |
| 按最终用户行业 | 信息技术和电信 |
| 消费类电子产品 | |
| 汽车 | |
| 其他最终用户行业 | |
| 地理 | 北美 |
| 欧洲 | |
| 亚太 | |
| 世界其他地区 |
内存封装市场研究常见问题解答
目前内存封装市场规模有多大?
预计内存封装市场在预测期内(2024-2029 年)复合年增长率为 5.5%
谁是内存封装市场的主要参与者?
Lingsen Precision Industries Ltd.、Hana Micron Inc.、ASE Kaohsiung、Amkor Technology Inc.、Powertech Technology Inc... 是内存封装市场的主要公司。
内存封装市场增长最快的地区是哪个?
预计亚太地区在预测期内(2024-2029 年)复合年增长率最高。
哪个地区的内存封装市场份额最大?
到2024年,亚太地区将占据内存封装市场最大的市场份额。
该内存封装市场涵盖哪些年份?
该报告涵盖了以下年份的内存封装市场历史市场规模:2019年、2020年、2021年、2022年和2023年。该报告还预测了以下年份的内存封装市场规模:2024年、2025年、2026年、2027年、2028年和2029年。
页面最后更新于:
内存封装行业报告
Mordor Intelligence™ 行业报告创建的 2024 年内存封装市场份额、规模和收入增长率统计数据。内存封装分析包括 2029 年的市场预测展望和历史概览。获取此行业分析的样本(免费下载 PDF 报告)。



