
扇出封装市场分析
扇出封装市场规模预计到 2024 年为 29.4 亿美元,预计到 2029 年将达到 63 亿美元,在预测期内(2024-2029 年)复合年增长率为 16.5%。
该市场的扩张是由半导体技术的技术进步和各个领域快速增长的需求推动的。
- 由于高性能、高能效的薄型和小尺寸封装的需求,扇出晶圆级封装 (FOWLP) 在智能手机等占地面积敏感的设备中得到越来越多的应用。此外,平均而言,现代智能手机中可以找到五到七个晶圆级封装(尤其是扇出封装),并且预计这一数字未来还会增加。这是因为它们正在逐渐取代更传统的层叠封装 (PoP) 逻辑存储器解决方案。
- 而且,人工智能和机器学习在各个领域的应用不断增加,增加了高性能计算在市场上的安装量。超高清扇出技术预计将应用于云、5G、自动驾驶汽车和人工智能芯片,并将在预测期内引领封装趋势。
- 韩国半导体行业正在继续努力改进并使3D TSV(硅通孔)、封装和FoWLP(扇出晶圆级封装)和FoPLP(扇出面板级封装)技术更加有效提高半导体的性能和集成度。
- 2021 年 12 月,Nepes Laweh 公司宣布使用 Deca 的 M 系列扇出技术成功生产出世界上第一个 600 mm x 600 mm 大型面板级封装 (PLP)。据该公司称,扇出面板级封装(FOPLP)生产线在第三季度通过了客户认证,建立了稳定的良率,并开始全面量产。
- 由于韩国公司过去依赖外国公司提供这些系统,KOSTEK预计未来将产生巨大的进口替代效应。其临时晶圆键合机和剥离技术可在扇出封装过程中使用。
- 随着COVID-19的爆发,由于货物流动受到限制以及半导体供应链的严重中断,半导体封装市场出现了增长下滑。 2020 年第一季度,COVID-19 导致半导体供应商和分销渠道的客户库存水平较低。由于冠状病毒的爆发,预计市场将受到长期影响。
扇出包装市场趋势
高密度扇出将占据重要份额
- 高密度扇出针对中端到高端应用,每平方毫米有 6 至 12 个 I/O,线路/空间为 15/15 μm 至 5/5 μm。高密度扇出封装因满足手机封装的外形尺寸和性能要求而受到欢迎。该技术的关键构建模块包括重新分布层 (RDL) 金属和巨型柱电镀。
- 台积电的 InFO 技术是高密度扇出最著名的例子之一。该技术针对引脚数较多的应用,例如应用处理器 (AP)。该公司计划将其 FO-WLP 领域扩展到 inFO-Antenna-in-Package (AiP) 和 inFO-on-Substrate 等技术。这些封装用于汽车、服务器和智能手机。苹果是这项新技术的早期采用者之一,该技术在 2016 年底推出的 iPhone 7 的 A10 应用处理器中使用了该技术。
- 正因为如此,2021年12月,高通和联发科都考虑效仿苹果采用台积电InFO_PoP技术封装iPhone芯片的做法,在其旗舰智能手机应用处理器的生产中采用扇出PoP。
- 此外,半导体市场的增长以及高密度扇出封装解决方案的发展预计将推动预测期内的市场增长。例如,2021年7月,全球首屈一指的组合电路制造商和技术解决方案提供商长电科技透露,正式推出XDFOI芯片全系列超高密度扇出封装选项,旨在降低成本为芯片异构集成提供有效的高密度连接、高集成度、高可靠性的解决方案。
- 高密度扇出晶圆级封装 (FOWLP) 的制造方法也取得了进步。正在开发的解决方案旨在减小芯片尺寸/高度并降低生产成本,同时提高可靠性、能源效率、设备速度和多功能集成。例如,SPTS Technologies 为领先的半导体封装公司提供多种等离子蚀刻和沉积工艺技术,用于先进的封装方案,例如高密度扇出晶圆级封装。
- 此外,高密度扇出 (HDFO) 封装可以通过晶圆级处理的制造能力以及使用高铜 (Cu) 柱等穿模互连和穿通封装创建 3D 结构的能力来满足小型化的需求通孔 (TPV) 和先进的倒装芯片封装技术。

台湾将在市场上占据重要份额
- 台湾拥有一些主要的半导体制造公司,这些公司正在推动对先进半导体封装的需求,特别是在 PLP 领域。据政府智库科技国际战略中心预测,2021年台湾产值预计将增长25.9%,达到1,470亿美元。
- 根据半导体行业协会 (SIA) 的数据,亚太地区占全球半导体销售收入的 50% 以上;这反过来又为台湾供应商提供了为增加的半导体应用提供 FOWLP 的机会。
- 该国大多数公司正在扩大扇出封装的产能,这有望进一步增加出口并有助于开发当地市场。例如,最近宣布重返晶圆代工行业的英特尔,将同时在新墨西哥州投资35亿美元建设一座半导体封装工厂,将于2022年下半年开始运营。
- 此外,2021年6月,纯半导体后处理(OAST)的日月光开始投资先进封装设施,以应对半导体的供需短缺。通过从HANMI Semiconductor采购大量用于WLP和PLP工艺的半导体制造设备,加速扩张。
- 此外,第五代 (5G) 无线通信和高性能计算市场的不断增长使制造商能够开发更新的技术。例如,作为高密度扇出领域的唯一领导者,台积电正计划将其 FO-WLP 领域扩展到 inFO-天线封装 (AiP) 和 inFO-on-Substrate (oS) 等技术。

扇出封装行业概述
该市场适度分散,参与者众多。全球扇出封装市场的主要参与者包括台积电、江苏长电、Amkor Technology Inc.、三星电机和力成科技等。这些参与者致力于产品创新、并购等发展,以增加市场份额。
- 2021 年 11 月 - 半导体封装和测试服务供应商 Amkor Technology, Inc. 表示拟在越南北宁建设智能工厂。拟建工厂的初始阶段将专注于为世界一流的半导体和电子制造企业提供先进的系统级封装 (SiP) 组装和测试服务。
- 2021 年 2 月 - 三星代工已向亚利桑那州、纽约州和德克萨斯州当局提交文件,寻求在美国建立领先的半导体制造工厂。德克萨斯州奥斯汀附近的潜在晶圆厂预计耗资超过 170 亿美元,并创造 1,800 个就业岗位。预计2023年第四季度上线。
扇出包装市场领导者
Taiwan Semiconductor Manufacturing Company Limited
Jiangsu Changjiang Electronics Tech Co.
Amkor Technology Inc.
Samsung Electro-Mechanics
Powertech Technology Inc.
- *免责声明:主要玩家排序不分先后
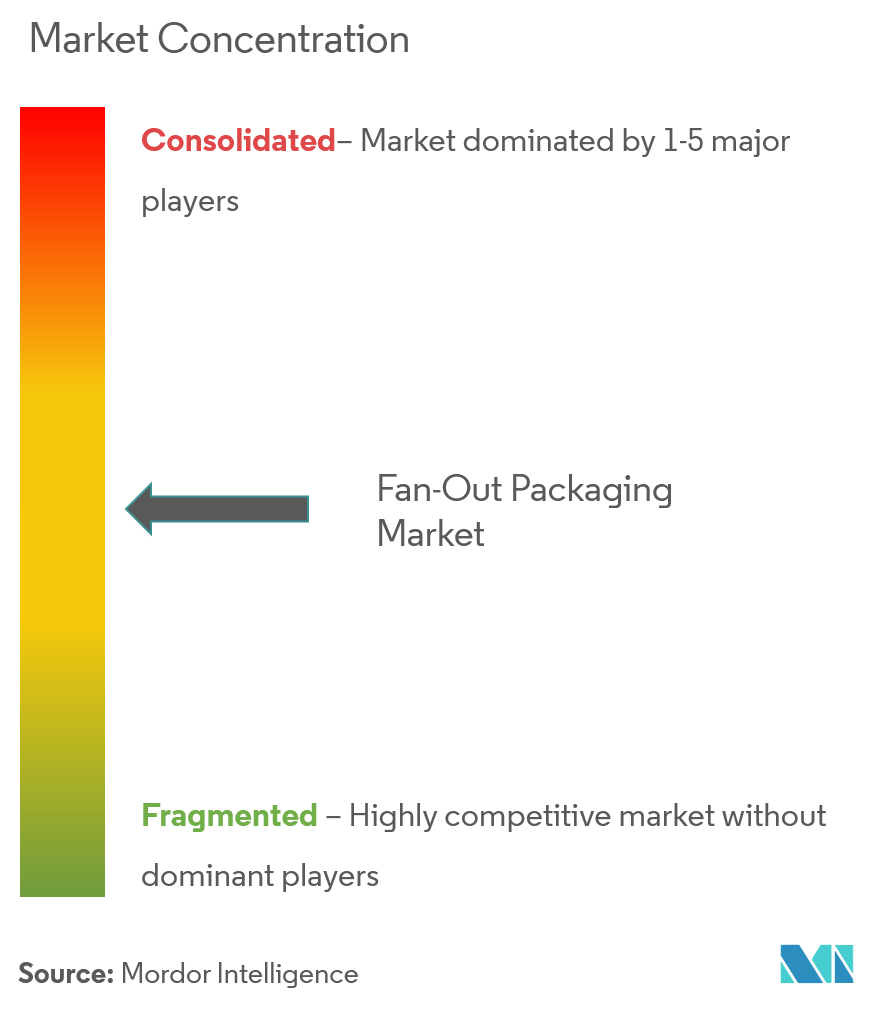
扇出包装市场新闻
- 2022年5月——值得信赖的技术实现合作伙伴SkyWater Technology和Xperi Holding Corporation新成立的品牌Adeia宣布SkyWater已与Xperi Corporation签署技术许可协议。 SkyWater 及其客户将能够使用 Adeia 的 ZiBond 直接桥接和 DBI® 混合键合技术和 IP,以改进下一代商业和政府产品。 SkyWater 佛罗里达工厂正在创建异构集成平台解决方案,包括硅中介层和扇出晶圆级封装 (FOWLP) 技术。
- 2021年7月,全球集成电路制造与创新服务领导者长电科技集团宣布正式推出超高密度扇出封装新技术XDFIOTM。这项突破性技术将为各种芯片组提供具有最大集成度、高密度连接和高可靠性的经济高效的替代方案。
- 2021 年 3 月 - 市场领先的创新半导体封装纯技术供应商 Deca 推出了新的 APDKTM(自适应图案设计套件)方法。 Deca 与先进半导体工程公司 (ASE) 和西门子数字工业软件公司合作开发了该解决方案。
扇出封装行业细分
扇出封装是具有从芯片表面扇出的连接器的任何封装,允许额外的外部 I/O。传统的扇出封装不是将芯片放置在基板或中介层上,而是将它们完全浸入环氧树脂模塑料中。扇出封装市场涵盖市场类型(核心扇出、高密度扇出、超高密度扇出)、载体类型(200mm、300mm、面板)、商业模式(OSAT、Foundary、 IDM)和地理(台湾、中国、美国、韩国、日本、欧洲)。
| 核心扇出 |
| 高密度扇出 |
| 超高密度扇出 |
| 200毫米 |
| 300毫米 |
| 控制板 |
| 组件 |
| 奠基 |
| 集成器件制造商 |
| 台湾 |
| 中国 |
| 美国 |
| 韩国 |
| 日本 |
| 欧洲 |
| 按类型 | 核心扇出 |
| 高密度扇出 | |
| 超高密度扇出 | |
| 按运营商类型 | 200毫米 |
| 300毫米 | |
| 控制板 | |
| 按商业模式 | 组件 |
| 奠基 | |
| 集成器件制造商 | |
| 地理 | 台湾 |
| 中国 | |
| 美国 | |
| 韩国 | |
| 日本 | |
| 欧洲 |
扇出包装市场研究常见问题解答
扇出封装市场有多大?
扇出封装市场规模预计到 2024 年将达到 29.4 亿美元,并以 16.5% 的复合年增长率增长,到 2029 年将达到 63 亿美元。
目前扇出封装市场规模有多大?
2024年,扇出封装市场规模预计将达到29.4亿美元。
谁是扇出封装市场的主要参与者?
Taiwan Semiconductor Manufacturing Company Limited、Jiangsu Changjiang Electronics Tech Co.、Amkor Technology Inc.、Samsung Electro-Mechanics、Powertech Technology Inc. 是扇出封装市场的主要运营公司。
扇出封装市场增长最快的地区是哪个?
预计亚太地区在预测期内(2024-2029 年)复合年增长率最高。
哪个地区在扇出封装市场中占有最大份额?
2024年,亚太地区将占据扇出封装市场最大的市场份额。
扇出封装市场涵盖哪些年份?2023 年市场规模是多少?
2023 年,扇出封装市场规模估计为 25.2 亿美元。该报告涵盖了扇出封装市场的历史市场规模:2019年、2020年、2021年、2022年和2023年。该报告还预测了扇出封装市场的未来几年规模:2024年、2025年、2026年、2027年、2028年和2029年。
页面最后更新于:
扇出包装行业报告
Mordor Intelligence™ 行业报告创建的 2024 年扇出封装市场份额、规模和收入增长率统计数据。扇出包装分析包括 2029 年的市场预测展望和历史概述。获取此行业分析的样本(免费下载 PDF 报告)。



