
Analyse du marché des emballages en éventail
La taille du marché des emballages Fan Out est estimée à 2,94 milliards USD en 2024 et devrait atteindre 6,30 milliards USD dici 2029, avec une croissance de 16,5 % au cours de la période de prévision (2024-2029).
Lexpansion de ce marché est stimulée par les progrès technologiques dans les technologies basées sur les semi-conducteurs et par laugmentation rapide de la demande dans divers secteurs.
- Le conditionnement au niveau des tranches (FOWLP) trouve son application croissante dans les appareils sensibles à l'encombrement tels que les smartphones en raison de la nécessité de boîtiers minces et de petit facteur de forme hautes performances et économes en énergie. De plus, en moyenne, cinq à sept packages au niveau des tranches (en particulier avec répartition) peuvent être trouvés dans les smartphones modernes, et ce nombre devrait augmenter à l'avenir. En effet, ils remplacent progressivement les solutions de mémoire sur logique package-on-package (PoP) plus traditionnelles.
- De plus, lapplication croissante de lintelligence artificielle et de lapprentissage automatique dans divers domaines a accru linstallation du calcul haute performance sur le marché. La technologie de diffusion UHD devrait être appliquée au cloud, à la 5G, aux voitures autonomes et aux puces IA et mènera la tendance en matière d'emballage au cours de la période de prévision.
- L'industrie sud-coréenne des semi-conducteurs continue de déployer des efforts pour améliorer et rendre plus efficaces les technologies 3D TSV (Through-silicon via), d'emballage et FoWLP (Fan-out Wafer-Level Packaging) et FoPLP (Fan-out Panel-Level Packaging). augmenter les performances des semi-conducteurs et le degré dintégration.
- En décembre 2021, la société Nepes Laweh a annoncé la production réussie du premier emballage au niveau du panneau (PLP) de 600 mm x 600 mm de large au monde utilisant les technologies de déploiement de la série M de Deca. La ligne FOPLP (Fan-out-Panel Level Packaging) a passé la certification client au troisième trimestre, a établi un rendement constant et a commencé la production de masse à grande échelle, selon l'entreprise.
- Étant donné que les entreprises sud-coréennes dépendaient autrefois d'entreprises étrangères pour ces systèmes, KOSTEK s'attend à un énorme effet de substitution des importations à l'avenir. Ses techniques temporaires de liaison et de décollage de tranches peuvent être utilisées lors d'un processus d'emballage en sortance.
- Avec lépidémie de COVID-19, le marché de lemballage des semi-conducteurs a connu un déclin de sa croissance en raison des restrictions sur la circulation des marchandises et de graves perturbations dans la chaîne dapprovisionnement des semi-conducteurs. Au premier trimestre 2020, la COVID-19 a entraîné de faibles niveaux de stocks pour les clients des fournisseurs de semi-conducteurs et des canaux de distribution. Le marché devrait subir un impact à long terme en raison de lépidémie de coronavirus.
Tendances du marché des emballages en éventail
Distribution haute densité pour détenir une part importante
- Destiné aux applications de milieu de gamme à haut de gamme, la distribution haute densité comporte entre 6 et 12 E/S par mm2 et entre 15/15 μm et 5/5 μm ligne/espace. Les emballages à sortance haute densité ont gagné en popularité pour répondre aux exigences de forme et de performances des emballages de téléphones mobiles. Les éléments de base clés de cette technologie comprennent le métal de la couche de redistribution (RDL) et le placage des méga-piliers.
- La technologie InFO de TSMC est l'un des exemples les plus remarquables de diffusion haute densité. Cette technologie cible les applications à plus grand nombre de broches, telles que les processeurs d'application (AP). La société prévoit d'étendre son segment FO-WLP à des technologies telles que inFO-Antenna-in-Package (AiP) et inFO-on-Substrate. Ces packages sont utilisés dans les automobiles, les serveurs et les smartphones. Apple a été l'un des premiers à adopter cette nouvelle technologie, qui l'a utilisée dans le processeur d'application A10 de l'iPhone 7, introduit fin 2016.
- En raison de ces avantages, en décembre 2021, Qualcomm et MediaTek ont tous deux envisagé d'adopter le PoP à répartition dans la production de leurs processeurs d'applications phares pour smartphones, suivant les traces d'Apple utilisant la technologie InFO_PoP de TSMC pour emballer ses puces iPhone.
- En outre, la croissance du marché des semi-conducteurs ainsi que le développement de solutions demballage à sortance haute densité devraient propulser la croissance du marché au cours de la période de prévision. Par exemple, en juillet 2021, Changdian Technology, le premier fabricant mondial de circuits combinés et fournisseur de solutions technologiques, a révélé l'introduction officielle de toute la gamme d'options de boîtier de distribution à très haute densité pour les puces XDFOI, destinées à offrir des performances économiques. solutions efficaces, de connectivité haute densité, de haute intégration et de haute fiabilité pour l'intégration hétérogène de puces.
- Des progrès sont également réalisés dans la méthode de fabrication de l'emballage au niveau des plaquettes en éventail à haute densité (FOWLP). Des solutions sont en cours de développement pour réduire la taille/hauteur des puces et réduire les coûts de production tout en améliorant la fiabilité, l'efficacité énergétique, la vitesse des appareils et l'intégration multifonction. Par exemple, SPTS Technologies propose plusieurs technologies de processus de gravure et de dépôt au plasma aux principales entreprises de conditionnement de semi-conducteurs pour des schémas de conditionnement avancés tels que celui du conditionnement au niveau des tranches à diffusion haute densité.
- De plus, les boîtiers HDFO (high-density fan-out) peuvent répondre à ces besoins de miniaturisation grâce à leurs capacités de fabrication de traitement au niveau des tranches, associées à leur capacité à créer des structures 3D à l'aide d'interconnexions traversantes telles que de grands piliers en cuivre (Cu) et des boîtiers traversants. vias (TPV) et technologies avancées d'emballage de puces retournées.

Taiwan détiendra une part importante du marché
- Taiwan abrite certaines des plus grandes entreprises manufacturières de semi-conducteurs qui alimentent la demande en emballages de semi-conducteurs avancés, en particulier dans les PLP. Selon un groupe de réflexion gouvernemental, Science and Technology International Strategy Center, la production de Taiwan devrait croître de 25,9 % en 2021 pour atteindre 147 milliards de dollars.
- Selon la Semiconductor Industry Association (SIA), la région Asie-Pacifique génère plus de 50 % des revenus des ventes mondiales de semi-conducteurs ; cela, à son tour, offre aux fournisseurs taïwanais lopportunité de fournir du FOWLP pour des applications accrues de semi-conducteurs.
- La plupart des entreprises du pays augmentent leur capacité de production d'emballages Fan-out, ce qui devrait en outre accroître les exportations et contribuer au développement du marché local. Par exemple, Intel, qui a récemment annoncé son retour dans le secteur de la fonderie, investira simultanément 3,5 milliards de dollars au Nouveau-Mexique pour construire une usine de conditionnement de semi-conducteurs qui entrera en activité au second semestre 2022.
- De plus, en juin 2021, ASE, une entreprise de post-traitement pur de semi-conducteurs (OAST), a commencé à investir dans des installations de conditionnement avancées en réponse à la pénurie de l'offre et de la demande de semi-conducteurs. Elle accélère son expansion en achetant une grande quantité d'équipements de fabrication de semi-conducteurs pour les processus WLP et PLP auprès de HANMI Semiconductor.
- En outre, le marché croissant des communications sans fil de cinquième génération (5G) et du calcul haute performance a permis aux fabricants de développer de nouvelles technologies. Par exemple, en tant qu'unique leader dans le segment de diffusion haute densité, TSMC prévoit d'étendre son segment FO-WLP à des technologies telles que inFO-Antenna-in-Package (AiP) et inFO-on-Substrate (oS).

Aperçu du marché de lemballage en éventail
Le marché est modérément fragmenté, avec la présence de nombreux acteurs. Parmi les principaux acteurs opérant sur le marché mondial des emballages à sortance figurent Taiwan Semiconductor Manufacturing Company Limited, Jiangsu Changjiang Electronics Tech Co., Amkor Technology Inc., Samsung Electro-Mechanics et Powertech Technology Inc., entre autres. Ces acteurs se livrent à linnovation de produits, aux fusions et acquisitions, entre autres développements, afin daugmenter leur part de marché.
- Novembre 2021 - Amkor Technology, Inc., un fournisseur de services d'emballage et de test de semi-conducteurs, a déclaré son intention de construire une usine intelligente à Bac Ninh, au Vietnam. La phase initiale de l'usine proposée se concentrera sur l'offre de services d'assemblage et de test de systèmes avancés en boîtier (SiP) aux plus grandes entreprises mondiales de fabrication de semi-conducteurs et de produits électroniques.
- Février 2021 - Samsung Foundry a déposé des documents auprès des autorités de l'Arizona, de New York et du Texas visant à construire une usine de fabrication de semi-conducteurs de pointe aux États-Unis. La future usine de fabrication située près d'Austin, au Texas, devrait coûter plus de 17 milliards de dollars et créer 1800 emplois. Il devrait être mis en ligne dici le quatrième trimestre 2023.
Leaders du marché de lemballage en éventail
Taiwan Semiconductor Manufacturing Company Limited
Jiangsu Changjiang Electronics Tech Co.
Amkor Technology Inc.
Samsung Electro-Mechanics
Powertech Technology Inc.
- *Avis de non-responsabilité : les principaux acteurs sont triés sans ordre particulier
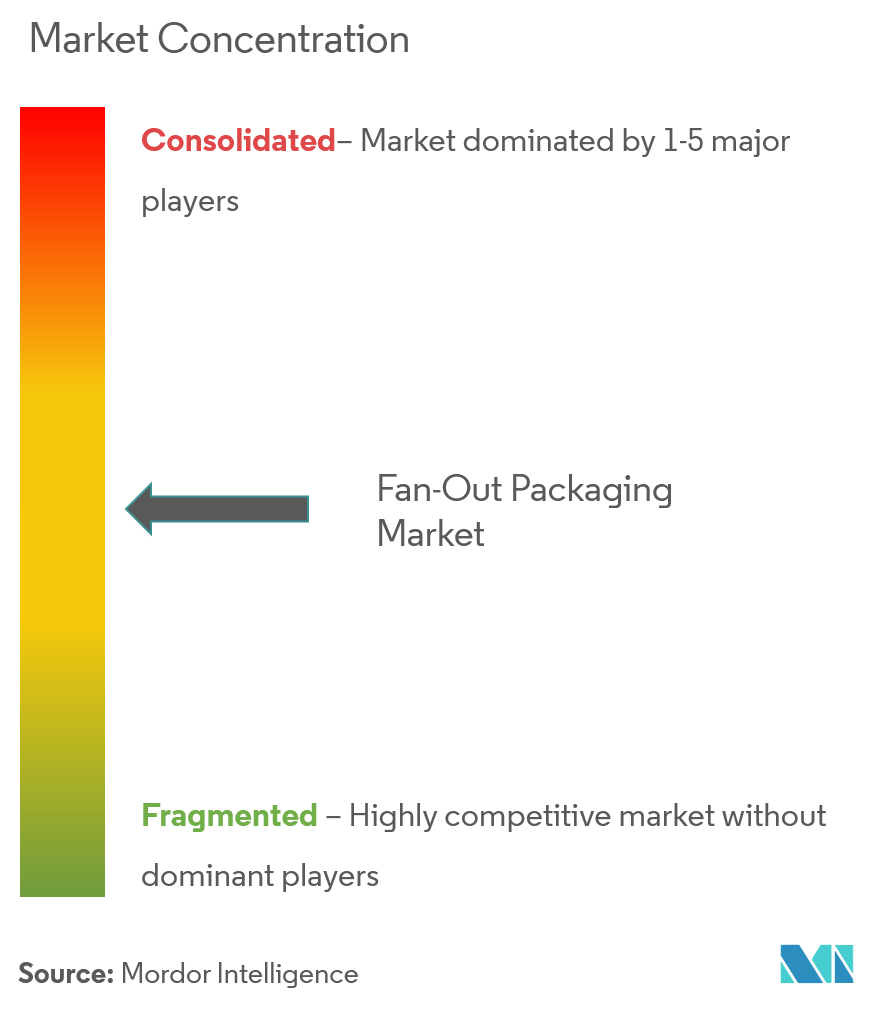
Actualités du marché de lemballage en éventail
- Mai 2022 - SkyWater Technology, un partenaire de confiance en matière de réalisation technologique, et Adeia, la marque nouvellement créée pour Xperi Holding Corporation, ont annoncé que SkyWater avait signé un accord de licence technologique avec Xperi Corporation. SkyWater et ses clients auront accès aux technologies de pontage direct ZiBond et de liaison hybride DBI® d'Adeia ainsi qu'à la propriété intellectuelle pour améliorer les produits commerciaux et gouvernementaux de nouvelle génération. L'usine de Floride de SkyWater crée des solutions de plate-forme d'intégration hétérogènes, notamment des technologies d'interposeur de silicium et de conditionnement au niveau des tranches (FOWLP).
- Juillet 2021 - JCET Group, un leader mondial de la fabrication de circuits intégrés et des services d'innovation, a annoncé l'introduction officielle de XDFOITM, une nouvelle technologie pour le boîtier de distribution ultra haute densité. Cette technologie révolutionnaire offrira des alternatives rentables avec une intégration maximale, une connectivité haute densité et une fiabilité élevée pour les différents chipsets.
- Mars 2021 - Deca, l'un des principaux fournisseurs de technologies spécialisées dans le conditionnement innovant de semi-conducteurs, a présenté sa nouvelle approche APDKTM (Adaptive Patterning Design Kit). Deca a collaboré avec Advanced Semiconductor Engineering, Inc. (ASE) et Siemens Digital Industrial Software pour développer la solution.
Segmentation de lindustrie de lemballage en éventail
L'emballage Fan-Out est tout emballage dont les connecteurs sont déployés à partir de la surface de la puce, permettant des E/S externes supplémentaires. Au lieu de placer les matrices sur un substrat ou un intercalaire, les emballages traditionnels les plongent totalement dans un composé de moule époxy. Le marché de lemballage en éventail couvre létude du type de marché (fan-out de base, fan-out haute densité, fan-out ultra haute densité), du type de support (200 mm, 300 mm, panneau), du modèle commercial (OSAT, fonderie, IDM) et Géographie (Taiwan, Chine, États-Unis, Corée du Sud, Japon, Europe).
| Distribution centrale |
| Distribution haute densité |
| Sortie ultra haute densité |
| 200 millimètres |
| 300 millimètres |
| Panneau |
| ASSEMBLAGES |
| Fondatrice |
| IDM |
| Taïwan |
| Chine |
| États-Unis |
| Corée du Sud |
| Japon |
| L'Europe |
| Par type | Distribution centrale |
| Distribution haute densité | |
| Sortie ultra haute densité | |
| Par type de transporteur | 200 millimètres |
| 300 millimètres | |
| Panneau | |
| Par modèle économique | ASSEMBLAGES |
| Fondatrice | |
| IDM | |
| Géographie | Taïwan |
| Chine | |
| États-Unis | |
| Corée du Sud | |
| Japon | |
| L'Europe |
FAQ sur les études de marché sur les emballages en éventail
Quelle est la taille du marché des emballages Fan Out ?
La taille du marché des emballages Fan Out devrait atteindre 2,94 milliards USD en 2024 et croître à un TCAC de 16,5 % pour atteindre 6,30 milliards USD dici 2029.
Quelle est la taille actuelle du marché des emballages Fan Out ?
En 2024, la taille du marché des emballages Fan Out devrait atteindre 2,94 milliards USD.
Qui sont les principaux acteurs du marché des emballages Fan Out ?
Taiwan Semiconductor Manufacturing Company Limited, Jiangsu Changjiang Electronics Tech Co., Amkor Technology Inc., Samsung Electro-Mechanics, Powertech Technology Inc. sont les principales sociétés opérant sur le marché des emballages en éventail.
Quelle est la région qui connaît la croissance la plus rapide sur le marché des emballages en éventail ?
On estime que lAsie-Pacifique connaîtra la croissance du TCAC le plus élevé au cours de la période de prévision (2024-2029).
Quelle région détient la plus grande part du marché des emballages en éventail ?
En 2024, la région Asie-Pacifique représente la plus grande part de marché sur le marché des emballages Fan Out.
Quelles années couvre ce marché de lemballage Fan Out et quelle était la taille du marché en 2023 ?
En 2023, la taille du marché des emballages Fan Out était estimée à 2,52 milliards USD. Le rapport couvre la taille historique du marché du marché des emballages en éventail pour les années 2019, 2020, 2021, 2022 et 2023. Le rapport prévoit également la taille du marché des emballages en éventail pour les années 2024, 2025, 2026, 2027, 2028 et 2029.
Dernière mise à jour de la page le:
Rapport sur l'industrie de l'emballage en éventail
Statistiques sur la part de marché, la taille et le taux de croissance des revenus de lemballage Fan Out 2024, créées par Mordor Intelligence™ Industry Reports. Lanalyse de Fan Out Packaging comprend des perspectives de prévision du marché jusquen 2029 et un aperçu historique. Obtenez un échantillon de cette analyse de lindustrie sous forme de rapport PDF gratuit à télécharger.



