Fan Out Packaging Market Size and Share

Fan Out Packaging Market Analysis by Mordor Intelligence
The Fan Out Packaging Market size is estimated at USD 3.43 billion in 2025, and is expected to reach USD 7.35 billion by 2030, at a CAGR of 16.5% during the forecast period (2025-2030). The semiconductor packaging industry is undergoing a fundamental transformation as Moore's Law approaches its physical limits in process technologies, shifting focus toward advanced packaging solutions. Traditional packaging methods are being challenged by the increasing demands for miniaturization and higher performance in electronic devices, leading manufacturers to explore innovative solutions. This evolution has positioned fan-out packaging as a crucial technology, particularly in addressing the growing complexity of modern semiconductor devices. The technology's ability to enable increased component density while maintaining smaller form factors has made it increasingly vital for next-generation electronic devices.
The integration of fan-out packaging in consumer electronics has reached a significant milestone, with modern smartphones now incorporating an average of five to seven wafer-level packaging solutions. This adoption represents a paradigm shift from traditional package-on-package (PoP) memory-on-logic solutions, as fan-out packaging offers superior performance in a more compact form factor. The technology's ability to provide higher bandwidth, improved thermal performance, and better electrical characteristics has made it particularly attractive for manufacturers seeking to optimize device performance while reducing overall package size.
Technological advancements in advanced packaging have led to significant breakthroughs in manufacturing capabilities. A notable achievement was demonstrated in December 2021 when Nepes Laweh Corporation successfully produced the world's first 600mm x 600mm large panel-level packaging using Deca's M-Series fan-out technologies. This development represents a significant step forward in scaling up production capabilities and improving cost efficiency. The industry has also witnessed the emergence of various fan-out configurations, including core fan-out, high-density fan-out, and ultra-high-density fan-out, each serving specific application requirements and performance needs.
The market is experiencing a shift in manufacturing approaches, with panel-level packaging emerging as a cost-effective alternative to traditional wafer-level packaging processing. This transition is driven by the potential for significant cost reductions through increased production efficiency and higher carrier usage ratios, which can reach up to 95% compared to traditional wafer-size fan-out wafer-level packaging. Major semiconductor manufacturers are investing in research and development to overcome technical challenges associated with panel-level packaging, including warpage control, die shift, and yield optimization. These developments are crucial for enabling the next generation of electronic devices that demand higher performance in smaller form factors.
Global Fan Out Packaging Market Trends and Insights
The Proliferation of 5G Wireless Networking Along with High-Performance Computing
The rapid advancement of 5G wireless networking and high-performance computing (HPC) applications is fundamentally transforming the semiconductor packaging landscape, driving significant innovations in fan-out packaging technology. As wide bandwidth requirements necessitate higher-frequency millimeter wave (mmWave) solutions, Antenna-in-Packages (AiPs) have become crucial for reducing signal loss through shorter interconnect lines. This technological shift has led to major semiconductor manufacturers developing specialized solutions, exemplified by TSMC's expansion of its FO-WLP segment into technologies like InFO-Antenna-in-Package (AiP) and InFO-on-Substrate (oS) for applications across automotive, servers, and smartphones. The integration of these advanced packaging solutions has been particularly notable in the mobile sector, with industry leaders like Apple adopting TSMC's InFO technology for their application processors, setting a precedent for other manufacturers.
The evolution of high-performance computing applications has further accelerated the development of ultra-high-density fan-out packaging solutions, particularly for addressing the demanding requirements of data centers and network infrastructure. This trend is evidenced by recent industry developments, such as Changdian Technology's introduction of very high-density packaging options for XDFOI chips, designed to deliver cost-effective, high-density connectivity and high-reliability solutions for chip heterogeneous integration. The technology's capability to support increased component density while boosting performance has made it particularly valuable for addressing chip I/O limitations in HPC applications. Major players like Qualcomm and MediaTek have followed suit, adopting fan-out PoP in their flagship smartphone application processors, demonstrating the technology's growing importance in meeting the performance demands of next-generation computing and communication devices. The industry has also witnessed significant investments in advanced packaging facilities, with companies like Intel announcing a $3.5 billion investment in semiconductor packaging facilities, highlighting the critical role of fan-out packaging in supporting the future of high-performance computing and 5G applications.
Segment Analysis
Ultra High-Density Fan-Out Segment in Fan-Out Packaging Market
The Ultra High-Density Fan-Out (UHD FO) segment dominates the global fan-out packaging market, holding approximately 49% market share in 2024. This segment has emerged as the preferred choice for high-performance computing applications, particularly in networking and data center servers, due to its capability to provide more than 18 inputs and outputs (I/O) per square millimeter and line and spacing measurements of 5μm in the redistribution layer. The segment's prominence is driven by its ability to offer dense interconnection, superior electrical performance, and the capability to integrate multiple heterogeneous dies in a cost-effective, low-profile semiconductor packaging. UHD FO has become particularly crucial in addressing the demands of artificial intelligence applications and high-performance semiconductor integrated circuits, where it serves as a cost-effective alternative to 2.5D silicon through-silicon via (TSV) interposer packaging.

Growth Trajectory of UHD FO Segment in Fan-Out Packaging Market
The Ultra High-Density Fan-Out segment is projected to maintain its growth momentum through 2024-2029, with an expected growth rate of approximately 22%. This remarkable growth is primarily driven by the increasing adoption of 5G applications across major economies and the rising demand for high-performance computing solutions. The segment's growth is further supported by its critical role in enabling high-bandwidth, low-latency 5G services such as autonomous driving and security monitoring. The technology's ability to make smaller two-dimensional connections that redistribute the output of the silicon die to a greater area, enabling higher I/O density and higher bandwidth, makes it particularly valuable for modern devices requiring advanced packaging solutions.
Remaining Segments in Fan-Out Packaging Market
The Core Fan-Out segment, while representing a smaller portion of the market, continues to serve specific applications in consumer and mobile devices. This segment is particularly relevant for audio codecs, power management ICs, radar modules, and RF applications, where standard-density packaging with fewer than 6 I/Os per square millimeter is sufficient. Meanwhile, the High-Density Fan-Out segment bridges the gap between core and ultra-high-density applications, catering to mid-range to high-end applications with I/O densities between 6 to 12 per square millimeter. This segment has found significant applications in mobile phone packaging and continues to evolve with advancements in redistribution layer metal and mega pillar plating technologies.
Segment Analysis: By Carrier Type
300mm Segment in Fan-Out Packaging Market
The 300mm carrier type dominates the fan-out packaging market, commanding approximately 81% market share in 2024. This significant market position is driven by the segment's widespread adoption in manufacturing advanced packaging semiconductor packages, particularly for 5G applications, high-performance computing, and mobile devices. Major semiconductor manufacturers are increasingly utilizing 300mm wafers due to their superior efficiency and economies of scale compared to smaller wafer sizes. The technology enables the production of more chips per wafer while maintaining high quality and reliability standards. Leading companies like TSMC and Samsung have made substantial investments in 300mm manufacturing capabilities, particularly for applications in artificial intelligence, edge computing, and cloud systems that require massive amounts of high-bandwidth memory.
Panel Segment in Fan-Out Packaging Market
The panel-level packaging carrier type segment is experiencing remarkable growth in the fan-out packaging market, with an expected growth rate of approximately 39% during 2024-2029. This exceptional growth is driven by the segment's ability to significantly increase production output and achieve greater cost efficiencies compared to traditional wafer-based approaches. Panel-level packaging represents a paradigm shift in manufacturing processes, enabling the production of larger substrate sizes and higher carrier usage ratios of up to 95%. The technology is particularly attractive for applications in 5G infrastructure, automotive electronics, and Internet of Things (IoT) devices. Major manufacturers are increasingly investing in panel-level fan-out capabilities to leverage these advantages and meet the growing demand for advanced packaging solutions in emerging technologies.
Remaining Segments in Fan-Out Packaging Market by Carrier Type
The 200mm carrier type segment, while representing a smaller portion of the market, continues to serve specific niche applications in the semiconductor packaging industry. This segment remains relevant for certain specialized applications and legacy products where the transition to larger carrier sizes may not be economically viable or technically necessary. The 200mm format maintains its position in specific market segments where smaller production volumes and specialized packaging requirements are prevalent. While not experiencing the dramatic growth of panel or 300mm segments, it continues to play a role in supporting diverse packaging needs across various industries.
Segment Analysis: By Business Model
Foundry Segment in Fan-Out Packaging Market
The Foundry segment dominates the global fan-out packaging market, commanding approximately 71% market share in 2024. This significant market position is primarily driven by the segment's ability to share manufacturing lines, provide faster turnaround times, and offer a single point of contact for various services. Major foundries like TSMC have established themselves as leaders in this space by developing comprehensive design flows complete with sign-off decks, giving designers confidence in achieving reasonable yields. The segment's strength is further reinforced by its flexibility in expansion and robust revenue streams that support growth into assembly and testing operations, particularly in wafer-level packaging techniques. Additionally, foundries have demonstrated superior capabilities in handling high-volume manufacturing requirements and maintaining consistent quality standards across complex packaging processes.
IDM Segment in Fan-Out Packaging Market
The Integrated Device Manufacturer (IDM) segment is projected to experience the fastest growth in the fan-out packaging market from 2024 to 2029, with an expected growth rate of approximately 22%. This remarkable growth trajectory is attributed to IDMs' unique advantage of handling semiconductor manufacturing in-house, allowing for better control over the entire production process and faster implementation of technological innovations. The segment's growth is being fueled by increasing investments in advanced packaging technologies, particularly in areas such as 5G wireless networking, artificial intelligence, and automotive electronics. IDMs are also expanding their capabilities in panel-level packaging and developing new applications for fan-out technology in emerging markets like Internet of Things (IoT) devices and high-performance computing solutions.
Remaining Segments in Fan-Out Packaging Market Business Model
The Outsourced Semiconductor Assembly and Test (OSAT) segment plays a crucial role in the fan-out packaging market by providing third-party IC-packaging and test services. OSATs serve as merchant vendors, offering specialized packaging solutions to both fabless companies and IDMs that need to supplement their internal packaging capabilities. These providers have been instrumental in advancing fan-out packaging technology through continuous innovation and investment in research and development. The segment has a particularly strong presence in Asia-Pacific, where many OSAT providers have established advanced manufacturing facilities and technical expertise in various packaging technologies, including core fan-out, high-density packaging, and ultra high-density fan-out solutions.
Geography Analysis
Fan Out Packaging Market in Taiwan
Taiwan continues to dominate the global fan-out packaging landscape, commanding approximately 47% of the market share in 2024. The country's leadership position is anchored by the presence of major semiconductor packaging companies, particularly Taiwan Semiconductor Manufacturing Company (TSMC), which has devoted substantial resources to developing advanced packaging technologies, including integrated fan-out wafer-level packaging (InFoWLP). The region's strength is further reinforced by its robust ecosystem of packaging organizations that are actively advancing panel-level packaging technologies. Several packaging companies are investing heavily in research and development, with many converting existing facilities into advanced packaging plants dedicated to FOPLP processes. The country's semiconductor ecosystem benefits from strong government support and strategic partnerships between key industry players. Taiwan's dominance is particularly evident in high-performance computing applications and mobile device packaging solutions, where its advanced packaging capabilities are crucial for meeting the demanding requirements of next-generation electronics.

Fan Out Packaging Market in China
China's fan-out packaging market is projected to grow at an impressive rate of approximately 22% during 2024-2029, positioning it as the fastest-growing market globally. The country's remarkable growth trajectory is driven by its ambitious semiconductor self-sufficiency goals and substantial investments in advanced packaging technologies. China's packaging industry benefits from sound policy support under the backdrop of industrial upgrades, particularly in advanced packaging capabilities. The country's expanding consumer electronics industry, coupled with a growing pool of engineering talent, has created a robust foundation for market growth. Chinese manufacturers are making significant strides in both 200mm and 300mm wafer processing technologies, with domestic suppliers rapidly improving their capabilities. The market is further strengthened by the presence of key players like JCET China, which is producing Ultra High-Density Fan-Out as a cost-effective high-end package solution. The country's focus on developing indigenous packaging capabilities, particularly in panel-level packaging, positions it strongly for future growth in this sector.
Fan Out Packaging Market in United States
The United States maintains its position as a crucial market in the global fan-out packaging industry, driven by its leadership in semiconductor packaging innovation and extensive research capabilities. The country's market is characterized by high adoption rates of consumer electronics and advanced technology integration across various sectors, particularly in automotive and high-performance computing applications. American semiconductor companies are at the forefront of developing next-generation packaging solutions, supported by a robust ecosystem of research institutions and technology companies. The market benefits from significant government support through initiatives aimed at strengthening domestic semiconductor manufacturing and packaging capabilities. The presence of major fabless semiconductor companies and their increasing focus on advanced packaging solutions continues to drive innovation in the sector. The United States' strength in artificial intelligence, data centers, and emerging technologies creates sustained demand for advanced packaging solutions, particularly in high-performance computing applications.
Fan Out Packaging Market in South Korea
South Korea has established itself as a significant player in the fan-out packaging market, leveraging its strong semiconductor industry foundation and technological expertise. The country's market is driven by the presence of major players like Samsung Electronics and SK Hynix, who are making substantial investments in advanced packaging technologies. South Korean companies are particularly focused on developing innovative solutions in Fan-out Panel-Level Packaging (FO-PLP) technology, which is crucial for next-generation electronic devices. The country's packaging industry benefits from strong integration between design, manufacturing, and testing capabilities, creating a comprehensive ecosystem for advanced packaging solutions. South Korean manufacturers are particularly strong in mobile device applications, where their advanced packaging solutions are crucial for smartphone and wearable device manufacturing. The market is further strengthened by significant research and development investments in areas such as 5G technology, artificial intelligence, and automotive electronics.
Fan Out Packaging Market in Other Countries
Beyond the major markets, the fan-out packaging industry maintains a significant presence in other regions, particularly Japan and European countries. Japan's market is characterized by its strength in high-end materials and ongoing R&D efforts, with companies focusing on developing specialized packaging solutions for emerging applications. European countries, while having a smaller market share, are making notable strides in advanced packaging research and development, particularly through collaborative projects and research initiatives. These regions are focusing on developing niche applications and specialized packaging solutions for specific industry sectors such as automotive electronics and industrial applications. The diversity of these markets contributes to the overall innovation in the global fan-out packaging industry, with each region bringing unique technological capabilities and market approaches to the fore.
Competitive Landscape
Top Companies in Fan Out Packaging Market
The fan-out packaging market is characterized by intense innovation and strategic developments from key players like TSMC, Samsung, ASE Group, and Amkor Technology. Companies are heavily investing in research and development to advance their packaging technologies, particularly in areas like wafer-level and panel-level packaging solutions. The industry witnesses continuous product launches focusing on enhanced performance, miniaturization, and cost-effectiveness. Operational excellence is being achieved through automation, Industry 4.0 implementation, and streamlined manufacturing processes. Strategic partnerships with semiconductor manufacturers, technology providers, and end-users are becoming increasingly common to strengthen market positions. Geographic expansion, particularly in Asia-Pacific regions like Taiwan, South Korea, and China, remains a key focus area as companies aim to capitalize on growing semiconductor demand and supportive government policies.
Market Dominated by Integrated Technology Leaders
The fan-out packaging market structure is characterized by the presence of both large integrated device manufacturers (IDMs) and specialized outsourced semiconductor assembly and test (OSAT) providers. Major foundries and IDMs are increasingly incorporating advanced packaging capabilities into their core competencies, creating a more competitive environment for traditional OSAT providers. The market shows moderate consolidation with established players leveraging their technological expertise, manufacturing scale, and customer relationships to maintain market positions. Companies are actively pursuing vertical integration strategies to control the entire value chain from design to final packaging.
The industry is witnessing significant merger and acquisition activities as companies seek to expand their technological capabilities and geographic presence. Large conglomerates are acquiring specialized packaging technology providers to enhance their advanced packaging portfolios and gain access to proprietary technologies. Regional players, particularly in Asia, are forming strategic alliances and joint ventures to compete with global leaders. The market also sees collaboration between equipment manufacturers, material suppliers, and packaging service providers to develop comprehensive solutions for emerging applications in 5G, artificial intelligence, and high-performance computing.
Innovation and Integration Drive Market Success
Success in the fan-out packaging market increasingly depends on companies' ability to offer comprehensive solutions that address emerging technological challenges while maintaining cost competitiveness. Incumbent players are focusing on developing proprietary technologies, expanding their intellectual property portfolios, and investing in advanced manufacturing capabilities. Market leaders are strengthening their positions through continuous innovation in areas like panel-level packaging, system-in-package solutions, and heterogeneous integration. Companies are also emphasizing quality management systems and industry certifications to meet stringent requirements from automotive, industrial, and high-performance computing sectors.
For new entrants and smaller players, success lies in identifying and serving niche market segments while building strategic partnerships with larger ecosystem players. The market shows moderate end-user concentration with major electronics manufacturers and semiconductor companies driving demand patterns. Substitution risk remains relatively low due to the specialized nature of fan-out packaging technology and its critical role in advanced electronic devices. Regulatory compliance, particularly in areas of environmental sustainability and quality standards, is becoming increasingly important for market participation. Companies are also investing in talent development and research capabilities to maintain technological leadership and market competitiveness.
Fan Out Packaging Industry Leaders
Taiwan Semiconductor Manufacturing Company Limited
Jiangsu Changjiang Electronics Tech Co.
Amkor Technology Inc.
Samsung Electro-Mechanics
Powertech Technology Inc.
- *Disclaimer: Major Players sorted in no particular order
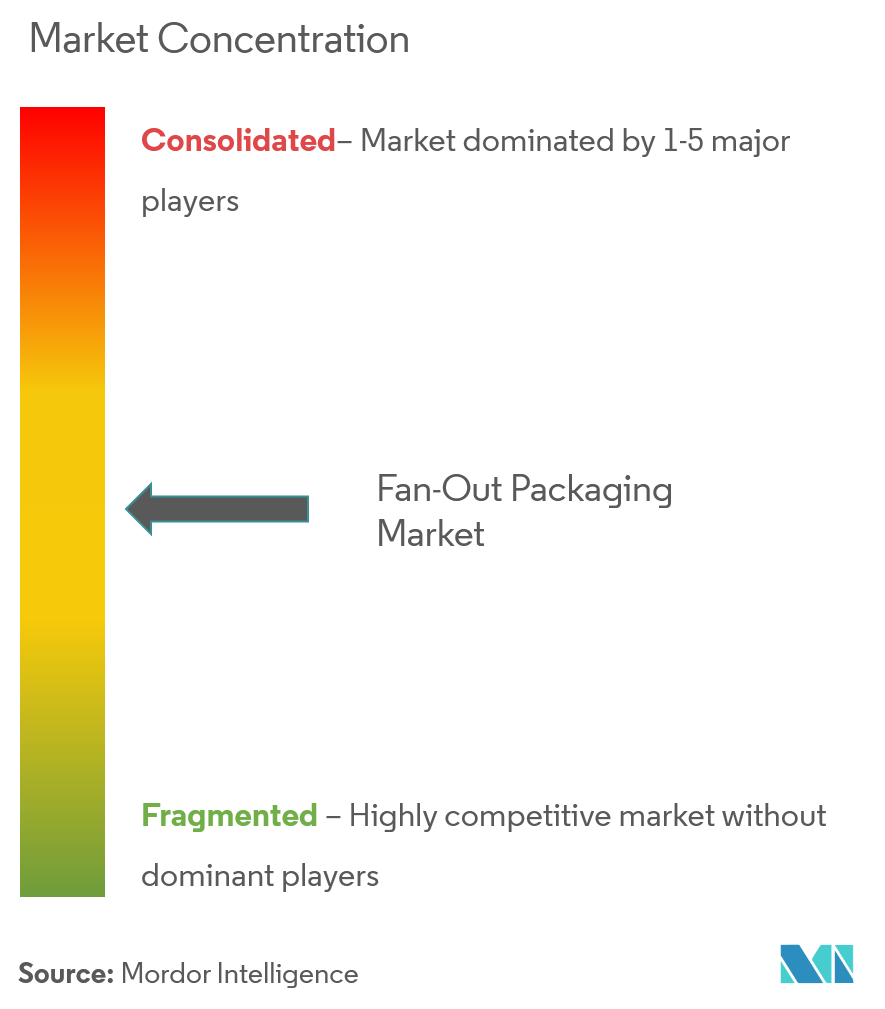


Recent Industry Developments
- May 2022: SkyWater Technology, a trusted technology realization partner, and Adeia, the newly established brand for Xperi Holding Corporation, announced that SkyWater had inked a technology license deal with Xperi Corporation. SkyWater and its clients will have accessibility to Adeia's ZiBond direct bridging and DBI® hybrid bonding technologies and IP to improve next-generation commercial and government products. SkyWater's Florida plant is creating heterogeneous integration platform solutions, including silicon interposer and fan-out wafer-level packaging (FOWLP) technologies.
- July 2021: JCET Group, a global leader in IC manufacturing and innovation services, announced the official introduction of XDFOITM, a novel technology for ultra-high-density fan-out packaging. This ground-breaking technology will deliver cost-effective alternatives with maximum integration, high-density connectivity, and high reliability for the various chipsets.
- March 2021: Deca, a market-leading pure-play technology supplier for innovative semiconductor packaging, has introduced its new APDKTM (Adaptive Patterning Design Kit) approach. Deca collaborated with Advanced Semiconductor Engineering, Inc. (ASE) and Siemens Digital Industrial Software to develop the solution.
Global Fan Out Packaging Market Report Scope
Fan-Out packaging is any package having connectors fanned out from the chip surface, allowing for additional external I/Os. Instead of putting the dies onto a substrate or interposer, traditional fan-out packaging totally immerses those in an epoxy mold compound.
The fan-out packaging market covers the study of Market Type (Core Fan-Out, High-Density Fan-Out, and Ultra High-density Fan Out), Carrier Type (200mm, 300mm, and Panel), Business Model (OSAT, Foundary, and IDM), and Geography (Taiwan, China, United States, South Korea, Japan, and Europe).
| Core Fan-Out |
| High-Density Fan-Out |
| Ultra High-density Fan Out |
| 200 mm |
| 300 mm |
| Panel |
| OSAT |
| Foundary |
| IDM |
| Taiwan |
| China |
| United States |
| South Korea |
| Japan |
| Europe |
| By Type | Core Fan-Out |
| High-Density Fan-Out | |
| Ultra High-density Fan Out | |
| By Carrier Type | 200 mm |
| 300 mm | |
| Panel | |
| By Business Model | OSAT |
| Foundary | |
| IDM | |
| Geography | Taiwan |
| China | |
| United States | |
| South Korea | |
| Japan | |
| Europe |


Key Questions Answered in the Report
How big is the Fan Out Packaging Market?
The Fan Out Packaging Market size is expected to reach USD 3.43 billion in 2025 and grow at a CAGR of 16.5% to reach USD 7.35 billion by 2030.
What is the current Fan Out Packaging Market size?
In 2025, the Fan Out Packaging Market size is expected to reach USD 3.43 billion.
Who are the key players in Fan Out Packaging Market?
Taiwan Semiconductor Manufacturing Company Limited, Jiangsu Changjiang Electronics Tech Co., Amkor Technology Inc., Samsung Electro-Mechanics and Powertech Technology Inc. are the major companies operating in the Fan Out Packaging Market.
Which is the fastest growing region in Fan Out Packaging Market?
Asia Pacific is estimated to grow at the highest CAGR over the forecast period (2025-2030).
Which region has the biggest share in Fan Out Packaging Market?
In 2025, the Asia Pacific accounts for the largest market share in Fan Out Packaging Market.
What years does this Fan Out Packaging Market cover, and what was the market size in 2024?
In 2024, the Fan Out Packaging Market size was estimated at USD 2.86 billion. The report covers the Fan Out Packaging Market historical market size for years: 2019, 2020, 2021, 2022, 2023 and 2024. The report also forecasts the Fan Out Packaging Market size for years: 2025, 2026, 2027, 2028, 2029 and 2030.
Page last updated on:








