
Análisis del mercado de embalaje en abanico
El tamaño del mercado de embalaje Fan Out se estima en 2,94 mil millones de dólares en 2024 y se espera que alcance los 6,30 mil millones de dólares en 2029, creciendo a una tasa compuesta anual del 16,5% durante el período previsto (2024-2029).
La expansión de este mercado está siendo impulsada por los avances tecnológicos en tecnologías basadas en semiconductores y la rápida expansión de la demanda en varios sectores.
- El empaquetado a nivel de oblea en abanico (FOWLP) encuentra su aplicación cada vez mayor en dispositivos sensibles al espacio, como los teléfonos inteligentes, debido al requisito de paquetes de factor de forma pequeño y delgado de alto rendimiento y eficiencia energética. Además, en promedio, se pueden encontrar entre cinco y siete paquetes de nivel de oblea (especialmente en abanico) en los teléfonos inteligentes modernos, y se espera que las cifras aumenten en el futuro. Esto se debe a que están reemplazando gradualmente las soluciones más tradicionales de memoria en lógica de paquete en paquete (PoP).
- Además, la creciente aplicación de la inteligencia artificial y el aprendizaje automático en diversos campos ha aumentado la instalación de informática de alto rendimiento en el mercado. Se espera que la tecnología UHD fan-out se aplique a la nube, 5G, automóviles autónomos y chips de IA y lidere la tendencia de empaquetado durante el período de pronóstico.
- La industria de semiconductores de Corea del Sur continúa esforzándose para mejorar y hacer que las tecnologías 3D TSV (vía de silicio), embalaje y FoWLP (envasado a nivel de oblea en abanico) y FoPLP (empaque a nivel de panel en abanico) sean más efectivas. para elevar el rendimiento de los semiconductores y el grado de integración.
- En diciembre de 2021, la corporación Nepes Laweh anunció la producción exitosa del primer empaque a nivel de panel (PLP) de gran tamaño de 600 mm x 600 mm del mundo utilizando las tecnologías de distribución en abanico de la serie M de Deca. La línea Fan-out-Panel Level Packaging (FOPLP) obtuvo la certificación del cliente en el tercer trimestre, estableció un rendimiento constante y comenzó la producción en masa a gran escala, según la empresa.
- Debido a que las empresas surcoreanas dependían en el pasado de empresas extranjeras para estos sistemas, KOSTEK espera un enorme efecto de sustitución de importaciones en el futuro. Sus técnicas de unión y desunión de obleas temporales se pueden utilizar durante un proceso de envasado en abanico.
- Con el brote de COVID-19, el mercado de envases de semiconductores experimentó una disminución en su crecimiento debido a las restricciones al movimiento de mercancías y a graves interrupciones en la cadena de suministro de semiconductores. En el primer trimestre de 2020, COVID-19 provocó niveles bajos de inventario para los clientes de proveedores de semiconductores y canales de distribución. Se espera que el mercado sea testigo de un impacto a largo plazo debido al brote de coronavirus.
Fan Out Packaging Tendencias del mercado
Fan-out de alta densidad para mantener una participación significativa
- Dirigido a aplicaciones de rango medio a alto, el despliegue de alta densidad tiene entre 6 y 12 E/S por mm2 y entre 15/15 μm y 5/5 μm de línea/espacio. Los empaques desplegables de alta densidad ganaron popularidad para abordar los requisitos de factor de forma y rendimiento del empaque de teléfonos móviles. Los componentes clave de esta tecnología son el metal de capa de redistribución (RDL) y el revestimiento de megapilares.
- La tecnología InFO de TSMC es uno de los ejemplos más notables de distribución en abanico de alta densidad. Esta tecnología se dirige a aplicaciones con un mayor número de pines, como los procesadores de aplicaciones (AP). La compañía planea ampliar su segmento FO-WLP a tecnologías como inFO-Antenna-in-Package (AiP) e inFO-on-Substrate. Estos paquetes se utilizan en automóviles, servidores y teléfonos inteligentes. Apple fue uno de los primeros en adoptar esta nueva tecnología, que la utilizó en el procesador de aplicaciones A10 del iPhone 7, presentado a finales de 2016.
- Debido a tales beneficios, en diciembre de 2021, Qualcomm y MediaTek consideraron adoptar PoP en abanico en la producción de sus procesadores de aplicaciones para teléfonos inteligentes emblemáticos, siguiendo los pasos de Apple que utilizó la tecnología InFO_PoP de TSMC para empaquetar sus chips de iPhone.
- Además, se espera que el crecimiento del mercado de semiconductores junto con el desarrollo de soluciones de embalaje en abanico de alta densidad impulsen el crecimiento del mercado durante el período previsto. Por ejemplo, en julio de 2021, Changdian Technology, el principal fabricante de circuitos combinados y proveedor de soluciones tecnológicas del mundo, reveló la introducción oficial de toda la línea de opciones de empaquetamiento en abanico de muy alta densidad para chips XDFOI, que están destinados a ofrecer costos- Soluciones efectivas de conectividad de alta densidad, alta integración y alta confiabilidad para la integración heterogénea de chips.
- También se realizan avances en el método de fabricación de envases a nivel de oblea en abanico de alta densidad (FOWLP). Se están desarrollando soluciones para reducir el tamaño y la altura del chip y disminuir los costos de producción, al tiempo que se mejora la confiabilidad, la eficiencia energética, la velocidad del dispositivo y la integración multifunción. Por ejemplo, SPTS Technologies ofrece múltiples tecnologías de proceso de deposición y grabado con plasma a empresas líderes de envasado de semiconductores para esquemas de envasado avanzados, como el envasado a nivel de oblea de alta densidad.
- Además, los paquetes de distribución en abanico de alta densidad (HDFO) pueden abordar estas necesidades de miniaturización mediante capacidades de fabricación de procesamiento a nivel de oblea junto con su capacidad para crear estructuras 3D utilizando interconexiones a través del molde, como pilares altos de cobre (Cu) y paquetes a través. vias (TPV) y tecnologías avanzadas de empaquetado de chips invertidos.

Taiwán tendrá una participación significativa en el mercado
- Taiwán alberga algunas de las principales empresas de fabricación de semiconductores que están impulsando la demanda de envases de semiconductores avanzados, especialmente en PLP. Según un grupo de expertos del gobierno, el Centro de Estrategia Internacional de Ciencia y Tecnología, se esperaba que la producción de Taiwán creciera un 25,9% en 2021 a 147 mil millones de dólares.
- Según la Asociación de la Industria de Semiconductores (SIA), Asia-Pacífico genera más del 50% de los ingresos por ventas mundiales de semiconductores; esto, a su vez, brinda a los proveedores taiwaneses la oportunidad de suministrar FOWLP para mayores aplicaciones de semiconductores.
- La mayoría de las empresas del país están ampliando su capacidad de producción de envases Fan-out, lo que se espera que aumente aún más las exportaciones y ayude a desarrollar el mercado local. Por ejemplo, Intel, que anunció recientemente su regreso a la industria de la fundición, invertirá simultáneamente 3.500 millones de dólares en Nuevo México para construir una fábrica de embalaje de semiconductores que comenzará a operar en la segunda mitad de 2022.
- Además, en junio de 2021, ASE, un posprocesamiento de semiconductores puros (OAST), comenzó a invertir en instalaciones de embalaje avanzadas en respuesta a la escasez de oferta y demanda de semiconductores. Está acelerando la expansión mediante la compra de una gran cantidad de equipos de fabricación de semiconductores para procesos WLP y PLP de HANMI Semiconductor.
- Además, el creciente mercado de comunicaciones inalámbricas de quinta generación (5G) y computación de alto rendimiento ha permitido a los fabricantes desarrollar tecnologías más nuevas. Por ejemplo, como líder exclusivo en el segmento Fan-out de alta densidad, TSMC planea ampliar su segmento FO-WLP a tecnologías como inFO-Antenna-in-Package (AiP) e inFO-on-Substrate (oS).

Descripción general de la industria del embalaje en abanico
El mercado está moderadamente fragmentado, con presencia de numerosos actores. Algunos de los principales actores que operan en el mercado mundial de embalajes en abanico incluyen Taiwan Semiconductor Manufacturing Company Limited, Jiangsu Changjiang Electronics Tech Co., Amkor Technology Inc., Samsung Electro-Mechanics y Powertech Technology Inc., entre otros. Estos actores se dedican a la innovación de productos, fusiones y adquisiciones, entre otros desarrollos, para aumentar la participación de mercado.
- Noviembre de 2021 Amkor Technology, Inc., un proveedor de servicios de prueba y embalaje de semiconductores, declaró que tiene la intención de construir una fábrica inteligente en Bac Ninh, Vietnam. La fase inicial de la fábrica propuesta se concentrará en ofrecer servicios de ensamblaje y prueba de sistemas avanzados en paquetes (SiP) a las principales empresas de fabricación de semiconductores y productos electrónicos del mundo.
- Febrero de 2021 Samsung Foundry ha presentado documentos ante las autoridades de Arizona, Nueva York y Texas con el objetivo de construir una instalación de fabricación de semiconductores de vanguardia en EE. UU. Se espera que la posible fábrica cerca de Austin, Texas, cueste más de 17 mil millones de dólares y cree 1.800 puestos de trabajo. Se espera que entre en funcionamiento en el cuarto trimestre de 2023.
Líderes del mercado de envases en abanico
Taiwan Semiconductor Manufacturing Company Limited
Jiangsu Changjiang Electronics Tech Co.
Amkor Technology Inc.
Samsung Electro-Mechanics
Powertech Technology Inc.
- *Nota aclaratoria: los principales jugadores no se ordenaron de un modo en especial
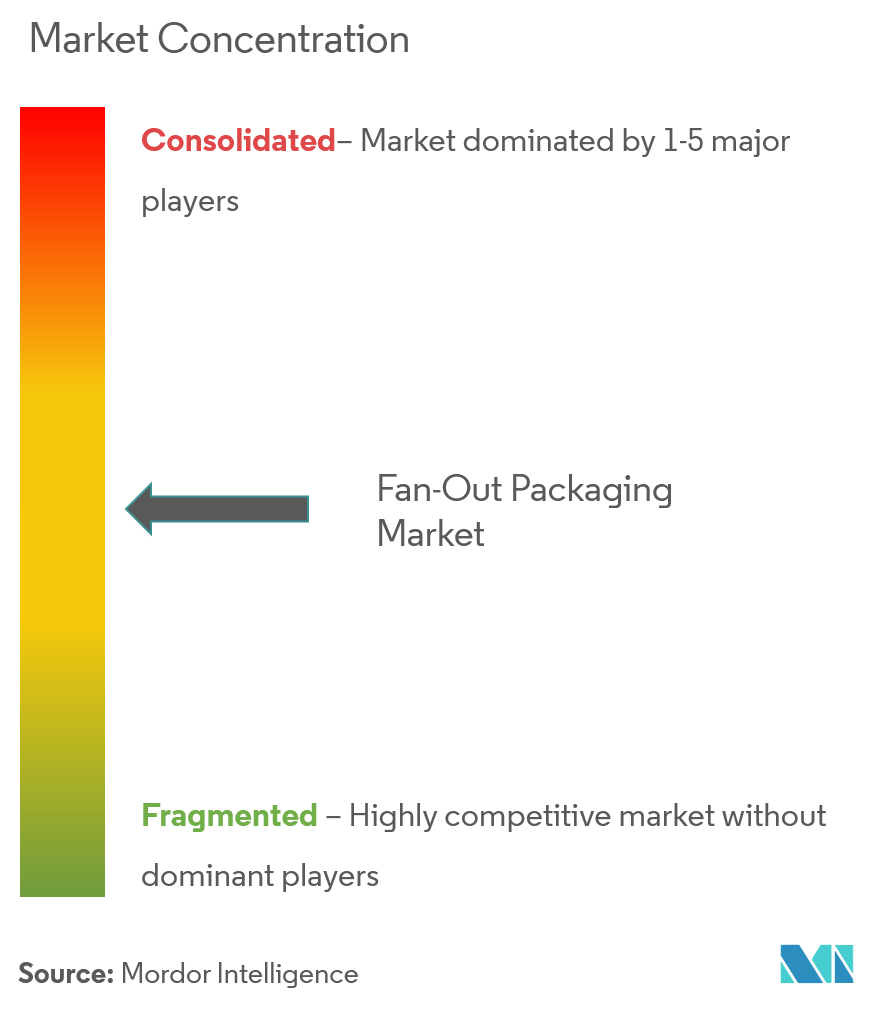
Noticias del mercado de embalaje en abanico
- Mayo de 2022 SkyWater Technology, un socio confiable de realización de tecnología, y Adeia, la marca recientemente establecida de Xperi Holding Corporation, anunciaron que SkyWater había firmado un acuerdo de licencia de tecnología con Xperi Corporation. SkyWater y sus clientes tendrán acceso a las tecnologías de puente directo ZiBond y de enlace híbrido DBI® e IP de Adeia para mejorar los productos comerciales y gubernamentales de próxima generación. La planta de SkyWater en Florida está creando soluciones de plataformas de integración heterogéneas, incluidas tecnologías de intercalador de silicio y empaquetado a nivel de oblea en abanico (FOWLP).
- Julio de 2021 JCET Group, líder mundial en servicios de innovación y fabricación de circuitos integrados, anunció la presentación oficial de XDFOITM, una tecnología novedosa para empaques en abanico de densidad ultraalta. Esta tecnología innovadora ofrecerá alternativas rentables con máxima integración, conectividad de alta densidad y alta confiabilidad para los distintos conjuntos de chips.
- Marzo de 2021 Deca, un proveedor de tecnología líder en el mercado para envases de semiconductores innovadores, ha presentado su nuevo enfoque APDKTM (Adaptive Patterning Design Kit). Deca colaboró con Advanced Semiconductor Engineering, Inc. (ASE) y Siemens Digital Industrial Software para desarrollar la solución.
Segmentación de la industria del embalaje en abanico
El paquete Fan-Out es cualquier paquete que tenga conectores desplegados en abanico desde la superficie del chip, lo que permite E/S externas adicionales. En lugar de colocar los troqueles sobre un sustrato o intercalador, el embalaje tradicional en abanico los sumerge totalmente en un compuesto de molde epoxi. El mercado de embalaje en abanico cubre el estudio del tipo de mercado (en abanico de núcleo, en abanico de alta densidad, en abanico de ultra alta densidad), el tipo de portador (200 mm, 300 mm, panel), el modelo de negocio (OSAT, fundición, IDM) y Geografía (Taiwán, China, Estados Unidos, Corea del Sur, Japón, Europa).
| Distribución del núcleo |
| Distribución en abanico de alta densidad |
| Salida en abanico de ultra alta densidad |
| 200 milímetros |
| 300 milímetros |
| Panel |
| ENSAMBLES |
| fundición |
| IDM |
| Taiwán |
| Porcelana |
| Estados Unidos |
| Corea del Sur |
| Japón |
| Europa |
| Por tipo | Distribución del núcleo |
| Distribución en abanico de alta densidad | |
| Salida en abanico de ultra alta densidad | |
| Por tipo de transportista | 200 milímetros |
| 300 milímetros | |
| Panel | |
| Por modelo de negocio | ENSAMBLES |
| fundición | |
| IDM | |
| Geografía | Taiwán |
| Porcelana | |
| Estados Unidos | |
| Corea del Sur | |
| Japón | |
| Europa |
Preguntas frecuentes sobre investigación de mercado de envases en abanico
¿Qué tamaño tiene el mercado de embalaje Fan Out?
Se espera que el tamaño del mercado de embalaje Fan Out alcance los 2,94 mil millones de dólares en 2024 y crezca a una tasa compuesta anual del 16,5% hasta alcanzar los 6,30 mil millones de dólares en 2029.
¿Cuál es el tamaño actual del mercado Embalaje Fan Out?
En 2024, se espera que el tamaño del mercado de embalaje Fan Out alcance los 2,94 mil millones de dólares.
¿Quiénes son los actores clave en el mercado Embalaje Fan Out?
Taiwan Semiconductor Manufacturing Company Limited, Jiangsu Changjiang Electronics Tech Co., Amkor Technology Inc., Samsung Electro-Mechanics, Powertech Technology Inc. son las principales empresas que operan en Fan Out Packaging Market.
¿Cuál es la región de más rápido crecimiento en Fan Out Packaging Market?
Se estima que Asia Pacífico crecerá a la CAGR más alta durante el período previsto (2024-2029).
¿Qué región tiene la mayor participación en el mercado Fan Out Packaging?
En 2024, Asia Pacífico representa la mayor cuota de mercado en Fan Out Packaging Market.
¿Qué años cubre este mercado de Embalaje Fan Out y cuál fue el tamaño del mercado en 2023?
En 2023, el tamaño del mercado de embalaje Fan Out se estimó en 2,52 mil millones de dólares. El informe cubre el tamaño histórico del mercado de Embalaje Fan Out para los años 2019, 2020, 2021, 2022 y 2023. El informe también pronostica el tamaño del mercado de Embalaje Fan Out para los años 2024, 2025, 2026, 2027, 2028 y 2029.
Última actualización de la página el:
Informe de la industria del embalaje en abanico
Estadísticas para la participación de mercado, el tamaño y la tasa de crecimiento de ingresos de Embalaje Fan Out en 2024, creadas por Mordor Intelligence™ Industry Reports. El análisis Fan Out Packaging incluye una perspectiva de previsión del mercado hasta 2029 y una descripción histórica. Obtenga una muestra de este análisis de la industria como descarga gratuita del informe en PDF.



