
Marktanalyse für Halbleiter-Bonding-Geräte
Die Marktgröße für Halbleiter-Bonding-Geräte wird im Jahr 2024 auf 542,38 Mio. USD geschätzt und wird bis 2029 voraussichtlich 689,03 Mio. USD erreichen, was einer CAGR von 4,90 % im Prognosezeitraum (2024-2029) entspricht.
Halbleiter-Bonding-Geräte finden aufgrund der steigenden Nachfrage nach Halbleiterchips mit höherer Effizienz, Rechenleistung und geringerem Platzbedarf Anwendung, wodurch die Nachfrage nach dem Markt im Prognosezeitraum angekurbelt wird.
- Da die Auswirkungen der Digitalisierung zugenommen haben, boomen die Halbleitermärkte. Dies hat insbesondere zu Regierungsprogrammen zur Unterstützung der 5G-Einführung geführt. So hat die Europäische Kommission die Bedeutung des 5G-Netzes frühzeitig erkannt und eine öffentlich-private Partnerschaft zur Entwicklung und Erforschung der 5G-Technologie gegründet.
- Da die Chipnachfrage in den kommenden zehn Jahren stark ansteigen wird, wird erwartet, dass die globale Halbleiterindustrie bis 2030 zu einer Billionen-Dollar-Industrie wird. Dieses Wachstum wird von Unternehmen und Ländern begünstigt, die riesige Geldsummen in die Halbleiterfertigung, Materialien und Forschung stecken, um eine konstante Versorgung mit Chips und Know-how zu gewährleisten, um das Wachstum in einem breiten Spektrum zunehmend datenzentrierter Branchen zu unterstützen.
- Die Halbleiterindustrie, die wichtige technologische Komponenten herstellt, ist aufgrund eines ungezügelten Nachfrageanstiegs in die Schlagzeilen geraten. Ein kürzlich veröffentlichter Bericht des Wall Street Journal zeigt, dass Halbleiter nach Rohöl, raffiniertem Öl und Autos das viertgrößte gehandelte Produkt der Welt (Importe und Exporte) sind. Dies liegt daran, dass Halbleiter für High-Computing-Anwendungen in verschiedenen Branchen von entscheidender Bedeutung sind, darunter Elektronik- und Fertigungsindustrie, Landwirtschaft, Gesundheitswesen, Infrastruktur, Unterhaltung, Transport, Telekommunikation, militärische Systeme, Energiemanagement und Raumfahrt, um nur einige zu nennen.
- Es können mehrere Methoden verwendet werden, wenn ein Produkt das Bonding von zwei Dies oder Wafern erfordert. Es muss nicht nur die Art der Bondmethode selbst ausgewählt werden, sondern es muss auch entschieden werden, ob die zu bondenden Gegenstände in Wafer- oder Die-Form vorliegen. Der gewählte Klebeprozess ist der Haupttreiber für die Betriebskosten der Verklebung. Für einen bestimmten Prozess sind die drei wichtigsten Faktoren die Kosten des vorgelagerten Prozesses, der für die Verklebung benötigt wird, die Zykluszeit des Klebprozesses und die Ausbeute des Klebprozesses.
- Mit dem weltweiten Ausbruch der Pandemie und den restriktiven Maßnahmen zur Eindämmung der Ausbreitung von COVID-19 wurde die globale Lieferkette der Halbleiterbondgeräteindustrie erheblich gestört, was sich auf die Produktionskapazitäten verschiedener Unternehmen auswirkte. Obwohl die Zahl der COVID-19-infizierten Patienten erheblich zurückgegangen ist, müssen immer noch hervorstechende Probleme bei der Materialversorgung und -nachfrage nach diesen Komponenten angegangen werden, was das Wachstum des Marktes herausfordert.
Markttrends für Halbleiter-Bonding-Geräte
Leistungs-IC und leistungsdiskrete Anwendungssegmente halten einen bedeutenden Marktanteil
- Leistungshalbleiterbauelemente ermöglichen eine effiziente Energieverwaltung, -umwandlung und -steuerung für verschiedene Anwendungen. Der zunehmende Fokus auf Energieeinsparung und Stromverbrauch erhöht die Bedeutung von Leistungshalbleiterbauelementen. Der Markt wird durch reduzierte Verluste, verbesserte Steuerbarkeit, längere Haltbarkeit und zuverlässige Leistung unter Standard- und Fehlerbedingungen unterstützt. Da die Nachfrage nach Leistungshalbleitern weiter steigt, wird auch ein Anstieg des Marktes für Leistungs-ICs und Bonding-Technologie erwartet.
- Das Wachstum des Segments wird durch die rasante Digitalisierung der Industrie und die zunehmende Anzahl vernetzter Geräte vorangetrieben. Diese Bauelemente erfordern ein effizientes Energiemanagement und leistungsstarke Leistungshalbleiterbauelemente. Durch den Einsatz dieser Geräte wird eine optimale Leistungsumwandlung erreicht, Energieverluste reduziert und die Gesamtenergieeffizienz elektronischer Systeme verbessert.
- Das Segment verzeichnet aufgrund der steigenden Nachfrage nach energiereichen und energieeffizienten Geräten ein Wachstum. Diese Nachfrage wird durch die Verbreitung drahtloser und tragbarer elektronischer Produkte, die Verlagerung der Automobilindustrie in Richtung Elektrifizierung und die zunehmende Nutzung dieser Geräte weiter angeheizt.
- Die Branche hat eine zunehmende Neigung zu Leistungsmodulen und integrierten Lösungen. Hersteller von Leistungshalbleitern entwickeln kompakte, hochintegrierte Module, die verschiedene Leistungskomponenten wie Schalter, Dioden und Treiber zusammenführen, um das Systemdesign zu rationalisieren, die Anzahl der Komponenten zu verringern und die Gesamtsystemeffizienz zu verbessern. Leistungshalbleiterunternehmen können davon profitieren, wenn sie die Hindernisse und Markttrends frühzeitig im Produktentwicklungsprozess verstehen, um wettbewerbsfähig zu bleiben. Es wird erwartet, dass die zunehmenden Investitionen der Anbieter zur Steigerung der Produktion von Leistungshalbleitern die Expansion des Marktes beeinträchtigen werden.
- Eine bedeutende Entwicklung bei Leistungs-ICs und diskreten Komponenten verbessert die Effizienz des Energiemanagements. Jüngste Fortschritte bei Systemarchitekturen haben zu effizienteren AC/DC-Netzteilen mit reduzierter Größe und Komponentenanzahl geführt. Die Einführung neuer Power-over-Ethernet (PoE)-Standards hat höhere Leistungsübertragungsmöglichkeiten ermöglicht und die Schaffung innovativer Gerätekategorien wie vernetzter Beleuchtung erleichtert. Die zunehmende Betonung der Minimierung des Stromverbrauchs durch Elektronikhersteller und die steigende Nachfrage aus der Unterhaltungselektronik sind die Hauptgründe für die Notwendigkeit von Leistungs-ICs. Diese Faktoren könnten möglicherweise die Nachfrage nach Klebegeräten ankurbeln.
- Die Übertragungsgeschwindigkeiten von Smartphones steigen deutlich an, was Batteriemodule erfordert, um den Verarbeitungsanforderungen gerecht zu werden. Netzteile enthalten jetzt diskrete Halbleiter, was zu einem erwarteten Nachfrageschub führt, der durch den steigenden Verkauf von batteriebetriebenen Geräten angetrieben wird. Das Wachstum von IoT-Anwendungen wird voraussichtlich die Nachfrage nach diskreten Halbleitern weiter ankurbeln.
- Laut Ericsson erreichten beispielsweise die weltweiten Mobilfunk-IoT-Verbindungen im Jahr 2022 1,9 Milliarden und werden bis 2027 schätzungsweise 5,5 Milliarden erreichen. Es wird erwartet, dass die zunehmende Durchdringung von Smartphones mit der Entwicklung von 5G das Wachstum des Marktes vorantreiben wird.
- In ähnlicher Weise wird erwartet, dass das Wachstum des Marktes durch die bedeutenden technologischen Fortschritte bei IoT-Anwendungen positiv beeinflusst wird, die darauf abzielen, Verbrauchern weltweit technologisch verbesserte vernetzte Geräte zur Verfügung zu stellen. Die Ausweitung von IoT-Anwendungen hat die Verbreitung von intelligenten Geräten und kleinen Halbleitern erhöht und damit die Nachfrage nach fortschrittlichen Halbleiter-Bonding-Geräten angekurbelt.
- Ericsson erklärte, dass sich die Zahl der vernetzten Geräte weltweit von 2022 bis 2028 fast verdoppeln wird, was vor allem auf die Zunahme von IoT-Geräten mit kurzer Reichweite zurückzuführen ist. Es wird erwartet, dass es bis 2028 etwa 28,72 Milliarden solcher Geräte geben wird. Mit der wachsenden Nachfrage nach diesen IoT-verbundenen Geräten wird erwartet, dass die Nachfrage nach Leistungs-ICs steigen wird, wodurch das Wachstum des Marktes für Bonding-Geräte gefördert wird.

Der asiatisch-pazifische Raum wird voraussichtlich der am schnellsten wachsende Markt sein
- Die Halbleiterindustrie hat sich zu einem entscheidenden Motor des Wirtschaftswachstums in Asien entwickelt. Die schnelle Expansion und der technologische Fortschritt sind zu einem wichtigen Bestandteil der globalen Lieferkette geworden.
- Der asiatisch-pazifische Raum hält weltweit einen großen Anteil an Halbleitergießereien, wobei in der Region prominente Unternehmen wie Samsung Electronics, TSMC usw. vertreten sind. Südkorea, Taiwan, Japan und China haben bedeutende Marktanteile in der Region. Taiwan hält einen bedeutenden Anteil an den Gießereien der Welt und ist eine wichtige Region in der Halbleiter-Wertschöpfungskette. Es wird erwartet, dass die zunehmenden Investitionen in den Ausbau der Halbleiterfertigungskapazitäten in der Region das Wachstum des Marktes erheblich unterstützen werden.
- Im September 2023 legte China einen Fonds in Höhe von 40 Milliarden US-Dollar auf, um die Halbleiterindustrie anzukurbeln. China plant die Einrichtung eines staatlich unterstützten Investmentfonds, um den Abstand zu globalen Konkurrenten, insbesondere den Vereinigten Staaten, zu verringern. Diese Initiative ist bereit, sich als der bedeutendste der drei Fonds zu entwickeln, die vom China Integrated Circuit Industry Investment Fund, allgemein bekannt als Big Fund, verwaltet werden. Der chinesische Präsident Xi Jinping betonte die entscheidende Bedeutung der Selbstversorgung mit Halbleitern, vor allem als Reaktion auf die von den Vereinigten Staaten verhängten Exportkontrollmaßnahmen. Der jüngste Fonds wurde von den chinesischen Behörden genehmigt, wobei das Finanzministerium 60 Mrd. CNY (8,30 Mrd. USD) zusagte.
- Basierend auf seiner wachsenden inländischen Chipnachfrage wird geschätzt, dass China die Vereinigten Staaten als weltweit führendes Kraftpaket in der Halbleiterindustrie überholen wird. Bis 2030 wird sich der Halbleitermarkt voraussichtlich verdoppeln und mehr als 1 Billion US-Dollar erreichen, wobei China nach Angaben der Semiconductor Industry Association über 60 % zu diesem Anstieg beiträgt. Es wird erwartet, dass ein solches exponentielles Wachstum die Nachfrage nach Halbleiter-Bonding-Geräten erhöhen wird.
- Die neue Halbleiterfabrik würde Chips für Anwendungen wie Display-Treiber, Power-Management-ICs, Mikrocontroller und Hochleistungs-Computing-Logik herstellen und damit die wachsende Nachfrage in Märkten wie Computer und Datenspeicherung, Automobil, drahtlose Kommunikation und künstliche Intelligenz bedienen. Diese Fabrik soll eine Produktionskapazität von bis zu 50.000 Wafern pro Monat haben, und der erste Chip wird die Anlage vor Ende 2026 verlassen.

Branchenübersicht für Halbleiter-Bonding-Geräte
Der Markt für Halbleiter-Bonding-Geräte ist stark fragmentiert, mit großen Akteuren wie EV Group, ASMPT Semiconductor Solutions, MRSI Systems (Myronic AB), WestBond Inc. und Panasonic Holding Corporation. Marktteilnehmer beteiligen sich an Partnerschaften und Übernahmen, um nachhaltige Wettbewerbsvorteile zu erzielen und ihr Produktangebot zu verbessern.
- November 2023 - Die EV Group (EVG) gab den Abschluss der Bauarbeiten für die nächste Phase der Erweiterung der EVG-Unternehmenszentrale bekannt. Die Manufacturing V-Anlage dient EVG als Fertigungsabteilung für Ausrüstungskomponenten und bietet eine deutliche Erweiterung der Produktionsfläche und der Lagerfläche. Die Eröffnung der Manufacturing V-Anlage markiert die jüngste Expansionsphase und Investition von EVG, die weiterhin von der anhaltend hohen Nachfrage nach EVGs Hybrid-Bonding-Lösungen und anderen Prozesslösungen sowie Prozessentwicklungsdienstleistungen profitiert, um den schnell wachsenden Markt für fortschrittliche Verpackungen und den Markt für 3D-/heterogene Integration zu unterstützen.
- September 2023 - MRSI Systems (Mycronic AB) kündigte die Einführung der neuen Variante der etablierten MRSI-7001-Plattform, des MRSI 7001HF, an. Der 7001HF verfügt über einen beheizten Bondkopf, der während des Bondens bis zu 500 N Kräfte aufbringen kann. Der beheizte Bondkopf sorgt auch für eine Erwärmung von oben bei einer Temperatur von 400 °C. Dies macht den 7001HF zum perfekten Werkzeug für High-Force-Die-Bonder für Anwendungen wie das Sintern von Leistungshalbleitern für IC-Packaging oder Thermokompressionsbonder für IC-Packaging.
Marktführer für Halbleiter-Bonding-Geräte
EV Group
ASMPT Semiconductor Solutions
MRSI Systems. (Myronic AB)
WestBond Inc.
Panasonic Holding Corporation
- *Haftungsausschluss: Hauptakteure in keiner bestimmten Reihenfolge sortiert
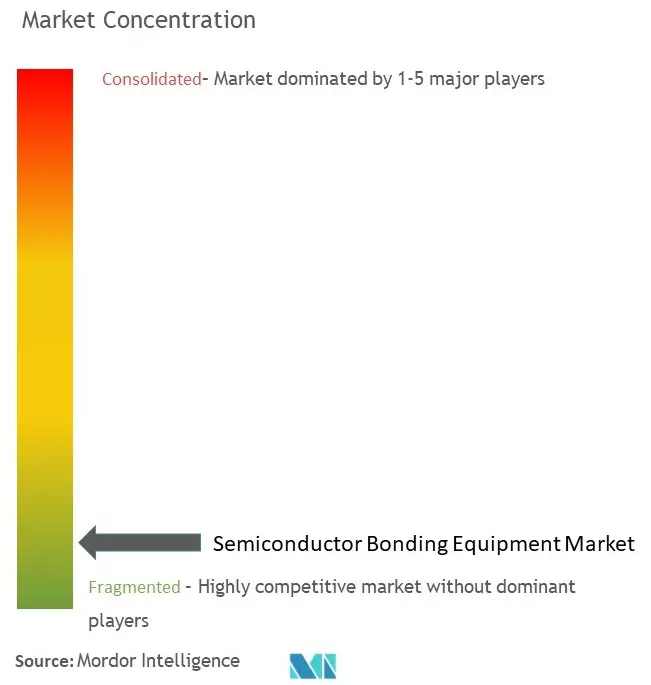
Marktnachrichten für Halbleiter-Bonding-Geräte
- Dezember 2023 - Panasonic Industrial Automation und Mouser Electronics, der autorisierte globale Distributor der neuesten elektronischen Komponenten und Produkte für die industrielle Automatisierung, haben eine Vertriebsvereinbarung geschlossen. Gemäß den Bedingungen der Vereinbarung wird Panasonic Industrial Automation seinen Kunden eine breite Palette integrierter Lösungen für Automatisierungsmärkte anbieten, die von der Automobilindustrie über die Halbleiter- und Verpackungsindustrie bis hin zur Biomedizin reichen.
- Dezember 2023 - Tokyo Electron gab bekannt, dass es eine Extreme Laser Lift Off (XLO)-Technologie entwickelt hat, die zu Innovationen bei der 3D-Integration fortschrittlicher Halbleiterbauelemente beiträgt, die permanentes Waferbonden einsetzen. Diese neue Technologie für zwei dauerhaft gebondete Siliziumwafer verwendet einen Laser, um das obere Siliziumsubstrat mit einer integrierten Schaltungsschicht vom unteren Substrat zu trennen.
Segmentierung der Halbleiter-Bonding-Ausrüstung
Beim Waferbonden wird ein dünner Substratwafer mit Hilfe von Wafersubstrat-Bonding-Einheiten auf eine Trägerträgerscheibe geklebt. Um dies zu erreichen, werden verschiedene Klebetechniken verwendet, die verschiedene Geräte oder Maschinen erfordern. Zu den Gerätetypen gehören permanente Verklebung, temporäre Verklebung und hybride Verklebung. Der Umfang des Marktes für Bonding-Geräte ist auf Anwendungen wie Advanced Packaging, Leistungs-ICs und leistungsdiskrete, photonische Bauelemente, MEMS-Sensoren und -Aktuatoren, technische Substrate, HF-Geräte und CMOS-Bildsensoren (CIS) beschränkt.
Der Markt für Halbleiter-Bonding-Geräte ist nach Typ (Permanent-Bonding-Ausrüstung, temporäre Bonding-Ausrüstung, Hybrid-Bonding-Ausrüstung), Anwendung (Advanced Packaging, Leistungs-IC und leistungsdiskret, photonische Bauelemente, MEMS-Sensoren und -Aktuatoren, technische Substrate, HF-Geräte, CMOS-Bildsensoren (CIS)) und Geografie (Nordamerika, Asien, Europa, Lateinamerika sowie Naher Osten und Afrika) unterteilt. Die Marktgrößen und Prognosen werden für alle oben genannten Segmente in USD angegeben.
| Ausrüstung für dauerhaftes Kleben |
| Temporäre Klebeausrüstung |
| Hybrid-Bonding-Ausrüstung |
| Fortschrittliche Verpackung |
| Leistungs-IC und diskrete Leistung |
| Photonische Geräte |
| MEMS-Sensoren und -Aktoren |
| Technische Substrate |
| HF-Geräte |
| CMOS-Bildsensoren (CIS) |
| Nordamerika |
| Europa |
| Asien |
| Australien und Neuseeland |
| Lateinamerika |
| Naher Osten und Afrika |
| Nach Typ | Ausrüstung für dauerhaftes Kleben |
| Temporäre Klebeausrüstung | |
| Hybrid-Bonding-Ausrüstung | |
| Nach Anwendung | Fortschrittliche Verpackung |
| Leistungs-IC und diskrete Leistung | |
| Photonische Geräte | |
| MEMS-Sensoren und -Aktoren | |
| Technische Substrate | |
| HF-Geräte | |
| CMOS-Bildsensoren (CIS) | |
| Nach Geografie | Nordamerika |
| Europa | |
| Asien | |
| Australien und Neuseeland | |
| Lateinamerika | |
| Naher Osten und Afrika |
Häufig gestellte Fragen zur Marktforschung für Halbleiter-Bonding-Geräte
Wie groß ist der Markt für Halbleiter-Bonding-Geräte?
Es wird erwartet, dass die Marktgröße für Halbleiter-Bonding-Geräte im Jahr 2024 542,38 Mio. USD erreichen und mit einer CAGR von 4,90 % wachsen wird, um bis 2029 689,03 Mio. USD zu erreichen.
Wie groß ist der aktuelle Markt für Halbleiter-Bonding-Geräte?
Im Jahr 2024 wird die Marktgröße für Halbleiter-Bonding-Geräte voraussichtlich 542,38 Mio. USD erreichen.
Wer sind die Hauptakteure auf dem Markt für Halbleiter-Bonding-Geräte?
EV Group, ASMPT Semiconductor Solutions, MRSI Systems. (Myronic AB), WestBond Inc., Panasonic Holding Corporation sind die wichtigsten Unternehmen, die auf dem Markt für Halbleiter-Bonding-Geräte tätig sind.
Welches ist die am schnellsten wachsende Region auf dem Markt für Halbleiter-Bonding-Geräte?
Es wird geschätzt, dass der asiatisch-pazifische Raum im Prognosezeitraum (2024-2029) mit der höchsten CAGR wachsen wird.
Welche Region hat den größten Anteil am Markt für Halbleiter-Bonding-Geräte?
Im Jahr 2024 hat der asiatisch-pazifische Raum den größten Marktanteil am Markt für Halbleiter-Bonding-Geräte.
Welche Jahre deckt dieser Markt für Halbleiter-Bonding-Geräte ab und wie groß war der Markt im Jahr 2023?
Im Jahr 2023 wurde die Marktgröße für Halbleiter-Bonding-Geräte auf 515,80 Mio. USD geschätzt. Der Bericht deckt die historische Marktgröße des Marktes für Halbleiter-Bonding-Geräte für Jahre ab 2019, 2020, 2021, 2022 und 2023. Der Bericht prognostiziert auch die Marktgröße für Halbleiter-Bonding-Geräte für Jahre 2024, 2025, 2026, 2027, 2028 und 2029.
Seite zuletzt aktualisiert am:
Branchenbericht für Halbleiter-Bonding-Geräte
Statistiken für den Marktanteil, die Größe und die Umsatzwachstumsrate von Halbleiter-Bonding-Geräten im Jahr 2024, erstellt von Mordor Intelligence™ Industry Reports. Die Analyse von Halbleiter-Bonding-Geräten umfasst einen Marktprognoseausblick für 2029 und einen historischen Überblick. Holen Sie sich eine Probe dieser Branchenanalyse als kostenlosen PDF-Download des Berichts.



