
Marktanalyse für Fan-Out-Verpackungen
Die Größe des Fan-Out-Verpackungsmarkts wird im Jahr 2024 auf 2,94 Milliarden US-Dollar geschätzt und soll bis 2029 6,30 Milliarden US-Dollar erreichen, was einem jährlichen Wachstum von 16,5 % im Prognosezeitraum (2024–2029) entspricht.
Die Expansion dieses Marktes wird durch technologische Fortschritte bei halbleiterbasierten Technologien und eine schnell steigende Nachfrage in verschiedenen Sektoren vorangetrieben.
- Fan-out-Wafer-Level-Packaging (FOWLP) findet zunehmend Anwendung bei platzsparenden Geräten wie Smartphones, da hochleistungsfähige, energieeffiziente Gehäuse mit dünnem und kleinem Formfaktor erforderlich sind. Darüber hinaus sind in modernen Smartphones durchschnittlich fünf bis sieben Wafer-Level-Gehäuse (insbesondere Fan-Out) zu finden, und es wird erwartet, dass die Zahl in Zukunft noch steigen wird. Dies liegt daran, dass sie nach und nach die traditionelleren Package-on-Package (PoP)-Memory-on-Logic-Lösungen ersetzen.
- Darüber hinaus hat der zunehmende Einsatz von künstlicher Intelligenz und maschinellem Lernen in verschiedenen Bereichen zu einer verstärkten Installation von Hochleistungsrechnern auf dem Markt geführt. Es wird erwartet, dass die UHD-Fanout-Technologie auf die Cloud, 5G, autonome Autos und KI-Chips angewendet wird und im Prognosezeitraum den Verpackungstrend anführen wird.
- Die südkoreanische Halbleiterindustrie unternimmt weiterhin Anstrengungen, um die Technologien 3D TSV (Through-Silicon Via), Packaging und FoWLP (Fan-out Wafer-Level Packaging) sowie FoPLP (Fan-out Panel-Level Packaging) zu verbessern und effektiver zu machen die Leistungsfähigkeit von Halbleitern und den Integrationsgrad zu erhöhen.
- Im Dezember 2021 gab die Nepes Laweh Corporation die erfolgreiche Produktion der weltweit ersten 600 mm x 600 mm großen Panel Level Packaging (PLP) unter Verwendung der Fan-Out-Technologien der M-Serie von Deca bekannt. Nach Angaben des Unternehmens hat die Fan-out-Panel Level Packaging (FOPLP)-Linie im dritten Quartal die Kundenzertifizierung bestanden, eine konstante Ausbeute erzielt und mit der Massenproduktion in vollem Umfang begonnen.
- Da südkoreanische Unternehmen in der Vergangenheit für diese Systeme auf ausländische Unternehmen angewiesen waren, erwartet KOSTEK in Zukunft einen enormen Importsubstitutionseffekt. Seine temporären Wafer-Bonder- und Debonding-Techniken können während eines Fan-Out-Packaging-Prozesses eingesetzt werden.
- Mit dem Ausbruch von COVID-19 verzeichnete der Markt für Halbleiterverpackungen aufgrund von Einschränkungen im Warenverkehr und schwerwiegenden Störungen in der Halbleiterlieferkette einen Wachstumsrückgang. Im ersten Quartal 2020 führte COVID-19 zu niedrigen Lagerbeständen bei Kunden von Halbleiteranbietern und Vertriebskanälen. Aufgrund des Coronavirus-Ausbruchs wird der Markt voraussichtlich langfristige Auswirkungen haben.
Verbreiten Sie Verpackungsmarkttrends
High-Density-Fan-Out, um einen signifikanten Anteil zu halten
- Der High-Density-Fanout ist für Anwendungen im mittleren bis oberen Preissegment gedacht und hat zwischen 6 und 12 I/Os pro mm2 und zwischen 15/15 μm und 5/5 μm Leitung/Abstand. Fan-Out-Verpackungen mit hoher Dichte erfreuen sich immer größerer Beliebtheit, da sie den Formfaktor- und Leistungsanforderungen für Mobiltelefonverpackungen gerecht werden. Zu den wichtigsten Bausteinen dieser Technologie gehören Redistribution Layer (RDL)-Metall und Mega-Pillar-Plating.
- Die InFO-Technologie von TSMC ist eines der bemerkenswertesten Beispiele für Fan-Out mit hoher Dichte. Diese Technologie zielt auf Anwendungen mit höherer Pinzahl ab, beispielsweise auf Anwendungsprozessoren (AP). Das Unternehmen plant, sein FO-WLP-Segment auf Technologien wie inFO-Antenna-in-Package (AiP) und inFO-on-Substrate auszudehnen. Diese Pakete werden in Autos, Servern und Smartphones verwendet. Apple gehörte zu den ersten Anwendern dieser neuen Technologie und nutzte sie im A10-Anwendungsprozessor des Ende 2016 eingeführten iPhone 7.
- Aufgrund dieser Vorteile erwogen Qualcomm und MediaTek im Dezember 2021 die Einführung von Fan-out-PoP bei der Produktion ihrer Flaggschiff-Smartphone-Anwendungsprozessoren und traten damit in die Fußstapfen von Apple, das die InFO_PoP-Technologie von TSMC zur Verpackung seiner iPhone-Chips nutzte.
- Darüber hinaus wird erwartet, dass das Wachstum des Halbleitermarktes zusammen mit der Entwicklung hochdichter Fan-Out-Verpackungslösungen das Marktwachstum im Prognosezeitraum ankurbeln wird. Beispielsweise gab Changdian Technology, der weltweit führende Hersteller von kombinierten Schaltkreisen und Technologielösungsanbieter, im Juli 2021 die offizielle Einführung der gesamten Reihe von Fan-out-Gehäuseoptionen mit sehr hoher Dichte für XDFOI-Chips bekannt, die eine kostengünstige Bereitstellung ermöglichen sollen. effektive, hochdichte Konnektivitäts-, Hochintegrations- und Hochzuverlässigkeitslösungen für die heterogene Chip-Integration.
- Auch bei der Herstellungsmethode für High-Density Fan-Out Wafer Level Packaging (FOWLP) wurden Fortschritte erzielt. Es werden Lösungen entwickelt, um die Chipgröße/-höhe zu reduzieren und die Produktionskosten zu senken und gleichzeitig die Zuverlässigkeit, Energieeffizienz, Gerätegeschwindigkeit und Multifunktionsintegration zu verbessern. Beispielsweise bietet SPTS Technologies führenden Halbleiterverpackungsunternehmen mehrere Plasmaätz- und Abscheidungsprozesstechnologien für fortschrittliche Verpackungsschemata wie das hochdichte Fan-out-Wafer-Level-Packaging an.
- Darüber hinaus können High-Density-Fan-out-Pakete (HDFO) diesen Anforderungen der Miniaturisierung gerecht werden, indem sie über Fertigungsmöglichkeiten für die Wafer-Level-Verarbeitung verfügen und gleichzeitig 3D-Strukturen mithilfe von Durchformungsverbindungen wie hohen Kupfersäulen (Cu) und Durchgangsgehäusen erzeugen können Vias (TPVs) und fortschrittliche Flip-Chip-Gehäusetechnologien.

Taiwan wird einen bedeutenden Marktanteil halten
- Taiwan beherbergt einige der größten Halbleiterhersteller, die die Nachfrage nach fortschrittlichen Halbleiterverpackungen, insbesondere in PLPs, ankurbeln. Laut einer staatlichen Denkfabrik, dem Science and Technology International Strategy Center, soll Taiwans Produktion im Jahr 2021 um 25,9 % auf 147 Milliarden US-Dollar wachsen.
- Nach Angaben der Semiconductor Industry Association (SIA) erwirtschaftet der asiatisch-pazifische Raum mehr als 50 % des weltweiten Umsatzes mit Halbleitern; Dies wiederum bietet taiwanesischen Anbietern die Möglichkeit, FOWLP für zunehmende Halbleiteranwendungen zu liefern.
- Die meisten Unternehmen im Land erweitern ihre Produktionskapazität für Fan-out-Verpackungen, was voraussichtlich die Exporte weiter steigern und zur Entwicklung des lokalen Marktes beitragen wird. Beispielsweise wird Intel, das kürzlich seine Rückkehr in die Gießereiindustrie angekündigt hat, gleichzeitig 3,5 Milliarden US-Dollar in New Mexico investieren, um eine Halbleiterverpackungsfabrik zu errichten, die in der zweiten Hälfte des Jahres 2022 ihren Betrieb aufnehmen wird.
- Darüber hinaus begann ASE, ein reines Halbleiter-Post-Processing-Unternehmen (OAST), im Juni 2021 mit der Investition in fortschrittliche Verpackungsanlagen als Reaktion auf die Angebots- und Nachfrageknappheit bei Halbleitern. Das Unternehmen beschleunigt die Expansion durch den Kauf einer großen Menge an Halbleiterfertigungsanlagen für WLP- und PLP-Prozesse von HANMI Semiconductor.
- Darüber hinaus hat der wachsende Markt für drahtlose Kommunikation und Hochleistungsrechnen der fünften Generation (5G) den Herstellern die Entwicklung neuer Technologien ermöglicht. Als alleiniger Marktführer im High-Density-Fanout-Segment plant TSMC beispielsweise, sein FO-WLP-Segment auf Technologien wie inFO-Antenna-in-Package (AiP) und inFO-on-Substrate (oS) auszudehnen.

Überblick über die Fan-Out-Verpackungsbranche
Der Markt ist mäßig fragmentiert und es sind zahlreiche Akteure vertreten. Zu den wichtigsten Akteuren auf dem globalen Fan-Out-Verpackungsmarkt zählen unter anderem Taiwan Semiconductor Manufacturing Company Limited, Jiangsu Changjiang Electronics Tech Co., Amkor Technology Inc., Samsung Electro-Mechanics und Powertech Technology Inc. Diese Akteure betreiben unter anderem Produktinnovationen, Fusionen und Übernahmen, um ihren Marktanteil zu erhöhen.
- November 2021 – Amkor Technology, Inc., ein Anbieter von Verpackungs- und Testdienstleistungen für Halbleiter, gab bekannt, dass er beabsichtigt, in Bac Ninh, Vietnam, eine intelligente Fabrik zu errichten. In der ersten Phase der geplanten Fabrik wird es darum gehen, den weltweit führenden Halbleiter- und Elektronikherstellern Montage- und Testdienstleistungen für Advanced System in Package (SiP) anzubieten.
- Februar 2021 – Samsung Foundry hat bei Behörden in Arizona, New York und Texas Unterlagen eingereicht, um eine hochmoderne Halbleiterfertigungsanlage in den USA zu bauen. Die potenzielle Fabrik in der Nähe von Austin, Texas, wird voraussichtlich über 17 Milliarden US-Dollar kosten und 1.800 Arbeitsplätze schaffen. Sie soll im vierten Quartal 2023 online gehen.
Verbreiten Sie die Marktführer im Verpackungsmarkt
Taiwan Semiconductor Manufacturing Company Limited
Jiangsu Changjiang Electronics Tech Co.
Amkor Technology Inc.
Samsung Electro-Mechanics
Powertech Technology Inc.
- *Haftungsausschluss: Hauptakteure in keiner bestimmten Reihenfolge sortiert
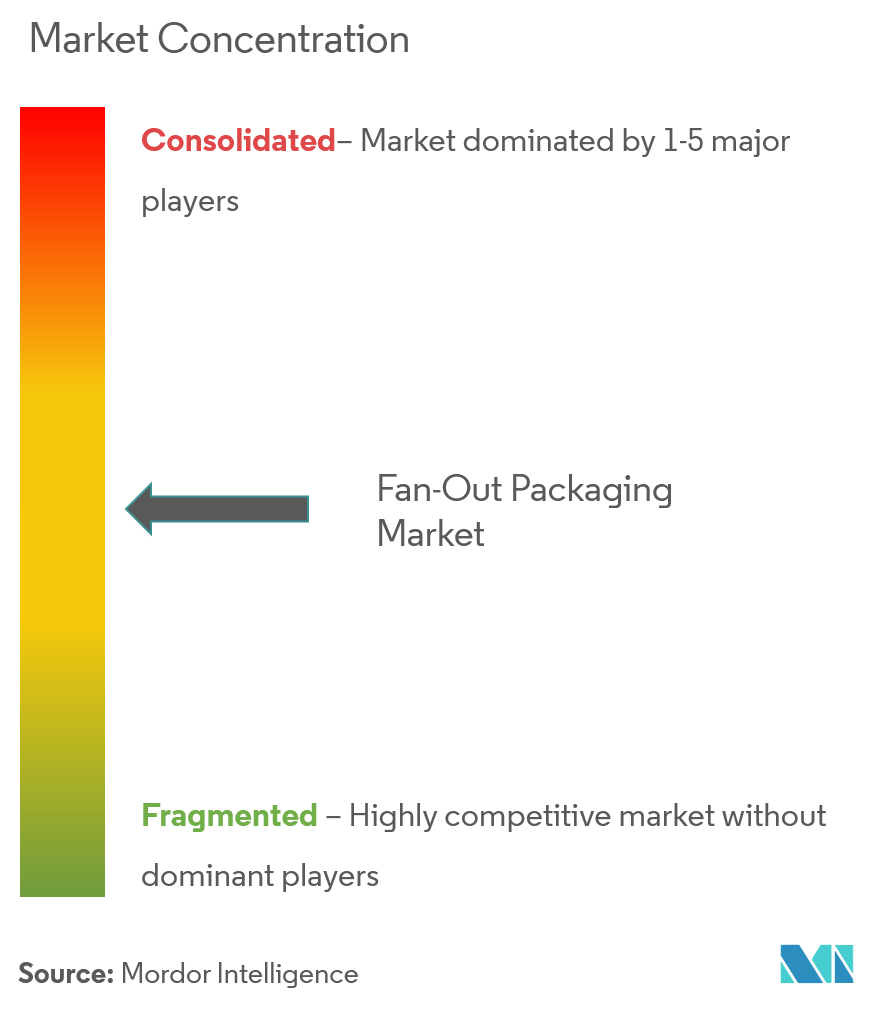
Fan-out Verpackungsmarktnachrichten
- Mai 2022 – SkyWater Technology, ein vertrauenswürdiger Technologierealisierungspartner, und Adeia, die neu gegründete Marke der Xperi Holding Corporation, gaben bekannt, dass SkyWater einen Technologielizenzvertrag mit der Xperi Corporation unterzeichnet hat. SkyWater und seine Kunden werden Zugang zu Adeias ZiBond-Direktbridging- und DBI®-Hybrid-Bonding-Technologien und IP haben, um kommerzielle und staatliche Produkte der nächsten Generation zu verbessern. Das SkyWater-Werk in Florida entwickelt heterogene Integrationsplattformlösungen, einschließlich Silizium-Interposer- und Fan-out-Wafer-Level-Packaging-Technologien (FOWLP).
- Juli 2021 – Die JCET Group, ein weltweit führender Anbieter von IC-Fertigungs- und Innovationsdienstleistungen, gab die offizielle Einführung von XDFOITM bekannt, einer neuartigen Technologie für Fan-Out-Verpackungen mit ultrahoher Dichte. Diese bahnbrechende Technologie wird kostengünstige Alternativen mit maximaler Integration, hochdichter Konnektivität und hoher Zuverlässigkeit für die verschiedenen Chipsätze liefern.
- März 2021 – Deca, ein marktführender reiner Technologieanbieter für innovative Halbleiterverpackungen, hat seinen neuen APDKTM-Ansatz (Adaptive Patterning Design Kit) vorgestellt. Deca arbeitete bei der Entwicklung der Lösung mit Advanced Semiconductor Engineering, Inc. (ASE) und Siemens Digital Industrial Software zusammen.
Segmentierung der Verpackungsindustrie auffächern
Bei Fan-Out-Gehäusen handelt es sich um alle Gehäuse, deren Anschlüsse von der Chipoberfläche aus aufgefächert sind und so zusätzliche externe I/Os ermöglichen. Anstatt die Dies auf ein Substrat oder einen Interposer zu setzen, werden sie bei herkömmlichen Fan-out-Verpackungen vollständig in eine Epoxid-Formmasse eingetaucht. Der Fan-Out-Verpackungsmarkt umfasst die Untersuchung des Markttyps (Core-Fan-Out, High-Density-Fan-Out, Ultra-High-Density-Fan-Out), Trägertyp (200 mm, 300 mm, Panel), Geschäftsmodell (OSAT, Foundary, IDM) und Geographie (Taiwan, China, USA, Südkorea, Japan, Europa).
| Kern-Fan-Out |
| High-Density-Fan-Out |
| Ultra-High-Density-Fan-Out |
| 200 mm |
| 300 mm |
| Panel |
| BAUGRUPPEN |
| Gründer |
| IDM |
| Taiwan |
| China |
| Vereinigte Staaten |
| Südkorea |
| Japan |
| Europa |
| Nach Typ | Kern-Fan-Out |
| High-Density-Fan-Out | |
| Ultra-High-Density-Fan-Out | |
| Nach Trägertyp | 200 mm |
| 300 mm | |
| Panel | |
| Nach Geschäftsmodell | BAUGRUPPEN |
| Gründer | |
| IDM | |
| Erdkunde | Taiwan |
| China | |
| Vereinigte Staaten | |
| Südkorea | |
| Japan | |
| Europa |
Häufig gestellte Fragen zur Fan-Out-Verpackungsmarktforschung
Wie groß ist der Fan-Out-Verpackungsmarkt?
Es wird erwartet, dass der Markt für Fan-Out-Verpackungen im Jahr 2024 ein Volumen von 2,94 Milliarden US-Dollar erreichen und bis 2029 mit einer durchschnittlichen jährlichen Wachstumsrate von 16,5 % auf 6,30 Milliarden US-Dollar wachsen wird.
Wie groß ist der Fan-Out-Verpackungsmarkt derzeit?
Im Jahr 2024 wird die Marktgröße für Fan-Out-Verpackungen voraussichtlich 2,94 Milliarden US-Dollar erreichen.
Wer sind die Hauptakteure im Fan-Out-Verpackungsmarkt?
Taiwan Semiconductor Manufacturing Company Limited, Jiangsu Changjiang Electronics Tech Co., Amkor Technology Inc., Samsung Electro-Mechanics, Powertech Technology Inc. sind die wichtigsten Unternehmen, die auf dem Fan-Out-Verpackungsmarkt tätig sind.
Welches ist die am schnellsten wachsende Region im Fan-Out-Verpackungsmarkt?
Schätzungen zufolge wird der asiatisch-pazifische Raum im Prognosezeitraum (2024–2029) mit der höchsten CAGR wachsen.
Welche Region hat den größten Anteil am Fan-Out-Verpackungsmarkt?
Im Jahr 2024 hat der asiatisch-pazifische Raum den größten Marktanteil im Fan-Out-Verpackungsmarkt.
Welche Jahre deckt dieser Fan-Out-Verpackungsmarkt ab und wie groß war der Markt im Jahr 2023?
Im Jahr 2023 wurde die Größe des Fan-Out-Verpackungsmarkts auf 2,52 Milliarden US-Dollar geschätzt. Der Bericht deckt die historische Marktgröße des Fan-Out-Verpackungsmarkts für die Jahre 2019, 2020, 2021, 2022 und 2023 ab. Der Bericht prognostiziert auch die Marktgröße des Fan-Out-Verpackungsmarkts für die Jahre 2024, 2025, 2026, 2027, 2028 und 2029.
Seite zuletzt aktualisiert am:
Branchenbericht zur Fan-Out-Verpackung
Statistiken für den Marktanteil, die Größe und die Umsatzwachstumsrate von Fan-Out-Verpackungen im Jahr 2024, erstellt von Mordor Intelligence™ Industry Reports. Die Fan-Out-Verpackungsanalyse umfasst eine Marktprognose bis 2029 und einen historischen Überblick. Holen Sie sich ein Beispiel dieser Branchenanalyse als kostenlosen PDF-Download.



