
Анализ рынка упаковки Fan Out
Размер рынка упаковки Fan Out оценивается в 2,94 миллиарда долларов США в 2024 году и, как ожидается, достигнет 6,30 миллиарда долларов США к 2029 году, среднегодовой темп роста составит 16,5% в течение прогнозируемого периода (2024-2029 годы).
Расширение этого рынка обусловлено технологическим прогрессом в области полупроводниковых технологий и быстро растущим спросом в различных секторах.
- Упаковка на уровне пластины с разветвлением (FOWLP) находит все более широкое применение в устройствах, чувствительных к занимаемой площади, таких как смартфоны, из-за требований к высокопроизводительным, энергоэффективным корпусам тонкого и малого форм-фактора. Кроме того, в современных смартфонах в среднем можно найти от пяти до семи корпусов уровня пластин (особенно разветвленных), и ожидается, что в будущем их число увеличится. Это связано с тем, что они постепенно заменяют более традиционные решения пакет-на-пакете (PoP) память-на-логике.
- Более того, растущее применение искусственного интеллекта и машинного обучения в различных областях привело к увеличению количества высокопроизводительных вычислений на рынке. Ожидается, что технология разветвления UHD будет применяться к облаку, 5G, автономным автомобилям и чипам искусственного интеллекта и будет лидировать в тенденции упаковки в течение прогнозируемого периода.
- Полупроводниковая промышленность Южной Кореи продолжает прилагать усилия для улучшения и повышения эффективности технологий 3D TSV (сквозные кремниевые переходы), упаковки и FoWLP (упаковка на уровне пластины с разветвлением) и FoPLP (упаковка на уровне панели с разветвлением). повысить производительность полупроводников и степень интеграции.
- В декабре 2021 года корпорация Nepes Laweh объявила об успешном производстве первой в мире панельной упаковки (PLP) размером 600 x 600 мм с использованием технологий разветвления Deca серии M. По данным компании, линия упаковки с разветвленной панелью (FOPLP) прошла сертификацию потребителя в третьем квартале, обеспечила стабильную производительность и приступила к полномасштабному массовому производству.
- Поскольку южнокорейские компании в прошлом зависели от иностранных компаний в отношении этих систем, КОСТЕК ожидает огромного эффекта импортозамещения в будущем. Его методы временного склеивания пластин и отсоединения пластин можно использовать в процессе упаковки с разветвлением.
- С вспышкой COVID-19 на рынке упаковки для полупроводников наблюдалось снижение темпов роста из-за ограничений на перемещение товаров и серьезных сбоев в цепочке поставок полупроводников. В первом квартале 2020 года COVID-19 стал причиной низкого уровня запасов у клиентов поставщиков полупроводников и каналов сбыта. Ожидается, что рынок станет свидетелем долгосрочного воздействия из-за вспышки коронавируса.
Тенденции рынка упаковки Fan Out
Разветвление высокой плотности для удержания значительной доли
- Предназначенный для приложений среднего и высокого класса, разветвленный выход высокой плотности имеет от 6 до 12 входов/выходов на мм2 и от 15/15 до 5/5 мкм в линии/пространстве. Разветвленная упаковка высокой плотности приобрела популярность, поскольку соответствует форм-фактору и требованиям к производительности упаковки мобильных телефонов. Ключевыми строительными блоками этой технологии являются металл перераспределительного слоя (RDL) и обшивка мегастолбов.
- Технология InFO от TSMC — один из наиболее ярких примеров разветвления высокой плотности. Эта технология предназначена для приложений с большим количеством контактов, таких как процессоры приложений (AP). Компания планирует расширить свой сегмент FO-WLP за счет таких технологий, как inFO-Antenna-in-Package (AiP) и inFO-on-Substrate. Эти пакеты используются в автомобилях, серверах и смартфонах. Apple была одной из первых, кто внедрил эту новую технологию и использовала ее в процессоре приложений A10 iPhone 7, представленном в конце 2016 года.
- Благодаря таким преимуществам в декабре 2021 года Qualcomm и MediaTek рассмотрели возможность использования разветвленной PoP при производстве своих флагманских процессоров приложений для смартфонов, следуя по стопам Apple, использующей технологию InFO_PoP TSMC для упаковки своих чипов iPhone.
- Кроме того, ожидается, что рост рынка полупроводников наряду с разработкой решений для разветвленной упаковки высокой плотности будет способствовать росту рынка в течение прогнозируемого периода. Например, в июле 2021 года компания Changdian Technology, ведущий мировой производитель комбинированных схем и поставщик технологических решений, объявила об официальном выпуске всей линейки вариантов разветвленной упаковки очень высокой плотности для микросхем XDFOI, которые призваны снизить затраты. эффективные решения с высокой плотностью подключения, высокой степенью интеграции и высокой надежностью для интеграции гетерогенных микросхем.
- Достижения также были достигнуты в методе изготовления многослойной многослойной упаковки высокой плотности (FOWLP). Разрабатываются решения для уменьшения размера/высоты чипа и снижения производственных затрат при одновременном повышении надежности, энергоэффективности, скорости устройства и многофункциональной интеграции. Например, компания SPTS Technologies предлагает ведущим компаниям, занимающимся производством полупроводниковых упаковок, различные технологии плазменного травления и осаждения для создания передовых схем упаковки, таких как упаковка на уровне пластины с разветвлением высокой плотности.
- Кроме того, корпуса с разветвлением высокой плотности (HDFO) могут удовлетворить эти потребности в миниатюризации за счет производственных возможностей обработки на уровне пластин в сочетании с возможностью создания 3D-структур с использованием сквозных соединений, таких как высокие медные (Cu) опоры и сквозные корпуса. переходные отверстия (TPV) и передовые технологии упаковки флип-чипов.

Тайвань будет занимать значительную долю на рынке
- На Тайване расположены некоторые из крупнейших компаний-производителей полупроводников, которые стимулируют спрос на современные полупроводниковые упаковки, особенно в PLP. По данным правительственного аналитического центра Международного стратегического центра науки и технологий, ожидается, что объем производства Тайваня вырастет на 25,9% в 2021 году до 147 миллиардов долларов США.
- По данным Ассоциации полупроводниковой промышленности (SIA), Азиатско-Тихоокеанский регион генерирует более 50% доходов от мировых продаж полупроводников; это, в свою очередь, дает тайваньским поставщикам возможность поставлять FOWLP для более широкого применения полупроводников.
- Большинство компаний в стране расширяют свои мощности по производству упаковки Fan-out, что, как ожидается, в дальнейшем увеличит экспорт и поможет развитию местного рынка. Например, Intel, которая недавно объявила о своем возвращении в литейную промышленность, одновременно инвестирует 3,5 миллиарда долларов США в Нью-Мексико в строительство завода по производству упаковки для полупроводников, который начнет работу во второй половине 2022 года.
- Кроме того, в июне 2021 года ASE, компания по постобработке чистых полупроводников (OAST), начала инвестировать в современные упаковочные мощности в ответ на дефицит спроса и предложения на полупроводники. Компания ускоряет свое расширение за счет закупки большого количества оборудования для производства полупроводников для процессов WLP и PLP у HANMI Semiconductor.
- Кроме того, растущий рынок беспроводной связи пятого поколения (5G) и высокопроизводительных вычислений позволил производителям разрабатывать новые технологии. Например, будучи единственным лидером в сегменте разветвлений высокой плотности, TSMC планирует расширить свой сегмент FO-WLP за счет таких технологий, как inFO-антенна в корпусе (AiP) и inFO-on-Substrate (oS).

Обзор упаковочной отрасли Fan Out
Рынок умеренно фрагментирован, на нем присутствуют многочисленные игроки. В число крупных игроков, работающих на мировом рынке разветвленной упаковки, входят, среди прочего, Taiwan Semiconductor Manufacturing Company Limited, Jiangsu Changjiang Electronics Tech Co., Amkor Technology Inc., Samsung Electro-Mechanics и Powertech Technology Inc.. Эти игроки, помимо прочего, занимаются инновациями в продуктах, слияниями и поглощениями, чтобы увеличить долю рынка.
- Ноябрь 2021 г. - Amkor Technology, Inc., поставщик услуг по упаковке и тестированию полупроводников, заявила, что намерена построить интеллектуальный завод в Бакнинь, Вьетнам. На начальном этапе строительства предлагаемого завода основное внимание будет сосредоточено на предоставлении услуг по сборке и тестированию Advanced System in Package (SiP) ведущим мировым предприятиям по производству полупроводников и электроники.
- Февраль 2021 г. — Samsung Foundry подала документы властям Аризоны, Нью-Йорка и Техаса с просьбой построить передовое предприятие по производству полупроводников в США. Ожидается, что потенциальный завод недалеко от Остина, штат Техас, будет стоить более 17 миллиардов долларов США и создаст 1800 рабочих мест. Ожидается, что он появится в сети к четвертому кварталу 2023 года.
Лидеры рынка упаковки Fan Out
Taiwan Semiconductor Manufacturing Company Limited
Jiangsu Changjiang Electronics Tech Co.
Amkor Technology Inc.
Samsung Electro-Mechanics
Powertech Technology Inc.
- *Отказ от ответственности: основные игроки отсортированы в произвольном порядке
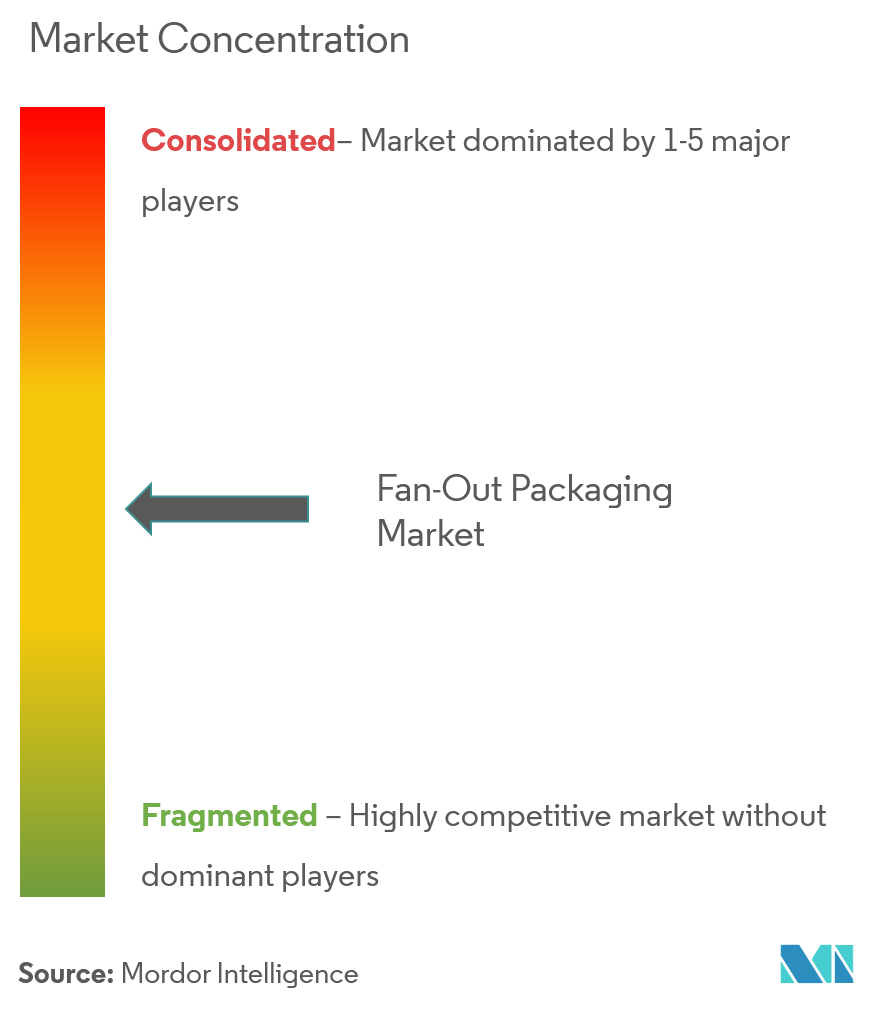
Новости рынка упаковки Fan Out
- Май 2022 г. — SkyWater Technology, надежный партнер по реализации технологий, и Adeia, недавно созданный бренд Xperi Holding Corporation, объявили, что SkyWater подписала соглашение о технологической лицензии с Xperi Corporation. SkyWater и ее клиенты получат доступ к технологиям прямого моста ZiBond от Adeia, технологиям гибридного соединения DBI® и IP для улучшения коммерческих и государственных продуктов следующего поколения. Завод SkyWater во Флориде создает гетерогенные интеграционные платформенные решения, включая технологии кремниевых переходников и разветвленной упаковки на уровне пластины (FOWLP).
- Июль 2021 г. — JCET Group, мировой лидер в области производства микросхем и инновационных услуг, объявила об официальном представлении XDFOITM, новой технологии разветвленной упаковки сверхвысокой плотности. Эта революционная технология предоставит экономически эффективные альтернативы с максимальной интеграцией, высокой плотностью подключения и высокой надежностью для различных наборов микросхем.
- Март 2021 г. — Deca, ведущий на рынке поставщик чистых технологий для инновационной полупроводниковой упаковки, представила свой новый подход APDKTM (комплект адаптивного проектирования шаблонов). Для разработки решения Deca сотрудничала с Advanced Semiconductor Engineering, Inc. (ASE) и Siemens Digital Industrial Software.
Сегментация упаковочной отрасли Fan Out
Корпус Fan-Out — это любой корпус, в котором разъемы расположены веером от поверхности чипа, что позволяет использовать дополнительные внешние вводы-выводы. Вместо того, чтобы помещать штампы на подложку или промежуточный элемент, традиционная разветвленная упаковка полностью погружает их в эпоксидный компаунд. Рынок разветвленной упаковки охватывает изучение типа рынка (основной разветвитель, разветвление высокой плотности, разветвление сверхвысокой плотности), типа носителя (200 мм, 300 мм, панель), бизнес-модели (OSAT, Foundry, IDM) и географии (Тайвань, Китай, США, Южная Корея, Япония, Европа).
| Разветвление ядра |
| Разветвление высокой плотности |
| Вентилятор сверхвысокой плотности |
| 200 мм |
| 300 мм |
| Панель |
| СБОРКИ |
| Литейный завод |
| ИДМ |
| Тайвань |
| Китай |
| Соединенные Штаты |
| Южная Корея |
| Япония |
| Европа |
| По типу | Разветвление ядра |
| Разветвление высокой плотности | |
| Вентилятор сверхвысокой плотности | |
| По типу оператора связи | 200 мм |
| 300 мм | |
| Панель | |
| По бизнес-модели | СБОРКИ |
| Литейный завод | |
| ИДМ | |
| География | Тайвань |
| Китай | |
| Соединенные Штаты | |
| Южная Корея | |
| Япония | |
| Европа |
Часто задаваемые вопросы по исследованию рынка упаковки Fan Out
Насколько велик рынок упаковки Fan Out?
Ожидается, что объем рынка упаковки Fan Out достигнет 2,94 млрд долларов США в 2024 году, а среднегодовой темп роста составит 16,5% и достигнет 6,30 млрд долларов США к 2029 году.
Каков текущий размер рынка упаковки Fan Out?
Ожидается, что в 2024 году объем рынка упаковки Fan Out достигнет 2,94 миллиарда долларов США.
Кто являются ключевыми игроками на рынке Fan Out Packaging?
Taiwan Semiconductor Manufacturing Company Limited, Jiangsu Changjiang Electronics Tech Co., Amkor Technology Inc., Samsung Electro-Mechanics, Powertech Technology Inc. — основные компании, работающие на рынке упаковки Fan Out.
Какой регион на рынке Fan Out Packaging является наиболее быстрорастущим?
По оценкам, Азиатско-Тихоокеанский регион будет расти с самым высоким среднегодовым темпом роста за прогнозируемый период (2024-2029 гг.).
Какой регион имеет самую большую долю на рынке Fan Out Packaging?
В 2024 году Азиатско-Тихоокеанский регион будет занимать наибольшую долю рынка упаковки Fan Out.
Какие годы охватывает рынок упаковки Fan Out и каков был размер рынка в 2023 году?
В 2023 году объем рынка упаковки Fan Out оценивался в 2,52 миллиарда долларов США. В отчете рассматривается исторический размер рынка упаковки Fan Out за годы 2019, 2020, 2021, 2022 и 2023 годы. В отчете также прогнозируется размер рынка упаковки Fan Out на годы 2024, 2025, 2026, 2027, 2028 и 2029 годы.
Последнее обновление страницы:
Отчет об индустрии упаковки Fan Out
Статистические данные о доле, размере и темпах роста доходов на рынке Fan Out Packaging в 2024 году, предоставленные Mordor Intelligence™ Industry Reports. Анализ Fan Out Packaging включает прогноз рынка до 2029 года и исторический обзор. Получите образец этого отраслевого анализа в виде бесплатного отчета в формате PDF, который можно загрузить.



