Размер и доля рынка полупроводниковой упаковки

Анализ рынка полупроводниковой упаковки от Mordor Intelligence
Размер рынка полупроводниковой упаковки составил 49,88 млрд долларов США в 2025 году и прогнозируется к достижению 81,22 млрд долларов США к 2030 году, увеличиваясь с совокупным годовым темпом роста 10,24% в период 2025-2030 годов. [1]Cheng Ting-Fang, "TSMC moves closer to next-gen packaging for Nvidia, Google AI chips," Nikkei Asia, asia.nikkei.comПереход от сборки, ориентированной на затраты, к интеграции, критически важной для производительности, лежит в основе этого роста. Спрос на архитектуры 2.5D и 3D резко возрос, поскольку нагрузки искусственного интеллекта требуют высокопропускной памяти и превосходных тепловых путей. Объемы остаются закрепленными за традиционными форматами проволочных соединений и рамок выводов, однако создание стоимости мигрирует к упаковке на уровне пластин типа fan-out (WLP) и интерпозерам с поддержкой чиплетов. Электрификация автомобилей поддерживает двузначный рост в модулях высокой плотности мощности, в то время как циклы обновления смартфонов и ПК поддерживают базовые объемы в потребительском сегменте. Регионально Азия контролирует более половины глобального производства, но Северная Америка регистрирует наивысший совокупный годовой темп роста благодаря стимулам CHIPS Act, которые финансируют новые заводы по производству back-end продукции.[2]U.S. Department of Commerce, "CHIPS for America Announces up to $300 million in Funding to Boost U.S. Semiconductor Packaging," commerce.gov Узкие места в поставках ABF-подложек и экспортные ограничения на передовые инструменты катализируют географическую диверсификацию и материальные инновации.
Ключевые выводы отчета
- По платформе упаковки традиционные форматы занимали 52,5% доли рынка полупроводниковой упаковки в 2024 году, тогда как fan-out WLP прогнозируется к росту с совокупным годовым темпом роста 12,3% до 2030 года.
- По отрасли конечного пользователя потребительская электроника лидировала с 43,8% долей доходов от размера рынка полупроводниковой упаковки в 2024 году; автомобильная промышленность демонстрирует самый быстрый рост с совокупным годовым темпом роста 10,3% до 2030 года.
- По размеру пластин: 300 мм обеспечивает эффективность, захватив 74,0% доли рынка полупроводниковой упаковки в 2024 году, в то время как формат панелей появляется, и обработка на уровне панелей на подложках 450 мм и более представляет самый быстрорастущий сегмент с совокупным годовым темпом роста 12,5% до 2030 года
- По бизнес-модели сегмент OSAT контролировал 62,0% глобальной доли рынка полупроводниковой упаковки в 2024 году, в то время как услуги back-end литейных заводов растут с совокупным годовым темпом роста 10,9%.
- По материалу упаковки органические ABF-подложки занимали 41,5% доходов в 2024 году, поддерживая основную экосистему flip-chip
- По географии Азия занимала 53,0% рынка полупроводниковой упаковки в 2024 году; Северная Америка готовится к совокупному годовому темпу роста 11,1% до 2030 года.
- ASE, Amkor и JCET совместно составляли более 30% доли доходов от передовых технологий в 2024 году, отражая масштабные преимущества в гибридном соединении и производстве SiP
Тенденции и аналитические данные глобального рынка полупроводниковой упаковки
Анализ влияния драйверов
| Драйвер | (~) % влияние на прогноз совокупного годового темпа роста | Географическая релевантность | Временные рамки воздействия |
|---|---|---|---|
| Бум ускорителей ИИ, стимулирующий интерпозеры 2.5D/3D | +2.8% | Глобально (Тайвань, США, Китай) | Среднесрочно (2-4 года) |
| Силовые пакеты электрифицированных транспортных средств | +1.9% | Северная Америка и АТЭС | Долгосрочно (≥4 года) |
| Стимулы CHIPS США-ЕС, создающие локальные заводы back-end | +1.4% | Северная Америка и ЕС | Долгосрочно (≥4 года) |
| Спрос на 5G RF-SiP в Китае и Корее | +1.2% | Ядро АТЭС | Краткосрочно (≤2 года) |
| Упаковка на уровне панелей для недорогого IoT | +0.9% | Глобально (центры АТЭС) | Среднесрочно (2-4 года) |
| Архитектуры чиплетов, питающие интерпозеры высокой плотности | +1.6% | Глобально (дизайн США, производство Тайваня) | Среднесрочно (2-4 года) |
| Источник: Mordor Intelligence | |||
Бум ускорителей ИИ, стимулирующий интерпозеры 2.5D/3D
Мощность CoWoS от TSMC удваивается со 120 000 до 240 000 единиц между 2023 и 2024 годами, однако она по-прежнему не может полностью удовлетворить спрос гипермасштабировщиков. Дефицит мощностей стимулирует альтернативные потоки на уровне панелей и испытания 3.5D-стекинга, которые объединяют более 6000 мм² кремния на упаковку. [3]James Morra, "Broadcom Bets on 3.5D Packaging Technology to Build Bigger AI Chips," Electronic Design, electronicdesign.com Передовая упаковка, таким образом, перешла от центра затрат к стратегическому рычагу для производительности систем ИИ
Силовые пакеты электрифицированных транспортных средств в США и Азии
Платформа EliteSiC от onsemi, награжденная Volkswagen, иллюстрирует миграцию к интегрированным силовым модулям с превосходным рассеиванием тепла. Формованные SiC-модули 6-в-1 от ROHM обеспечивают тройную плотность мощности по сравнению с предыдущими. Эти инновации концентрируются в цепочках поставок США и Азии, которые могут соответствовать строгой автомобильной квалификации.
Стимулы CHIPS США-ЕС, создающие локальные заводы back-end
Закон CHIPS выделяет 300 млн долларов США исключительно на НИОКР передовой упаковки, субсидируя тестовые линии в Джорджии, Калифорнии и Аризоне. Площадка Foveros от Intel стоимостью 3,5 млрд долларов США в Нью-Мексико закрепляет отечественные мощности 3D-интеграции. Сопоставимые средства в ЕС нацелены на снижение рисков автомобильной и оборонной электроники от азиатских перебоев в поставках.
Спрос на 5G RF-SiP в Китае и Корее
Гетерогенная RF-SiP от JCET для усилителей мощности повышает плотность интеграции в 1,5 раза по сравнению с предыдущими узлами. Хотя премиальные смартфоны поддерживают инновации, слабость спроса на массовые Android-устройства умерила рост единиц, заставляя поставщиков оптимизировать структуры затрат
Анализ влияния ограничений
| Ограничение | (~) % влияние на прогноз совокупного годового темпа роста | Географическая релевантность | Временные рамки воздействия |
|---|---|---|---|
| Дефицит поставок ABF-подложек | -1.8% | Глобально (острота в АТЭС) | Краткосрочно (≤2 года) |
| Проблемы выхода в 3D TSV/гибридном соединении | -1.3% | Глобально (Тайвань, Корея, США) | Среднесрочно (2-4 года) |
| Экспортный контроль на передовые инструменты упаковки в Китай | -0.9% | Китай первичный | Долгосрочно (≥4 года) |
| Ограничения теплорассеивания в fan-out WLP @ <5 нм | -0.7% | Глобальные передовые узлы | Среднесрочно (2-4 года) |
| Источник: Mordor Intelligence | |||
Дефицит поставок ABF-подложек
20%-ное повышение цен Nittobo в августе 2025 года выявляет системную нехватку материалов, которая особенно влияет на линии flip-chip BGA. Ограниченные квалифицированные мощности на Тайване и в Японии продлевают время поставки и заставляют OEM-производителей исследовать альтернативы со стеклянным или кремниевым ядром.
Проблемы выхода в 3D TSV/гибридном соединении
Допуски гибридного соединения медь-медь менее 0,5 нм и соотношения сторон TSV свыше 10:1 умножают риски дефектов в стекированных структурах. Программа Blackwell от NVIDIA, как сообщается, столкнулась с проблемами выхода, связанными с термомеханическим напряжением CoWoS-L.
Сегментный анализ
По платформе упаковки: передовые технологии стимулируют миграцию стоимости
Традиционные предложения проволочных соединений и рамок выводов по-прежнему доминировали в поставках с 52,5% доли рынка полупроводниковой упаковки в 2024 году, обеспечивая потребительской электронике и промышленным устройствам доступные затраты на спецификацию материалов. Однако Fan-out WLP превосходит все другие форматы с совокупным годовым темпом роста 12,3%, сигнализируя о движении рынка полупроводниковой упаковки к слоям перераспределения без подложек, которые уменьшают z-высоту и повышают плотность I/O. Flip-chip заполняет пробел, сочетая шаги с мелким шагом с умеренными затратами, в то время как архитектуры SiP и PoP обеспечивают вертикальное стекирование для смартфонов с ограниченным пространством.
На передовом фронте 2.5D-интерпозеры размещают высокопропускную память рядом с логикой ИИ, а 3D-стеки открывают прирост задержки. Встроенные кристаллы и потоки на уровне панелей привлекают новых участников, сосредоточенных на ценовых точках IoT, демонстрируя, что рынок полупроводниковой упаковки разделяется на премиальные узлы производительности и ультранизкозатратные объемные игры. Напротив, линии на уровне панелей обеспечивают менее 0,10 долларов США за контакт, соотношение, которое подчеркивает расходящиеся структуры затрат. В результате производители оборудования сегментировали свои портфели: высокоточные кластеры склеивания для выравнивания 3 мкм сосуществуют с большими панельными линиями MOLD, нацеленными на IoT-теги. Такая бифуркация переопределяет позиционирование поставщиков внутри рынка полупроводниковой упаковки.

Примечание: Доли сегментов всех отдельных сегментов доступны при покупке отчета
По материалу упаковки: органические подложки доминируют при давлении инноваций
Органические ABF-подложки занимали 41,5% доходов в 2024 году, поддерживая основную экосистему flip-chip. Однако размер рынка полупроводниковой упаковки для соединительных проводов будет расти на 11,4% ежегодно, поскольку автомобильные и промышленные секторы продлевают жизнь проверенных алюминиевых и золотых проволочных упаковок. Рамки выводов сохраняются в силовых приложениях, которые ценят производительность медных теплораспределителей. Инкапсулирующие смолы прогрессировали до сортов с высокой теплопроводностью, поддерживая модули SiC и GaN следующего поколения.
Стеклянные подложки могли бы заменить органические конструкции после 2027 года. Прототипы Intel и Samsung показывают 40%-ное уменьшение шага переходных отверстий и почти нулевое несоответствие CTE, снижая коробление в 3D-стеках. Материалы теплового интерфейса теперь интегрируют наполнители нано-алмаза, снижая сопротивление переход-корпус на 30% в тяговых инверторах на 1200 В. Скачки цен на золото сжали маржи для упаковки IC драйверов дисплеев в 2025 году, мотивируя миграцию к медным колонным шарам
По размеру пластин: 300 мм обеспечивает эффективность, в то время как появляется формат панелей
Формат пластин 300 мм захватил 74,0% доли рынка полупроводниковой упаковки в 2024 году, подтверждая свой статус предпочтительного выбора для передовых back-end потоков, которые балансируют эффективность обработки с совместимостью инструментов front-end. Меньшие пластины 200 мм или менее остаются жизнеспособными для устаревших аналоговых, сенсорных и силовых линий, где затраты на конверсию превышают прирост производительности. Большие форматы обеспечивают экономию масштаба, которая становится все более критичной по мере роста количества устройств в смартфонах, ПК и промышленных IoT-узлах.
Обработка на уровне панелей на подложках 450 мм или более представляет самый быстрорастущий сегмент с совокупным годовым темпом роста 12,5% до 2030 года и готова увеличить размер рынка полупроводниковой упаковки путем снижения потребления материалов на единицу и времени циклов. Контроль коробления, встроенная метрология выхода и стандартизация оборудования остаются главными препятствиями, требующими совместных усилий по разработке между производителями инструментов и высокообъемными упаковочными домами.
По бизнес-модели: лидерство OSAT сталкивается с вызовом литейных заводов
OSAT сохранили 62,0% доли рынка полупроводниковой упаковки в 2024 году благодаря широким клиентским реестрам и глобальным площадкам. Однако расширение back-end литейных заводов с совокупным годовым темпом роста 10,9% сигнализирует о вертикальной интеграции. Wafer Manufacturing 2.0 от TSMC объединяет литографию, тестирование и CoWoS под одним предложением, размывая границы OSAT.
В ответ ASE нацеливается на доходы от передовой упаковки в размере 1,6 млрд долларов США в 2025 году через стратегические капитальные вложения и совместное проектирование с системными OEM reuters.com. Стартапы, такие как Chipletz, сосредотачиваются на обслуживаемых доступных рынках, где индивидуальный дизайн интерпозеров соответствует картам вывода ИИ, иллюстрируя нишевые стратегии проникновения.

Примечание: Доли сегментов всех отдельных сегментов доступны при покупке отчета
По отрасли конечного пользователя: потребительская электроника лидирует, в то время как автомобильная промышленность ускоряется
Смартфоны, планшеты и ПК обеспечили 43,8% доли рынка полупроводниковой упаковки в 2024 году, поскольку OEM-производители обновляли форм-факторы и внедряли возможности генеративного ИИ на устройстве. Тем не менее, автомобильная вертикаль демонстрирует наивысший совокупный годовой темп роста на уровне 10,3% на фоне роста содержания EV-инверторов и контроллеров домена ADAS.
Автомобильные силовые модули класса automotive командуют ASP в пять раз выше мобильных SoC, расширяя размер рынка полупроводниковой упаковки непропорционально по сравнению с единичными объемами. Коммуникационная инфраструктура способствует спросу на RF-SiP, в то время как HPC центров обработки данных управляет самыми передовыми архитектурами, замыкая цикл между дорожными картами алгоритмов ИИ и выборами физической интеграции.
Географический анализ
Азия захватила 53,0% рынка полупроводниковой упаковки в 2024 году, закрепленная монополией CoWoS на Тайване и масштабом Китая в сборке проволочных соединений. Автомобильный завод JCET стоимостью 4,4 млрд юаней в Цзянсу продвигает местную компетенцию в силовых пакетах SiC. Южная Корея выигрывает от ориентированной на память SiP, тогда как Япония контролирует ключевые химические составы подложек, укрепляя тесно связанный региональный кластер.
Рынок полупроводниковой упаковки Северной Америки прогнозируется к демонстрации совокупного годового темпа роста 11,1% до 2030 года. Стимулы CHIPS Act собирают 300 млн долларов США для линий НИОКР, порождая хабы в Аризоне, Нью-Мексико и Калифорнии. Партнерства, такие как TSMC-Amkor в Аризоне, строят полные экосистемы back-end вблизи передовых wafer fabs. Канада культивирует упаковку фотоники, а Мексика предлагает низкозатратное финальное тестирование для потребительских ASIC.
Европа позиционируется вокруг автомобильной и промышленной силы. Немецкие Tier-1 совместно разрабатывают двусторонне охлаждаемые SiC-модули, нацеленные на плотность инвертора 9 кВт/л, катализируя нишевые инвестиции OSAT. Нидерланды продвигают упаковку высокочастотных оптических трансиверов, которая соответствует принятию вертикально-излучающих лазеров с поверхностным резонатором (VCSEL). Ближний Восток и Африка остаются развивающимися, в основном передавая сборку азиатским хабам, но планируя отечественные линии для безопасной IoT и оборонной электроники под суверенными мандатами.

Конкурентный ландшафт
Конкурентная интенсивность поворачивается от цены к технологии. TSMC использует ноу-хау литейных заводов для доминирования в 2.5D-интерпозерах, в то время как Samsung использует H-cube для смешивания памяти и логики для мобильного ИИ. ASE и Amkor распределяют риски между 40+ объектами, сосредотачиваясь на обучении выходу и услугах проектирования для производимости. JCET масштабирует линии SiP, работающие с автомобильными потоками AEC-Q100. Завод Foveros от Intel воплощает стратегический скачок к восстановлению лидерства в упаковке, предлагая шаг кристалл-к-кристаллу 50 мкм для клиентских и платформ центров обработки данных.
Барьеры входа включают интенсивность капиталовложений, безопасность поставок подложек и блокировки совместной разработки с клиентами. Следовательно, консолидация через слияния и поглощения - например, покупка Xpeedic компанией Empyrean - отражает попытку агрегировать EDA и IP упаковки под одной крышей
Лидеры индустрии полупроводниковой упаковки
-
ASE Technology Holding Co., Ltd.
-
Amkor Technology, Inc.
-
JCET Group Co., Ltd.
-
Siliconware Precision Industries Co., Ltd.
-
Powertech Technology Inc.
- *Отказ от ответственности: основные игроки отсортированы в произвольном порядке
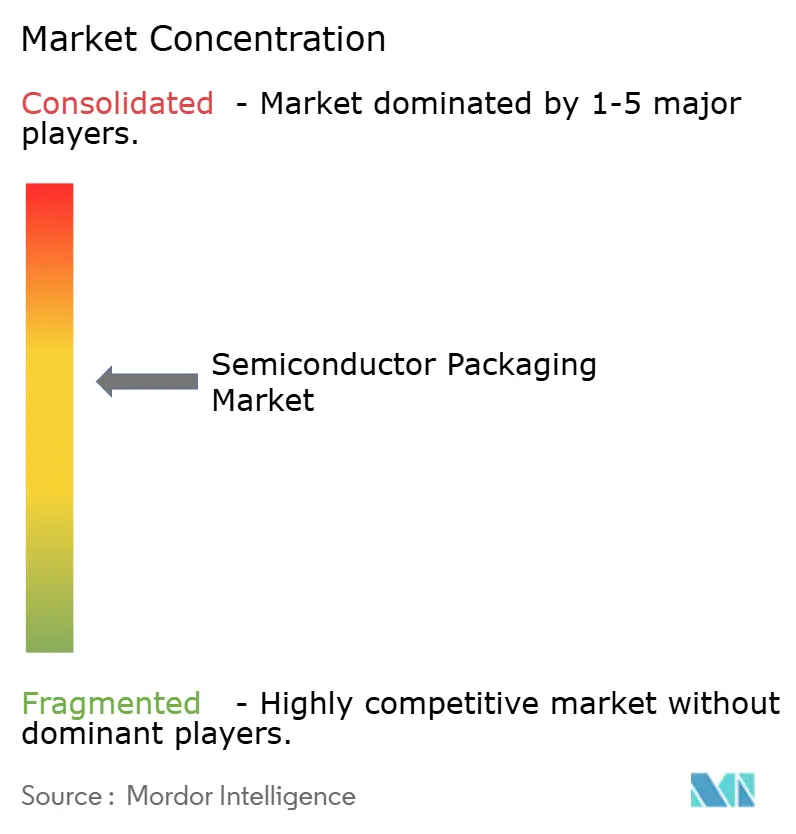
Последние разработки в отрасли
- Июнь 2025: ASE и AMD партнерствуют для повышения эффективности центров обработки данных на 50% при снижении мощности на 6,5%, оценивая GPU Instinct MI300 для рабочих нагрузок ИИ
- Июнь 2025: Infineon представляет транзевые SiC супер-переходные MOSFET, нацеленные на тяговые инверторы с первыми устройствами на 1200 В в корпусах ID-PAK
- Май 2025: ROHM выпускает формованные SiC-модули 4-в-1 и 6-в-1, которые утраивают плотность мощности и сокращают площадь платы на 52%
- Апрель 2025: ASE демонстрирует совместно упакованную оптику, снижающую энергию связи до <5 пДж/бит на фоне прогноза совокупного годового темпа роста пропускной способности центров обработки данных 24,9%
Объем отчета по глобальному рынку полупроводниковой упаковки
Полупроводниковая упаковка относится к корпусу, содержащему одно или более дискретных полупроводниковых устройств или интегральных схем, изготовленных из пластикового, керамического, металлического или стеклянного корпуса. Упаковка защищает электронную систему от излучения радиочастотного шума, электростатического разряда, механических повреждений и охлаждения. Рост полупроводниковой промышленности во всем мире является одним из основных факторов, стимулирующих рост рынка полупроводниковой упаковки. Непрерывные достижения в области интеграции, энергоэффективности и характеристик продукта из-за растущего спроса в различных вертикалях конечных пользователей отрасли и использование упаковки для улучшения производительности, надежности и экономической эффективности электронных систем ускоряют рост рынка.
Отчет отслеживает продажи полупроводниковой упаковки во всем мире для оценки доходов рынка для глобального рынка передовой упаковки и традиционной упаковки. В отчете рассматриваются различные платформы передовой упаковки, включая flip-chip, fan-in, встроенные кристаллы, 3D-стекинг и упаковку fan-out, которые используются в множественных приложениях конечных пользователей, таких как потребительская электроника, медицинские устройства, связь и телеком, и автомобильная промышленность. Конкурентный ландшафт был взят для расчета проникновения упаковки и того, как игроки вовлекаются в органические и неорганические стратегии роста. Эти компании инновируют свои продукты для увеличения своей доли рынка и прибыльности. Кроме того, отчет сосредотачивается на анализе макроэкономических факторов на рынке.
Рынок полупроводниковой упаковки сегментирован по платформе упаковки (передовая упаковка [flip chip, SIP, 2.5D/3D, встроенный кристалл, упаковка на уровне пластин fan-in (FI-WLP) и упаковка на уровне пластин fan-out (FO-WLP)] и традиционная упаковка), отрасли конечного пользователя (потребительская электроника, аэрокосмическая и оборонная, медицинские устройства, связь и телеком, автомобильная, энергетика и освещение) и географии (США, Китай, Тайвань, Корея, Япония и Европа). Отчет предлагает размеры рынка и прогнозы в стоимостном выражении (доллары США) для всех этих сегментов.
| Передовая упаковка | Flip-Chip |
| Fan-Out WLP | |
| Fan-In WLP | |
| 2.5D / 3D IC | |
| Встроенный кристалл | |
| SiP / PoP | |
| Упаковка на уровне панелей | |
| Традиционная упаковка | Проволочное соединение |
| Рамка выводов | |
| QFN / QFP / SOP |
| Органические подложки |
| Рамки выводов |
| Соединительные провода |
| Инкапсулирующие смолы |
| Керамические корпуса |
| Паяльные шарики и выступы |
| Прикрепление кристалла и TIM |
| ≤ 200 мм |
| 300 мм |
| ≥ 450 мм / Панель |
| OSAT |
| Foundry Back-End |
| IDM собственное производство |
| Потребительская электроника | Смартфоны и носимые устройства | |
| Вычислительная техника / центры обработки данных | ||
| Автомобильная промышленность и мобильность | ADAS / силовые агрегаты EV | |
| Связь и телеком | Инфраструктура 5G | |
| Аэрокосмическая и оборонная промышленность | ||
| Медицинские и здравоохранительные устройства | ||
| Промышленность и энергетика (LED / силовая) | ||
| Северная Америка | США |
| Канада | |
| Мексика | |
| Южная Америка | Бразилия |
| Остальная Южная Америка | |
| Европа | Германия |
| Франция | |
| Великобритания | |
| Италия | |
| Нидерланды | |
| Северные страны | |
| Остальная Европа | |
| Ближний Восток и Африка | Израиль |
| Турция | |
| СЗС | |
| Южная Африка | |
| Остальной Ближний Восток и Африка | |
| АТЭС | Китай |
| Тайвань | |
| Южная Корея | |
| Япония | |
| Индия | |
| Сингапур | |
| Австралия | |
| Новая Зеландия | |
| Остальная часть АТЭС |
| По платформе упаковки | Передовая упаковка | Flip-Chip | |
| Fan-Out WLP | |||
| Fan-In WLP | |||
| 2.5D / 3D IC | |||
| Встроенный кристалл | |||
| SiP / PoP | |||
| Упаковка на уровне панелей | |||
| Традиционная упаковка | Проволочное соединение | ||
| Рамка выводов | |||
| QFN / QFP / SOP | |||
| По материалу упаковки | Органические подложки | ||
| Рамки выводов | |||
| Соединительные провода | |||
| Инкапсулирующие смолы | |||
| Керамические корпуса | |||
| Паяльные шарики и выступы | |||
| Прикрепление кристалла и TIM | |||
| По размеру пластин | ≤ 200 мм | ||
| 300 мм | |||
| ≥ 450 мм / Панель | |||
| По бизнес-модели | OSAT | ||
| Foundry Back-End | |||
| IDM собственное производство | |||
| По отрасли конечного пользователя | Потребительская электроника | Смартфоны и носимые устройства | |
| Вычислительная техника / центры обработки данных | |||
| Автомобильная промышленность и мобильность | ADAS / силовые агрегаты EV | ||
| Связь и телеком | Инфраструктура 5G | ||
| Аэрокосмическая и оборонная промышленность | |||
| Медицинские и здравоохранительные устройства | |||
| Промышленность и энергетика (LED / силовая) | |||
| По географии | Северная Америка | США | |
| Канада | |||
| Мексика | |||
| Южная Америка | Бразилия | ||
| Остальная Южная Америка | |||
| Европа | Германия | ||
| Франция | |||
| Великобритания | |||
| Италия | |||
| Нидерланды | |||
| Северные страны | |||
| Остальная Европа | |||
| Ближний Восток и Африка | Израиль | ||
| Турция | |||
| СЗС | |||
| Южная Африка | |||
| Остальной Ближний Восток и Африка | |||
| АТЭС | Китай | ||
| Тайвань | |||
| Южная Корея | |||
| Япония | |||
| Индия | |||
| Сингапур | |||
| Австралия | |||
| Новая Зеландия | |||
| Остальная часть АТЭС | |||
Ключевые вопросы, на которые отвечает отчет
Какова текущая стоимость рынка полупроводниковой упаковки?
Рынок полупроводниковой упаковки оценивается в 49,88 млрд долларов США в 2025 году и прогнозируется к достижению 81,22 млрд долларов США к 2030 году.
Какая технология упаковки растет быстрее всего?
Упаковка на уровне пластин fan-out является самой быстрорастущей платформой, продвигаясь с совокупным годовым темпом роста 12,3% до 2030 года.
Почему ABF-подложки являются узким местом?
ABF-подложки производятся в основном на Тайване и в Японии, и нехватка поставок привела к росту цен на 20%, ограничивая расширение мощностей flip-chip.
Как Закон CHIPS влияет на упаковку?
Закон CHIPS выделяет 300 млн долларов США на отечественные НИОКР передовой упаковки, способствуя новым заводам в Аризоне, Калифорнии и Нью-Мексико и повышая совокупный годовой темп роста Северной Америки до 11,1%.
Какой сектор конечного использования увидит самый высокий рост?
Автомобильные приложения продемонстрируют самый высокий рост с совокупным годовым темпом роста 10,3%, обусловленным силовой электроникой электрических транспортных средств и спросом ADAS.
Как архитектуры чиплетов влияют на дизайн упаковки?
Открытые стандарты, такие как UCIe 2.0, обеспечивают гетерогенные чиплеты, подталкивая упаковку к интерпозерам высокой плотности и гибридному соединению для более высокой пропускной способности и более низкой задержки.
Последнее обновление страницы:



