Taille et part du marché de l'assemblage et du test de semi-conducteurs externalisés (OSAT)

Analyse du marché de l'assemblage et du test de semi-conducteurs externalisés (OSAT) par Mordor Intelligence
La taille du marché de l'assemblage et du test de semi-conducteurs externalisés un atteint 47,09 milliards USD en 2025 et devrait atteindre 71,44 milliards USD d'ici 2030, progressant à un TCAC de 8,69%. Les progrès soutenus dans l'intelligence artificielle, l'informatique haute performance et l'électrification automobile ont accru la demande pour des boîtiers avancés et des flux de test critiques pour la sécurité, élargissant ainsi l'opportunité totale adressable pour les fournisseurs de services backend spécialisés. Les fournisseurs d'Asie-Pacifique ont préservé leur avantage tarifaire grâce à des écosystèmes matures, mais les développements de capacité guidés par les politiques en Amérique du Nord et en Europe ont commencé à remodeler l'allocation de l'offre mondiale. Les architectures de chiplets hybrides ont élevé l'importance de l'intégration hétérogène, motivant des investissements stratégiques dans les plateformes fan-out au niveau wafer et 2.5D/3D. Parallèlement, des contrôles commerciaux plus stricts et des mandats de durabilité ont encouragé les clients à déplacer une partie de la charge de travail vers des sites géographiquement diversifiés pouvant démontrer une utilisation d'énergie inférieure par unité de débit. Alors que la capacité des fonderies est restée tendue, les entreprises de semi-conducteurs fab-lite ont continué d'externaliser les étapes backend, renforçant la pertinence structurelle du marché de l'assemblage et du test de semi-conducteurs externalisés dans le prochain cycle de planification.
Points clés du rapport
- Par type de service, l'emballage représentait 77,5% des revenus en 2024 ; le test devrait croître à un TCAC de 10,8% jusqu'en 2030.
- Par type d'emballage, le réseau de billes détenait 24,3% de la part du marché de l'assemblage et du test de semi-conducteurs externalisés en 2024, tandis que l'emballage fan-out au niveau wafer devrait s'étendre à un TCAC de 11,5% jusqu'en 2030.
- Par application, la communication menait avec 32,5% de part de revenus en 2024 ; l'automobile progresse à un TCAC de 13,4% jusqu'en 2030.
- Par nœud technologique, les nœuds hérités (≥28 nm) représentaient 46,3% de la taille du marché de l'assemblage et du test de semi-conducteurs externalisés en 2024 ; les nœuds sub-5 nm croissent à un TCAC de 15,1% jusqu'en 2030.
- Par géographie, l'Asie-Pacifique commandait 73,5% des revenus en 2024 ; son TCAC de 9,6% jusqu'en 2030 reflète un leadership persistant malgré les mouvements de diversification.
Tendances et perspectives du marché mondial de l'assemblage et du test de semi-conducteurs externalisés (OSAT)
Analyse d'impact des moteurs
| Moteur | (~) % Impact sur la prévision TCAC | Pertinence géographique | Calendrier d'impact |
|---|---|---|---|
| Contenu semi-conducteur en forte hausse par véhicule | +1.8% | Mondial, avec concentration en Allemagne, Japon, États-Unis et Chine | Moyen terme (2-4 ans) |
| Demande menée par la 5G pour des boîtiers RF avancés | +1.2% | Mondial, avec adoption précoce en Corée du Sud, Chine, États-Unis | Court terme (≤ 2 ans) |
| Architectures de chiplets IA/HPC nécessitant une intégration hétérogène | +2.1% | Mondial, avec concentration à Taïwan, États-Unis et Chine | Moyen terme (2-4 ans) |
| Pénuries de capacité des fonderies entraînant l'externalisation fab-lite | +1.5% | Mondial, avec effets de débordement en Asie du Sud-Est | Court terme (≤ 2 ans) |
| puces Act américain et EU puces Act incitant au développement OSAT local | +0.9% | Amérique du Nord et UE, avec effets sur la chaîne d'approvisionnement en Asie | Long terme (≥ 4 ans) |
| Les mandats de durabilité poussent l'adoption du fan-out au niveau wafer | +0.7% | Mondial, avec leadership réglementaire dans l'UE, Californie | Moyen terme (2-4 ans) |
| Source: Mordor Intelligence | |||
Contenu semi-conducteur en forte hausse par véhicule
Les équipementiers automobiles ont transitionné vers des plateformes définies par logiciel, augmentant la nomenclature semi-conducteurs par voiture et intensifiant la demande pour des boîtiers haute fiabilité. Le partenariat d'onduleur de traction du Groupe Volkswagen avec onsemi un souligné l'adoption croissante de dispositifs en carbure de silicium nécessitant des boîtiers de puissance thermiquement robustes.[1]onsemi, "Volkswagen Group Selects onsemi Silicon Carbide Traction Inverter," onsemi.com Le Programme Chiplet Automobile d'Imec, soutenu par ASE, BMW et Bosch, un illustré l'alignement trans-chaîne de valeur sur l'emballage de chiplets standardisé pour la conformité à la sécurité fonctionnelle. Les fournisseurs OSAT qui se qualifient selon AEC-Q100 et ISO 26262, par conséquent, ont capturé de nouveaux gains de conception et sécurisé des réservations de capacité pluriannuelles avec les fournisseurs de véhicules électriques.
Demande menée par la 5G pour des boîtiers RF avancés
Les déploiements commerciaux de stations de base 5G ont déplacé l'interface radio vers le territoire des ondes millimétriques, nécessitant des substrats à faibles pertes, un blindage conforme et des empreintes SiP compactes. L'intégration MISHEMT en mode E de Finwave Semiconductor chez GlobalFoundries un signalé le déploiement commercial de nouveaux dispositifs en nitrure de gallium nécessitant un emballage RF spécialisé, avec une qualification de masse ciblée pour 2026. Le pipeline pour les bancs d'essai 6G intègre déjà l'optique co-emballée, pressant les entreprises OSAT d'étendre les capacités d'assemblage de signaux mixtes et les solutions thermiques avancées.
Architectures de chiplets IA/HPC nécessitant une intégration hétérogène
Alors que l'évolutivité des puces monolithiques atteignait des limites économiques, le partitionnement en chiplets un prévalu dans les accélérateurs IA et les CPU de centres de données. La plateforme VIPack d'ASE un démontré des ponts de silicium actif et des voies de liaison hybride permettant une intégration efficace de chiplets tout en raccourcissant le temps de rendement. Les offres EMIB et Foveros d'Intel ont positionné les services de fonderie en concurrence directe, mais de nombreux clients fabless ont continué à tirer parti des maisons OSAT indépendantes pour la vérification de production en volume. Le marché de l'assemblage et du test de semi-conducteurs externalisés s'est élargi car les modules multi-puces nécessitaient des tests de fiabilité spécialisés tels que l'analyse structurelle couplée thermiquement que seuls quelques fournisseurs fournissent actuellement.
Pénuries de capacité des fonderies entraînant l'externalisation fab-lite
L'utilisation mondiale des fonderies est restée élevée malgré des dépenses d'investissement record, poussant les fabricants de dispositifs à adopter des modèles fab-lite dans lesquels les opérations backend sont entièrement externalisées. SEMI un projeté 400 milliards USD en dépenses d'équipement 300 mm jusqu'en 2027, mais le déséquilibre offre-demande à court terme un persisté, envoyant des volumes d'assemblage supplémentaires vers les clusters OSAT d'Asie du Sud-Est. Les fournisseurs d'équipement prévoient 34,9% de croissance des ventes d'outils d'assemblage pour 2025, soulignant le besoin urgent de capacité backend supplémentaire.
Analyse d'impact des contraintes
| Contrainte | (~) % Impact sur la prévision TCAC | Pertinence géographique | Calendrier d'impact |
|---|---|---|---|
| Intégration verticale par les principales fonderies et IDM | -1.4% | Mondial, avec concentration à Taïwan, Corée du Sud, États-Unis | Moyen terme (2-4 ans) |
| Intensité cap-ex et longs délais d'équipement | -0.8% | Mondial, avec impact particulier sur les marchés émergents | Court terme (≤ 2 ans) |
| Contrôles d'exportation géopolitiques sur les outils avancés | -0.6% | Mondial, avec focus sur les restrictions technologiques Chine-États-Unis | Moyen terme (2-4 ans) |
| Pénuries de main-d'œuvre qualifiée en ingénierie d'emballage avancé | -0.5% | Mondial, avec impact aigu sur les marchés développés | Long terme (≥ 4 ans) |
| Source: Mordor Intelligence | |||
Intégration verticale par les principales fonderies et IDM
La stratégie Wafer Manufacturing 2.0 de TSMC un intégré les flux d'emballage et de test, offrant des services clés en main qui ont réduit le volume adressable pour les entreprises OSAT autonomes. Samsung un poursuivi une voie similaire, tandis qu'Intel un développé ses services de fonderie pour inclure des interposeurs avancés. Ces mouvements ont compressé la part tierce dans les segments à haute marge et ont obligé les entreprises OSAT à doubler leur mise sur des niches telles que la sécurité automobile ou la photonique.
Intensité cap-ex et longs délais d'équipement
Une nouvelle ligne d'emballage avancé peut nécessiter 100-200 millions USD et 12-18 mois pour la livraison d'outils, obstacles qui dissuadent les entrants plus petits. La baisse de revenus FY 2023 d'ASMPT un illustré les vents contraires cycliques qui ont contraint la capacité de réinvestissement pendant les ralentissements. Les emplacements émergents en Inde et au Vietnam ont fait face à des cycles d'approvisionnement encore plus raides car les fournisseurs de matériaux japonais ont privilégié les clients de longue date, ralentissant le rattrapage concurrentiel.
Analyse par segment
Par type de service : L'élan des tests s'accélère sur la validation IA
Les tests ont capturé un TCAC prévisionnel de 10,8% pour 2025-2030, un rythme dépassant l'expansion de l'emballage mais partant d'une base plus petite. Les conceptions IA et informatique haute performance ont exigé une couverture de test au niveau système qui vérifie la latence d'interconnexion des chiplets, la limitation thermique dynamique et les performances de charge de travail d'apprentissage profond sous tensions variées. Le marché de l'assemblage et du test de semi-conducteurs externalisés un répondu en intégrant des algorithmes d'apprentissage automatique adaptatifs dans l'équipement de test automatique, réduisant le temps de test tout en améliorant l'isolation des défauts.
L'emballage un conservé 77,5% des revenus 2024, mais sa composition un évolué vers des lignes fan-out au niveau panneau, interposeur 2.5D et optique co-emballée. Alors que les clients consolidaient les fournisseurs, les groupes OSAT ont regroupé des offres clés en main qui fusionnent la conception d'appareillage, le test final et la logistique. Advantest un sécurisé son sixième leadership consécutif en équipement de test d'assemblage après avoir ajouté des analyses alimentées par l'IA à sa série V93000.[2]Advantest Corporation, "Advantest Ranks mondial #1 in Assembly Test Equipment Supplier," advantest.com

Note: Parts de segment de tous les segments individuels disponibles à l'achat du rapport
Par type d'emballage : Le WLP fan-out capture les conceptions de nœuds avancés
La technologie de réseau de billes un maintenu une part de 24,3% en 2024 en servant les plateformes grand public et industrielles mainstream qui valorisent la robustesse mécanique. Cependant, les boîtiers fan-out au niveau wafer se sont étendus à 11,5% TCAC alors que les processeurs mobiles et accélérateurs IA ont transitionné vers des couches de redistribution haute densité. Cette tendance un renforcé le marché de l'assemblage et du test de semi-conducteurs externalisés car seul un pool limité de fournisseurs peut traiter des formats de panneaux plus grands sans dérive de rendement.
L'expansion de 200 millions USD d'ASE au niveau panneau vers des panneaux de verre 310 mm × 310 mm un illustré un engagement cap-ex vers des constructions de grande surface rentables. Les variantes via-silicium traversant et via-verre traversant ont proliféré dans les piles de mémoire haute bande passante. Les substrats FC-BGA ont bénéficié de l'adoption de nœuds avancés, comblant l'écart entre les laminés organiques et les interposeurs de silicium pour les ASIC de réseau.
Par application : L'électrification automobile stimule l'innovation d'emballage
Les systèmes de communication ont dominé avec 32,5% des revenus en 2024, reflétant le déploiement macro 5G soutenu et la demande de renouvellement de combinés. Pourtant, les groupes motopropulseurs électrifiés et les modules ADAS ont poussé l'automobile au sommet des tableaux de croissance à 13,4% TCAC. La taille du marché de l'assemblage et du test de semi-conducteurs externalisés pour les modules automobiles devrait éclipser xx milliards USD d'ici 2030 (valeur spécifique non divulguée), soutenue par des accords d'approvisionnement à long terme qui garantissent la capacité pour les puces en carbure de silicium et radar.
L'acquisition par onsemi du portefeuille JFET en carbure de silicium de Qorvo pour 115 millions USD un souligné la course pour sécuriser des dispositifs de puissance différenciés. Les projets d'usines intelligentes industrielles et l'IA en périphérie ont également soulevé la demande backend, mais leurs parts sont restées inférieures aux segments mobilité et communication.

Par nœud technologique : Les nœuds avancés dépassent l'hérité mais la double voie persiste
Les géométries héritées ≥28 nm composaient encore 46,3% de la taille du marché de l'assemblage et du test de semi-conducteurs externalisés en 2024, servant l'analogique, la gestion d'alimentation et les microcontrôleurs automobiles. Ils ont conservé une part collante due à l'outillage mature et aux cycles de vie de produits étendus. En parallèle, les nœuds sub-5 nm ont crû à 15,1% TCAC, portés par les accélérateurs d'entraînement IA, smartphones premium et CPU de centres de données.
Siemens un publié le logiciel de test Tessent Hi-Res Chain pour freiner la perte de rendement à 5 nm et en dessous, démontrant que l'innovation de test backend doit correspondre à l'échelle front-end. Les OSAT, par conséquent, ont construit des zones de salle blanche avec un contrôle de contamination plus fin et des flux de débondage lithographique avancé pour gérer les puces ultra-minces que les lignes d'emballage conventionnelles ne peuvent soutenir.
Analyse géographique
L'Asie-Pacifique un conservé 73,5% de part des revenus du marché de l'assemblage et du test de semi-conducteurs externalisés en 2024 et un affiché une perspective TCAC de 9,6% jusqu'en 2030. Taïwan, la Chine et la Corée du Sud ont ancré le cluster grâce à la proximité des fonderies et fabricants de substrats, mais les frictions commerciales croissantes ont incité à la diversification vers la Malaisie, le Vietnam et les Philippines. L'Inde un accéléré les programmes d'incitation, approuvant l'usine de 413 millions USD de Kaynes Technology au Gujarat et le complexe d'emballage-test de 3 milliards USD de Tata Electronics à Assam.[3]Evertiq, "Indian Government Approves Kaynes' USD 413 Million Chip Plant," evertiq.com
L'Amérique du Nord un regagné du poids stratégique suite au financement du puces Act. Amkor un entamé la construction d'une installation d'emballage avancé en Arizona conçue pour approvisionner les clients automobiles et IA domestiques. Texas Instruments un réservé 60 milliards USD pour plusieurs fabs de wafers et la capacité backend correspondante, tandis que l'acquisition de 93 millions USD par SkyWater de l'usine d'Infineon à Austin un ajouté une redondance souveraine.
L'Europe est passée de la R&D de niche vers la production à l'échelle. Silicon Box un obtenu l'approbation UE pour une usine au niveau panneau de 1,3 milliard EUR (1,47 milliard USD) en Italie, ciblant >100 millions d'unités SiP par an. Thales, Radiall et Foxconn ont exploré une alliance OSAT française pour servir les utilisateurs de défense et d'unéronautique. Onsemi s'est engagé à 2 milliards USD pour une ligne carbure de silicium en République tchèque, assurant l'approvisionnement local pour les projets d'e-mobilité. Le Moyen-Orient et l'Afrique sont restés une frontière émergente, avec Israël et les EAU évaluant les cadres politiques pour attirer les investisseurs backend.

Paysage concurrentiel
Les trois premiers fournisseurs-ASE Technology, Amkor Technology et JCET-détenaient environ 45-50% des revenus en 2024, indiquant une concentration modérée. ASE un rapporté 595,410 milliards NT$ (18,6 milliards USD) de revenus, soutenu par les commandes IA et communication malgré la pression sur les marges.[4]StockTitan, "ASE Technology Reports Mixed Q4 Results," stocktitan.net Amkor un poursuivi la diversification régionale à travers son site Arizona et un projet conjoint avec GlobalFoundries au Portugal, visant les constructeurs automobiles européens. JCET un sécurisé des revenus record après avoir approfondi les engagements automobiles et étendu la capacité SiP dans le Jiangsu.
La concurrence s'intensifie alors que les fonderies intègrent les offres backend. La 3DFabric de TSMC un positionné l'entreprise comme fournisseur d'emballage avancé guichet unique, défiant le pouvoir de tarification OSAT. Les groupes OSAT ripostent en investissant dans l'intégration hétérogène, la photonique et les boîtiers de sécurité automobile. Les subventions gouvernementales ont également abaissé les barrières d'entrée pour les nouveaux venus en Inde et au Vietnam, qui tirent parti des partenariats stratégiques pour accélérer le transfert de technologie.
Les mouvements stratégiques ont inclus la coopération d'ASE avec TSMC sur les processus au niveau panneau, la subvention puces Act d'Amkor qui un ancré la capacité domestique américaine, et l'achat par SkyWater de l'usine d'Infineon à Austin pour élargir les voies prototype-vers-production. Les acteurs passent de la concurrence par les coûts vers des propositions de valeur différenciées telles que l'assemblage d'optique co-emballée, l'optimisation de test pilotée par apprentissage automatique et les flux de matériaux d'économie circulaire.
Leaders de l'industrie de l'assemblage et du test de semi-conducteurs externalisés (OSAT)
-
ASE Technology Holding Co. Ltd
-
Amkor Technology Inc.
-
Powertech Technology Inc.
-
ChipMOS Technologies Inc.
-
King Yuan Electronics Co. Ltd
- *Avis de non-responsabilité : les principaux acteurs sont triés sans ordre particulier
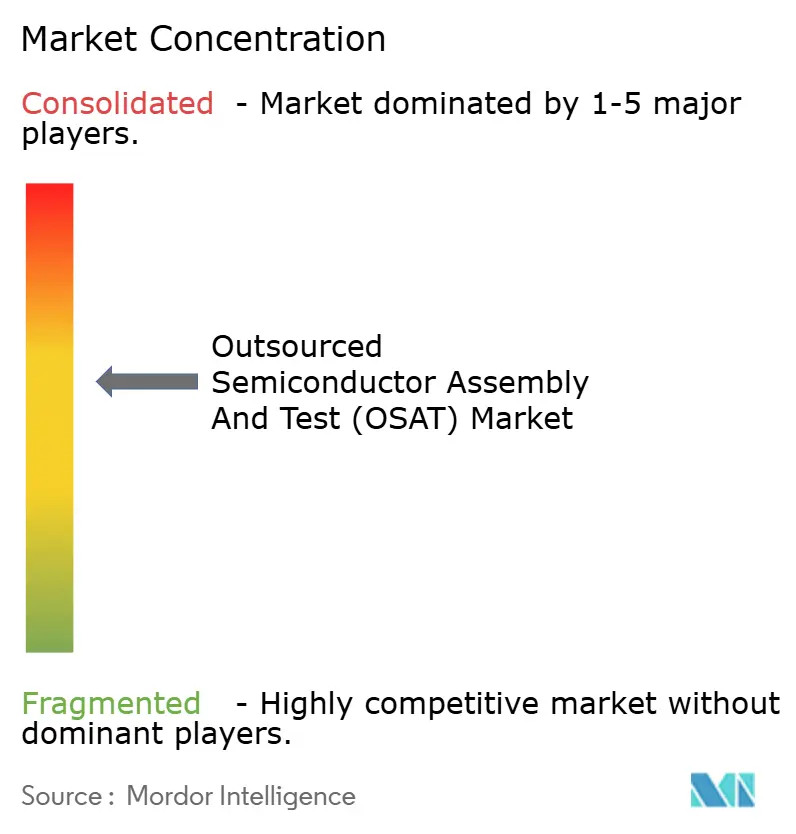


Développements récents de l'industrie
- Juillet 2025 : TSMC et ASE ont intensifié la course à l'emballage au niveau panneau ; ASE un investi 200 millions USD dans des panneaux 310 mm×310 mm pour les puces IA.
- Juillet 2025 : SkyWater un acquis l'usine d'Infineon à Austin pour 93 millions USD pour renforcer la souveraineté américaine.
- Juin 2025 : Texas Instruments un annoncé 60 milliards USD pour sept fabs américaines, le plus grand engagement domestique jamais enregistré.
- Mai 2025 : Thales, Radiall et Foxconn ont commencé les négociations pour un site OSAT français, dépassant 250 millions EUR.
Portée du rapport mondial sur le marché de l'assemblage et du test de semi-conducteurs externalisés (OSAT)
Les entreprises OSAT offrent des services tiers d'emballage et de test de circuits intégrés (CI). Ces entreprises fournissent l'emballage pour les dispositifs en silicium fabriqués par les fonderies et testent les dispositifs avant expédition. Elles se concentrent sur l'offre de solutions d'emballage et de test innovantes pour les entreprises de semi-conducteurs dans des marchés bien établis, tels que les communications, les consommateurs et l'informatique, ainsi que des marchés émergents, tels que l'électronique automobile, l'Internet des objets (IoT) et les dispositifs portables.
Le marché des services d'assemblage et de test de semi-conducteurs externalisés (OSAT) est segmenté par type de service (emballage et test), type d'emballage (emballage réseau de billes, emballage à l'échelle de la puce, emballage de puces empilées, emballage multi-puces, et emballage plat quad et double en ligne [seule l'analyse qualitative est incluse]), application (communication, électronique grand public, automobile, informatique et réseaux, industriel et autres applications), et géographie (États-Unis, Chine, Taïwan, Corée du Sud, Malaisie, Singapour, Japon et reste du monde). Le rapport inclut les prévisions de marché et la taille en valeur en USD pour tous les segments ci-dessus.
| Emballage |
| Test |
| Réseau de billes (BGA) |
| Boîtier à l'échelle de la puce (CSP) |
| Plat quad / Double en ligne (QFP/DIP) |
| Module multi-puces (MCM) |
| Emballage au niveau wafer (WLP) |
| Emballage fan-out (FO-WLP / FO-BGA) |
| Système dans un boîtier (SiP) |
| Via-silicium traversant (2.5D/3D TSV) |
| Puce retournée (FC-BGA / FC-CSP) |
| Communication |
| Électronique grand public |
| Automobile |
| Informatique et réseaux |
| Industriel |
| Autres applications |
| ≥28 nm |
| 16/14 nm |
| 10/7 nm |
| 5 nm et moins |
| Hérité (90-65 nm) |
| Amérique du Nord | États-Unis | |
| Canada | ||
| Mexique | ||
| Amérique du Sud | Brésil | |
| Argentine | ||
| Reste de l'Amérique du Sud | ||
| Europe | Allemagne | |
| France | ||
| Royaume-Uni | ||
| Italie | ||
| Pays-Bas | ||
| Russie | ||
| Reste de l'Europe | ||
| Asie-Pacifique | Chine | |
| Taïwan | ||
| Corée du Sud | ||
| Japon | ||
| Singapour | ||
| Malaisie | ||
| Inde | ||
| Reste de l'Asie-Pacifique | ||
| Moyen-Orient et Afrique | Moyen-Orient | Israël |
| Émirats arabes unis | ||
| Arabie saoudite | ||
| Turquie | ||
| Reste du Moyen-Orient | ||
| Afrique | Afrique du Sud | |
| Nigeria | ||
| Reste de l'Afrique | ||
| Par type de service | Emballage | ||
| Test | |||
| Par type d'emballage | Réseau de billes (BGA) | ||
| Boîtier à l'échelle de la puce (CSP) | |||
| Plat quad / Double en ligne (QFP/DIP) | |||
| Module multi-puces (MCM) | |||
| Emballage au niveau wafer (WLP) | |||
| Emballage fan-out (FO-WLP / FO-BGA) | |||
| Système dans un boîtier (SiP) | |||
| Via-silicium traversant (2.5D/3D TSV) | |||
| Puce retournée (FC-BGA / FC-CSP) | |||
| Par application | Communication | ||
| Électronique grand public | |||
| Automobile | |||
| Informatique et réseaux | |||
| Industriel | |||
| Autres applications | |||
| Par nœud technologique | ≥28 nm | ||
| 16/14 nm | |||
| 10/7 nm | |||
| 5 nm et moins | |||
| Hérité (90-65 nm) | |||
| Par géographie | Amérique du Nord | États-Unis | |
| Canada | |||
| Mexique | |||
| Amérique du Sud | Brésil | ||
| Argentine | |||
| Reste de l'Amérique du Sud | |||
| Europe | Allemagne | ||
| France | |||
| Royaume-Uni | |||
| Italie | |||
| Pays-Bas | |||
| Russie | |||
| Reste de l'Europe | |||
| Asie-Pacifique | Chine | ||
| Taïwan | |||
| Corée du Sud | |||
| Japon | |||
| Singapour | |||
| Malaisie | |||
| Inde | |||
| Reste de l'Asie-Pacifique | |||
| Moyen-Orient et Afrique | Moyen-Orient | Israël | |
| Émirats arabes unis | |||
| Arabie saoudite | |||
| Turquie | |||
| Reste du Moyen-Orient | |||
| Afrique | Afrique du Sud | ||
| Nigeria | |||
| Reste de l'Afrique | |||


Questions clés auxquelles répond le rapport
Quelle est la valeur actuelle du marché de l'assemblage et du test de semi-conducteurs externalisés ?
Le marché de l'assemblage et du test de semi-conducteurs externalisés s'élevait à 47,09 milliards USD en 2025 et devrait atteindre 71,44 milliards USD d'ici 2030.
Quelle région mène le marché de l'assemblage et du test de semi-conducteurs externalisés ?
L'Asie-Pacifique menait avec 73,5% de part de revenus en 2024, soutenue par des chaînes d'approvisionnement matures et la proximité des fonderies.
Pourquoi l'emballage fan-out au niveau wafer croît-il si rapidement ?
L'emballage fan-out au niveau wafer offre des facteurs de forme compacts et des interconnexions haute densité requis par les accélérateurs IA et processeurs mobiles, entraînant un TCAC de 11,5% jusqu'en 2030.
Comment les tendances automobiles influencent-elles les services OSAT ?
La hausse du contenu semi-conducteur par véhicule et le passage aux groupes motopropulseurs électriques ont poussé la demande d'emballage et de test axés sur l'automobile à un TCAC de 13,4%, créant des contrats à long terme pour les fournisseurs OSAT qualifiés pour la sécurité.
Quels risques pourraient ralentir l'expansion du marché ?
L'intégration verticale par les grandes fonderies et les exigences de dépenses d'investissement élevées peuvent rogner la croissance tierce, potentiellement retranchant 1,4% du TCAC prévisionnel sur le moyen terme.
Dernière mise à jour de la page le:









