
APAC Die-Attach-Equipment-Marktanalyse von Mordor Intelligence
Der APAC Die-Attach-Equipment-Markt wird voraussichtlich im Prognosezeitraum einen CAGR von 15,3% verzeichnen.
- Ein wesentlicher Schwerpunkt für die nächste Investitionsrunde der Marktteilnehmer ist die Entwicklung von Die-Bonding- und Verpackungslösungen für kleinere und hochkomplexe 5G-kompatible Smartphones. 5G ist eine vereinheitlichende Konnektivitätsplattform für zukünftige Innovationen, die einen kontinuierlichen sicheren Cloud-Zugang bei deutlich höheren Daten- und Videoübertragungsgeschwindigkeiten ermöglicht.
- Die Nutzerakzeptanz von 5G-Funktionen erweitert mobile Breitbandaktivitäten und beschleunigt die Nutzung künstlicher Intelligenz für das Internet der Dinge. Ebenso haben die Substrat- und Wafer-Level-Verpackungsprozesse für mobile Internetanwendungen, Computing, 5G und Automobilanwendungen die Halbleiterindustrie dazu veranlasst, eine Erholung der Kapitalinvestitionen in Speicher und Logik zu verzeichnen.
- Das Unternehmen hat Pläne für eine mittel- bis langfristige Erhöhung der Kapitalinvestitionen in erweiterte Halbleiter- und FPD-Anwendungen mitgeteilt. Shibaura hingegen verfolgt aktiv die Entwicklung von Hochgeschwindigkeits- und Hochpräzisions-Bondinggeräten für FOWLP/PLP und μLED im Bereich der Halbleitermontageausrüstung.
- BESI hat Pläne bekannt gegeben, in neue Montagetechnologien wie FOWLP, TCB, TSV, ultradünne Dies, Hybridbonden, Großflächen-, Wafer-Level-Molding, Solar- und 3D-Lithium-Ionen-Batteriebeschichtung für die neue digitale Gesellschaft zu investieren. Sein Sortiment im Bereich Die-Attach-Equipment umfasst Einzel-Chip-, Multi-Chip-, Multi-Modul-, Flip-Chip-, TCB-, FOWLP- und Hybrid-Die-Bonding-Systeme sowie Die-Sortiersysteme.
- Eine Quelle der Besorgnis ist jedoch der anhaltend unsichere Ausblick aufgrund der Auswirkungen der weltweiten Ausbreitung von COVID-19. Lockdowns und Produktionsstopps im asiatisch-pazifischen Raum infolge des COVID-19-Ausbruchs hatten die Produktion und den Verbrauch von Halbleitern erheblich beeinträchtigt. Da sich die Mehrheit der integrierten Gerätehersteller und Foundries in der Region befindet, hat die Auswirkung von Abschaltungen zu reduzierten Ausgaben für Kapitalinvestitionen geführt. Dies wird voraussichtlich den untersuchten Markt beeinflussen, wobei eine verlangsamte Erholung bis 2021 erwartet wird.
Trends und Erkenntnisse im APAC Die-Attach-Equipment-Markt
CIS wird voraussichtlich ein erhebliches Wachstum verzeichnen
- CMOS-Bildsensoren bieten Kamerafunktionen in Smartphones und anderen Produkten, und mit wachsendem Skalierungsbedarf entstehen damit verbundene Fertigungsprobleme in der Fabrik.
- Die höhere Bandbreitendatenleistung, die sich von 3G über 4G bis hin zu 5G entwickelt hat, hat die Nachfrage nach Kameras höherer Qualität gesteigert. Dieser Trend hat die Stapeltechniken für CMOS-Bildsensoren vorangetrieben, die auf dem Bedarf nach höheren Pixelzahlen und besserer Auflösung basieren. Über diese Trends hinaus haben die Bereiche biometrische Identifikation, 3D-Sensorik und erweiterte Anwendungen für das menschliche Sehen das Segmentwachstum verstärkt.
- Die Kundennachfrage nach größeren und besseren Kameras führt zu mehr Sensoren mit größeren Die-Größen. Neben der Pixelskalierung durchlaufen CMOS-Bildsensoren weitere Innovationen wie Das Die-Stapeln. Anbieter im untersuchten Markt verwenden auch verschiedene Verbindungstechnologien wie Through-Silicon-Vias (TSVs), Hybridbonden und Pixel-zu-Pixel für denselben Zweck.
- Beim Hybridbonden beispielsweise werden die Dies über Kupfer-zu-Kupfer-Verbindungen verbunden. Dazu werden zwei Wafer in einer Fabrik verarbeitet. Einer ist der Logik-Wafer, der andere ist der Pixelarray-Wafer. Die beiden Wafer werden mittels einer Dielektrikum-zu-Dielektrikum-Bindung verbunden, gefolgt von einer Metall-zu-Metall-Verbindung.
- Hybridbonden-DBI-Technologien, die proprietäre Technologie von Xperi, werden von Samsung in erheblichem Umfang für die Herstellung von CMOS-Bildsensoren für seine Telefone eingesetzt. Diese Technologie für CMOS-Bildsensoren ermöglicht eine permanente Cu-Cu-Bindung bei Raumtemperatur, ein Niedertemperatur-Glühen (ca. 300 °C) und einen Bondingprozess ohne externen Druck (Dielektrikum/Metall).
- Zuvor hat die Direktbindungstechnologie eine entscheidende Rolle bei der Realisierung der Pixelskalierung (rückseitige Beleuchtung) BSI und gestapeltem BSI mit mehreren generationalen Variationen gespielt, die von Xperi über mehr als 15 Jahre hinweg angeführt wurden.



LED wird den Marktanteil dominieren
- Das Die-Attach-Material spielt eine Schlüsselrolle für die Leistung und Zuverlässigkeit von mittel-, hoch- und superhochleistungs-LEDs. Die Nachfrage nach Die-Attach-Equipment steigt mit zunehmender LED-Durchdringungsrate. Die Auswahl des geeigneten Die-Attach-Materials für eine bestimmte Chipstruktur und Anwendung hängt von verschiedenen Überlegungen ab, darunter der Verpackungsprozess (Durchsatz und Ausbeute), die Leistung (Wärmeabfuhr und Lichtausbeute), die Zuverlässigkeit (Lichtstromerhalt) und die Kosten. Eutektisches Gold-Zinn, silbergefüllte Epoxide, Lot, Silikone und gesinterte Materialien wurden alle für den LED-Die-Attach verwendet.
- SFE bietet eine Epoxid-Klebstoff-Bondingmethode an, bei der ihre LED-Epoxid-Die-Bonder-Maschine eine Indexzeit von 0,2 Sek./Zyklus (90 Prozent Betriebsrate) mit einer Chipgröße von 250 × 250 Standard aufweist und eine Leitrahmen-Erkennung durch 2 Kameras bietet. Die Softwarefunktion bietet automatische Montage- und Aufnahmeniveau-Lehrfunktionen.
- Darüber hinaus stellen leitfähige Klebstoffe (hauptsächlich silbergefüllte Epoxide) die größte Klasse thermischer Die-Attach-Materialien (nach Stückzahl) für LEDs dar. Sie sind mit vorhandenen Back-End-Verpackungsgeräten kompatibel und bieten eine attraktive Kosten-Leistungs-Balance (typischerweise bis zu 50 W/mK Wärmeleitfähigkeit mit sekundärer Reflow-Kompatibilität). Da sie an blankem Silizium haften, sind sie das bevorzugte Material für Dies ohne Back-End-Metallisierung wie GaN auf Silizium.
- Darüber hinaus gibt es im LED-Markt viele Mitbewerber, und ASM ist einer der führenden Akteure in diesem Markt; sein LED-Epoxid-Hochgeschwindigkeits-Die-Bonder AD830 dominiert im LED-Markt. Er ist schnell, zuverlässig und präzise mit einer Die-Platzierungsgenauigkeit von +/-1 mil und +/-3 Grad; die Zykluszeit für einen kleinen Chip wie 10 mil × 10 mil beträgt 180 ms, was einem äquivalenten UPH von 18.000 entspricht. Er ist mit einem Post-Bond-Inspektionssystem ausgestattet, das die gebondete Einheit im voreingestellten Platzierungsbereich überwacht.



Wettbewerbslandschaft
Der APAC Die-Attach-Equipment-Markt ist mäßig wettbewerbsintensiv, mit einer großen Anzahl von Akteuren mit geringem Marktanteil. Die Unternehmen innovieren kontinuierlich und gehen strategische Partnerschaften ein, um ihren Marktanteil zu halten.
- April 2022 – Das Driving the Electric Revolution Industrialization Centre (DER-IC) North East hat Ausrüstung von Inseto, einem führenden technischen Distributor von Werkzeugen und Materialien, erhalten, um seine Fähigkeiten in den Bereichen Leistungselektronik, Maschinen und Antriebe (PEMD) zu verbessern. Die erste in Großbritannien installierte Mikrostanzmaschine ist eine AMX P100 Sinterpresse, die Teil der bereitgestellten Ausrüstung ist und die Produktion von hochzuverlässigen Hochleistungsmodulen ermöglichen wird.
- Juni 2022 – Die neue 7KF-Bonder-Serie wurde von West Bond entwickelt. Dieses bekannte Unternehmen entwirft und fertigt eine Reihe von Drahtbonding- und Die-to-Attach-Maschinen, Drahtzieh- und Scherprüfgeräten, Ultraschallkomponenten und Zubehör für die Mikroelektronik-Verpackungsindustrie. Dieses hervorragende Werkzeug ist für die Bewältigung der schwierigen Bondingaufgaben konzipiert, die in den Bereichen HF, Mikrowelle, Halbleiter, Hybrid und Medizingeräte auftreten.
Marktführer im APAC Die-Attach-Equipment-Bereich
Palomar Technologies, Inc.
Shinkawa Ltd.
Panasonic Corporation
ASM Pacific Technology Limited
Be Semiconductor Industries N.V.
- *Haftungsausschluss: Hauptakteure in keiner bestimmten Reihenfolge sortiert
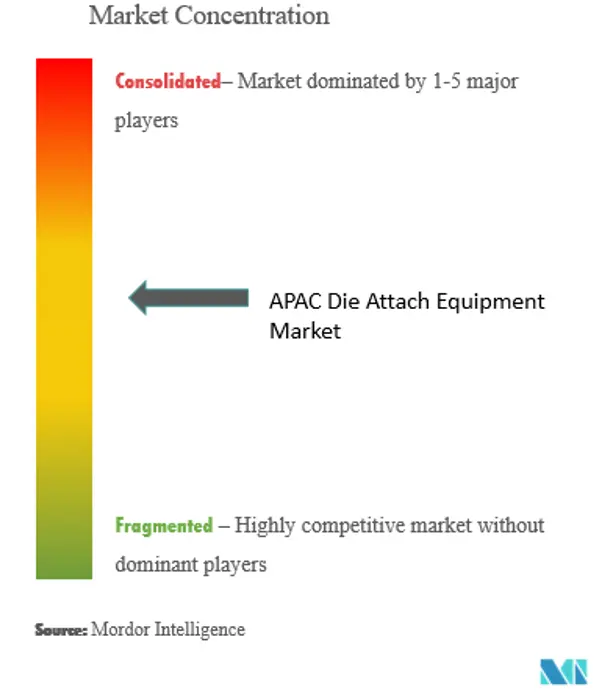


Aktuelle Branchenentwicklungen
- Juli 2022 – Laut EV Group (EVG), einem Anbieter von Wafer-Bonding- und Lithographiegeräten für die MEMS-, Nanotechnologie- und Halbleitermärkte, wurde ein bedeutender Fortschritt beim Die-to-Wafer (D2W) Fusions- und Hybridbonden erzielt. Dies wurde durch die erfolgreiche Demonstration einer 100-prozentigen hohlraumfreien Bonding-Ausbeute mehrerer Dies verschiedener Größen aus einem vollständigen 3D-System-on-a-Chip (SoC) in einem einzigen Transferprozess mit EVGs GEMINI erreicht. Bisher war dies eine enorme Schwierigkeit für das D2W-Bonding und ein erhebliches Hindernis für die Senkung der Kosten der Implementierung heterogener Integration.
- Juli 2022 – Unter Verwendung der ersten von SK Hynix veröffentlichten HBM3-Muster gab Global Unichip Corp. (GUC), ein führender Anbieter von Advanced-ASIC-Lösungen, bekannt, dass ihre 7,2-Gbps-HBM3-Lösung siliziumverifiziert wurde. Die Plattform wurde im Partner-Pavillon auf dem TSMC 2022 North America Technology Symposium präsentiert. Sie umfasste einen HBM3-Controller, einen PHY, eine GLink-2.5D-Die-to-Die-Schnittstelle und einen 112G-SerDes. Sowohl die fortschrittliche Plattform TSMC CoWoS-S (Silizium-Interposer) als auch CoWoS-R (organischer Interposer) unterstützen Verpackungstechnologien.
Berichtsumfang des APAC Die-Attach-Equipment-Markts
Die-Attach ist ein entscheidender Prozess in der Halbleiterverpackung. Er umfasst alle Bauelemente über verschiedene Anwendungen hinweg und trägt zu den Montagekosten bei. Die-Bonding ist ein Fertigungsprozess, der bei der Verpackung von Halbleitern eingesetzt wird. Es handelt sich dabei um den Vorgang des Befestigens eines Dies (oder Chips) auf einem Substrat oder Gehäuse mittels Epoxid oder Lot, auch bekannt als Die-Platzierung oder Die-Attach.
Der Markt ist segmentiert nach Technik (Die-Bonder (Epoxid/Klebstoff, Eutektisch, Lot, Sintern), Flip-Chip-Bonder (Bestücken und Platzieren/Reflow-Löten, Thermokompression, Thermosonisches Bonden, Hybridbonden)), Anwendung (Speicher, LED, Logik, CMOS-Bildsensor (CIS), Optoelektronik/Photonik, Diskrete Leistungsbauelemente, MEMS & Sensoren, Gestapelter Speicher & HF) und Land (Taiwan, China, Japan, Korea, Südostasien).
| Die-Bonder | Epoxid/Klebstoff (Paste/Film) |
| Eutektisch | |
| Lot | |
| Sintern | |
| Flip-Chip-Bonder | Bestücken und Platzieren / Reflow-Löten |
| Thermokompression (TCB) | |
| Thermosonisches Bonden | |
| Hybridbonden |
| Speicher |
| LED |
| Logik |
| CMOS-Bildsensor |
| Optoelektronik / Photonik |
| Diskrete Leistungsbauelemente |
| MEMS & Sensoren |
| Gestapelter Speicher & HF |
| Taiwan |
| China |
| Japan |
| Korea |
| Südostasien |
| Nach Bondingtechnik | Die-Bonder | Epoxid/Klebstoff (Paste/Film) |
| Eutektisch | ||
| Lot | ||
| Sintern | ||
| Flip-Chip-Bonder | Bestücken und Platzieren / Reflow-Löten | |
| Thermokompression (TCB) | ||
| Thermosonisches Bonden | ||
| Hybridbonden | ||
| Anwendung | Speicher | |
| LED | ||
| Logik | ||
| CMOS-Bildsensor | ||
| Optoelektronik / Photonik | ||
| Diskrete Leistungsbauelemente | ||
| MEMS & Sensoren | ||
| Gestapelter Speicher & HF | ||
| Land | Taiwan | |
| China | ||
| Japan | ||
| Korea | ||
| Südostasien | ||


Im Bericht beantwortete Schlüsselfragen
Wie groß ist der aktuelle APAC Die-Attach-Equipment-Markt?
Der APAC Die-Attach-Equipment-Markt wird voraussichtlich im Prognosezeitraum (2025–2030) einen CAGR von 15,3% verzeichnen.
Wer sind die wichtigsten Akteure im APAC Die-Attach-Equipment-Markt?
Palomar Technologies, Inc., Shinkawa Ltd., Panasonic Corporation, ASM Pacific Technology Limited und Be Semiconductor Industries N.V. sind die wichtigsten Unternehmen, die im APAC Die-Attach-Equipment-Markt tätig sind.
Welche Jahre deckt dieser APAC Die-Attach-Equipment-Markt ab?
Der Bericht deckt die historische Marktgröße des APAC Die-Attach-Equipment-Markts für die Jahre 2019, 2020, 2021, 2022, 2023 und 2024 ab. Der Bericht prognostiziert außerdem die Marktgröße des APAC Die-Attach-Equipment-Markts für die Jahre 2025, 2026, 2027, 2028, 2029 und 2030.
Seite zuletzt aktualisiert am:
APAC Die-Attach-Equipment-Branchenbericht
Statistiken zum Marktanteil, zur Größe und zur Umsatzwachstumsrate des APAC Die-Attach-Equipment-Markts 2025, erstellt von Mordor Intelligence™ Industry Reports. Die Analyse des APAC Die-Attach-Equipment-Markts umfasst einen Marktprognoseausblick für 2025 bis 2030 sowie einen historischen Überblick. Laden Sie ein Muster dieser Branchenanalyse als kostenlosen Bericht im PDF-Format herunter.








