
3D TSV 器件市场分析
3D TSV 器件市场在 2021 年至 2026 年的预测期内复合年增长率为 6.2%。为了节省封装空间,尤其是下一代产品,并满足边缘计算应用的需求,这些应用需要更短的反应时间和不同的结构 半导体制造商越来越多地使用硅通孔 (TSV) 技术进行芯片堆叠。
- 对电子设备小型化的需求不断增长,推动了 3D TSV 市场的增长。这些产品可以通过异质系统集成来实现,这可以提供更可靠的先进封装。借助极小的 MEMS 传感器和 3D 封装电子器件,人们几乎可以将传感器放置在任何地方,并可以实时监控恶劣环境中的设备,以帮助提高可靠性和正常运行时间。
- 动态随机存取存储器 (DRAM) 中的 3D TSV 将每一位数据存储在集成电路内的单独微型电容器中,推动了 3D TSV 市场的增长。美光的 3D DRAM 采用重新架构的 DRAM,在功耗和时序方面实现了显着改进,有助于开发先进的热模型。
- 最近的 COVID-19 爆发预计将在所研究市场的供应链中造成严重失衡,因为亚太地区,特别是中国,是所研究市场的主要影响者之一。此外,亚太地区许多地方政府都对半导体行业进行了长期投资,因此有望恢复市场增长。例如,中国政府筹集了约23至300亿美元的资金,用于支付2030年国家集成电路投资基金第二期的费用。
- 然而,由于高集成度而导致的热问题是 3D TSV 市场增长的一个挑战因素。由于硅通孔 (TSV) 提供了 3D IC 集成中的关键连接,因此硅和铜之间的热膨胀系数 (CTE) 差异超过 10 ppm/K,在施加热负载时会产生热应力。
3D TSV 器件市场趋势
LED封装将占有重要市场份额
- 产品中越来越多地使用发光二极管 (LED),促进了更高功率、更大密度和更低成本器件的开发。与 2D 封装不同,三维 (3D) 封装硅通孔 (TSV) 技术的使用可实现高密度垂直互连。
- TSV 集成电路缩短了连接长度,因此需要更小的寄生电容、电感和电阻,从而有效地实现单片和多功能集成的组合,从而提供高速低功耗互连。
- 底部带有薄硅膜的嵌入式设计优化了热接触,从而最大限度地减少了热阻。硅通孔 (TSV) 提供与表面安装器件的电接触,镜面侧壁可提高封装反射率并提高光效率。
- SUSS AltaSpray 技术能够对 90° 角、KOH(氢氧化钾)蚀刻腔、硅通孔 (TSV) 进行涂层集成,范围从几微米到 600μm 或更大。能够在严酷的地形(例如 TSV)上生产保形抗蚀剂涂层,使其成为 LED 晶圆级封装的理想选择,从而促进市场增长。

亚太地区将在预测期内见证最快的增长率
- 亚太地区是增长最快的市场,该地区的国家,如中国、日本、韩国、印度尼西亚、新加坡和澳大利亚,在消费电子、汽车和交通运输领域的制造水平很高, 3D TSV 市场的主要需求来源。
- 亚太地区也是世界上最活跃的制造中心之一。智能手机的日益普及和对新存储技术的需求促进了计算密集型消费电子产品的增长,从而在该地区创造了广泛的机会。随着硅晶圆广泛用于制造智能手机,5G技术的引入预计将推动5G智能手机的销售,从而可能扩大电信领域的市场。
- 2019 年 4 月,韩国推出了一种用于 3D TSV 与 NCP(非导电浆料)集成的集体激光辅助键合工艺,其中可以同时堆叠多个 TSV 芯片,以提高生产率,同时通过激光保持焊点的可靠性。辅助粘合(LAB)先进技术。这些焊点可能会增加消费和商业领域的增长,从而可能会增加市场的增长。

3D TSV 器件行业概览
由于市场多元化,3D TSV 器件市场呈现碎片化状态,市场上大型、小型和本地供应商的存在造成了高度竞争。主要参与者包括 Amkor Technology, Inc.、GLOBALFOUNDRIES、Micron Technology Inc. 等。市场的最新发展是 -。
- 2019 年 10 月——三星开发出业界首款用于 DRAM 产品的 12 层 3D 封装。该技术使用 TSV 为高端图形、FPGA 和计算卡等应用创建高容量、高带宽存储设备。
- 2019 年 4 月 - TSMC 认证了 ANSYS (ANSS) 解决方案,用于其创新的集成芯片系统 (TSMC-SoIC) 先进的 3D 芯片堆叠技术。 SoIC 是一种先进的互连技术,用于系统级集成上的多芯片堆叠,使用硅通孔 (TSV) 和晶圆上芯片键合工艺,使客户能够为高度复杂和要求苛刻的云和数据中心应用提供更高的功效和性能。
3D TSV 器件市场领导者
Taiwan Semiconductor Manufacturing Company Limited (TSMC)
Samsung Group
Toshiba Corporation
Pure Storage Inc.
ASE Group
- *免责声明:主要玩家排序不分先后
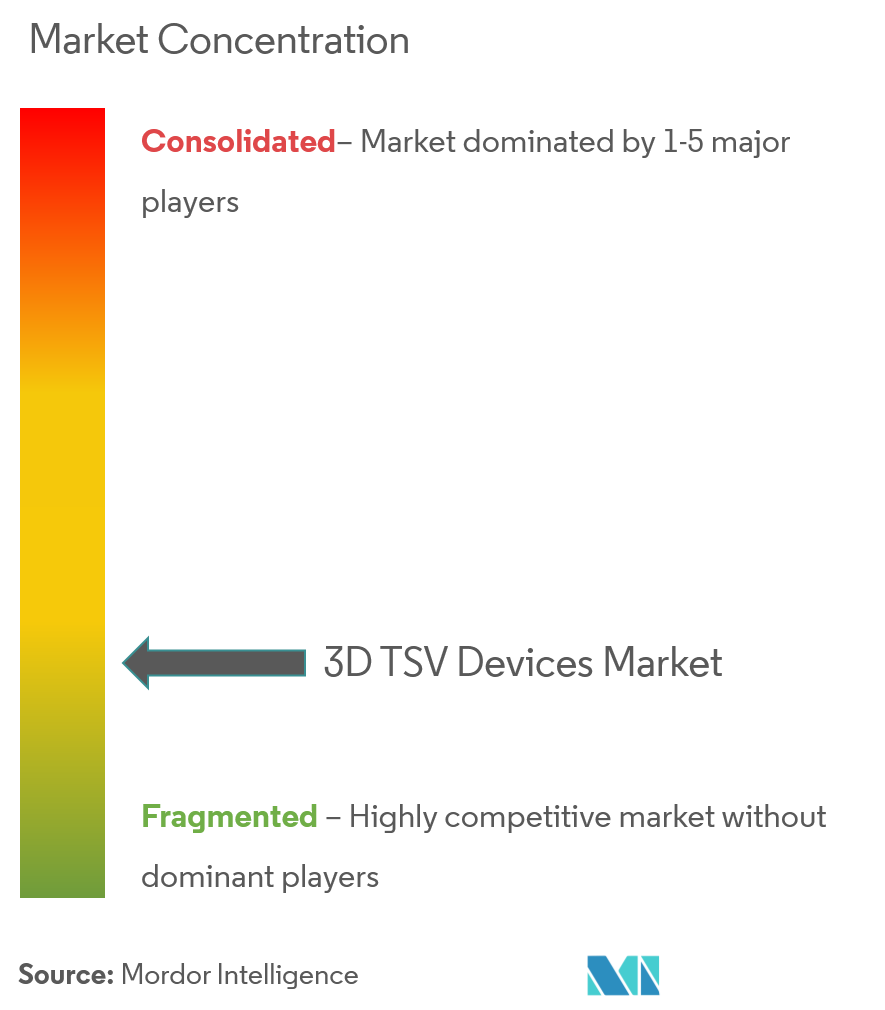
3D TSV 器件行业细分
3D tsv 器件是一种高性能互连技术,通过垂直电气连接穿过硅晶圆,从而降低功耗并提供更好的电气性能。从产品来看,子市场包括MEMS、成像、光电子、存储器、先进LED封装、CMOS图像传感器以及其他驱动市场的产品。
| 成像和光电子学 |
| 记忆 |
| MEMS/传感器 |
| 引领 |
| 其他产品 |
| 消费类电子产品 |
| 汽车 |
| 信息技术和电信 |
| 卫生保健 |
| 其他最终用户行业 |
| 北美 | 美国 |
| 加拿大 | |
| 欧洲 | 德国 |
| 法国 | |
| 英国 | |
| 欧洲其他地区 | |
| 亚太 | 中国 |
| 日本 | |
| 印度 | |
| 亚太其他地区 | |
| 世界其他地区 |
| 按产品类型 | 成像和光电子学 | |
| 记忆 | ||
| MEMS/传感器 | ||
| 引领 | ||
| 其他产品 | ||
| 按最终用户行业 | 消费类电子产品 | |
| 汽车 | ||
| 信息技术和电信 | ||
| 卫生保健 | ||
| 其他最终用户行业 | ||
| 地理 | 北美 | 美国 |
| 加拿大 | ||
| 欧洲 | 德国 | |
| 法国 | ||
| 英国 | ||
| 欧洲其他地区 | ||
| 亚太 | 中国 | |
| 日本 | ||
| 印度 | ||
| 亚太其他地区 | ||
| 世界其他地区 | ||
3D TSV 器件市场研究常见问题解答
目前 3D TSV 器件市场规模有多大?
3D TSV 器件市场预计在预测期内(2024-2029 年)复合年增长率为 6.20%
3D TSV 器件市场的主要参与者是谁?
Taiwan Semiconductor Manufacturing Company Limited (TSMC)、Samsung Group、Toshiba Corporation、Pure Storage Inc.、ASE Group 是 3D TSV 器件市场运营的主要公司。
3D TSV 器件市场增长最快的地区是哪个?
预计亚太地区在预测期内(2024-2029 年)复合年增长率最高。
哪个地区在 3D TSV 器件市场中占有最大份额?
2024年,北美将占据3D TSV设备市场最大的市场份额。
3D TSV 器件市场涵盖哪些年份?
该报告涵盖了 3D TSV 器件市场的历史市场规模:2019 年、2020 年、2021 年、2022 年和 2023 年。该报告还预测了 3D TSV 器件市场的规模:2024 年、2025 年、2026 年、2027 年、2028 年和 2029 年。
页面最后更新于:
3D TSV 器件行业报告
Mordor Intelligence™ 行业报告创建的 2024 年 3D TSV 设备市场份额、规模和收入增长率统计数据。 3D TSV 设备分析包括 2029 年的市场预测展望和历史概览。获取此行业分析的样本(免费下载 PDF 报告)。



