
3D-анализ рынка устройств TSV
На рынке устройств 3D TSV зарегистрирован среднегодовой темп роста 6,2% за прогнозируемый период 2021–2026 годов. Для экономии места в упаковке, особенно для продуктов следующего поколения, а также для удовлетворения спроса со стороны приложений периферийных вычислений, которые требуют более короткого времени реакции и различных Производители полупроводниковых структур все чаще используют методы кремниевых переходов (TSV) для укладки микросхем.
- Растущий спрос на миниатюризацию электронных устройств стимулирует рост рынка 3D TSV. Эти продукты могут быть получены путем интеграции гетеросистем, что может обеспечить более надежную и усовершенствованную упаковку. Благодаря чрезвычайно маленьким МЭМС-датчикам и трехмерной электронике датчики можно размещать практически где угодно и контролировать оборудование в суровых условиях в режиме реального времени, что помогает повысить надежность и время безотказной работы.
- 3D TSV в динамической памяти с произвольным доступом (DRAM), которая хранит каждый бит данных в отдельном крошечном конденсаторе внутри интегральной схемы, способствует росту рынка 3D TSV. 3D DRAM от Micron с переработанной архитектурой DRAM обеспечивает значительное улучшение мощности и синхронизации, что помогает в разработке расширенного теплового моделирования.
- Ожидается, что недавняя вспышка COVID-19 создаст значительный дисбаланс в цепочке поставок на изучаемом рынке, поскольку Азиатско-Тихоокеанский регион, особенно Китай, является одним из основных факторов влияния на изучаемый рынок. Кроме того, многие местные органы власти в Азиатско-Тихоокеанском регионе инвестировали в полупроводниковую промышленность в рамках долгосрочной программы, следовательно, ожидается восстановление роста рынка. Например, китайское правительство привлекло от 23 до 30 миллиардов долларов США для оплаты второго этапа своего Национального инвестиционного фонда IC 2030.
- Однако проблемы с перегревом, вызванные высоким уровнем внедрения, являются сложным фактором для роста рынка 3D TSV. Поскольку кремниевый переходник (TSV) обеспечивает ключевое соединение при интеграции 3D-ИС, разница коэффициентов теплового расширения (КТР) между кремнием и медью составляет более 10 ppm/K, что создает термическое напряжение при приложении тепловой нагрузки.
Тенденции рынка 3D-устройств TSV
Светодиодная упаковка будет занимать значительную долю рынка
- Растущее использование светодиодов (LED) в продуктах способствовало разработке устройств большей мощности, большей плотности и более низкой стоимости. Использование технологии трехмерной (3D) упаковки через кремний (TSV) обеспечивает высокую плотность вертикальных межсоединений, в отличие от 2D-упаковки.
- Интегральная схема TSV уменьшает длину соединений и, следовательно, требует меньших паразитных емкостей, индуктивностей и сопротивлений там, где эффективно сочетается монолитная и многофункциональная интеграция, что обеспечивает высокоскоростные межсоединения с низким энергопотреблением.
- Встроенная конструкция с тонкими силиконовыми мембранами внизу оптимизирует тепловой контакт и, следовательно, сводит к минимуму термическое сопротивление. Силиконовые отверстия (TSV) обеспечивают электрический контакт с устройствами поверхностного монтажа, а зеркальные боковые стенки увеличивают отражательную способность корпуса и улучшают светоотдачу.
- Технология SUSS AltaSpray позволяет покрывать интегральные углы 90°, полости, протравленные KOH (гидроксидом калия), сквозные отверстия кремния (TSV) толщиной от нескольких микрон до 600 мкм и более. Способность создавать конформные резистивные покрытия на сложных рельефах, таких как TSV, делает их идеальным выбором для упаковки светодиодов на уровне пластины, что увеличивает рост рынка.

В Азиатско-Тихоокеанском регионе будут наблюдаться самые быстрые темпы роста за прогнозируемый период
- Азиатско-Тихоокеанский регион является самым быстрорастущим рынком, поскольку в таких странах региона, как Китай, Япония, Южная Корея, Индонезия, Сингапур и Австралия, зафиксированы высокие уровни производства в секторах бытовой электроники, автомобилестроения и транспорта, что ключевой источник спроса на рынке 3D TSV.
- Азиатско-Тихоокеанский регион также является одним из самых активных производственных центров в мире. Растущая популярность смартфонов и спрос на новые технологии памяти привели к росту потребительской электроники с интенсивными вычислениями, тем самым создав широкий спектр возможностей в этом регионе. Поскольку кремниевые пластины широко используются для производства смартфонов, ожидается, что внедрение технологии 5G приведет к увеличению продаж смартфонов 5G, что может привести к росту рынка в телекоммуникационном секторе.
- В апреле 2019 года в Корее реализован коллективный процесс лазерной сварки для интеграции 3D TSV с NCP (непроводящей пастой), при котором несколько матриц TSV могут быть установлены одновременно для повышения производительности при сохранении надежности паяных соединений с помощью лазера. Передовая технология вспомогательного склеивания (LAB). Эти паяные соединения могут увеличить рост потребительского и коммерческого сегментов, что может увеличить рост рынка.

Обзор отрасли устройств 3D TSV
Рынок устройств 3D TSV фрагментирован, поскольку рынок диверсифицирован, а существование на рынке крупных, мелких и местных поставщиков создает высокую конкуренцию. Ключевыми игроками являются Amkor Technology, Inc., GLOBALFOUNDRIES, Micron Technology Inc. и т. д. Последние разработки на рынке:.
- Октябрь 2019 г. — Samsung разработала первую в отрасли 12-слойную 3D-упаковку для продуктов DRAM. В этой технологии используются TSV для создания устройств памяти большой емкости с высокой пропускной способностью для таких приложений, как высокопроизводительная графика, FPGA и вычислительные карты.
- Апрель 2019 г. — компания TSMC сертифицировала решения ANSYS (ANSS) для своей инновационной технологии укладки 3D-чипов система на интегрированных кристаллах (TSMC-SoIC). SoIC — это передовая технология межкомпонентных соединений для стекирования нескольких кристаллов при интеграции на системном уровне с использованием сквозного кремниевого перехода (TSV) и процесса соединения кристалла на пластине, позволяющая клиентам повысить энергоэффективность и производительность для очень сложных и требовательных облачных приложений и центров обработки данных.
Лидеры рынка устройств 3D TSV
Taiwan Semiconductor Manufacturing Company Limited (TSMC)
Samsung Group
Toshiba Corporation
Pure Storage Inc.
ASE Group
- *Отказ от ответственности: основные игроки отсортированы в произвольном порядке
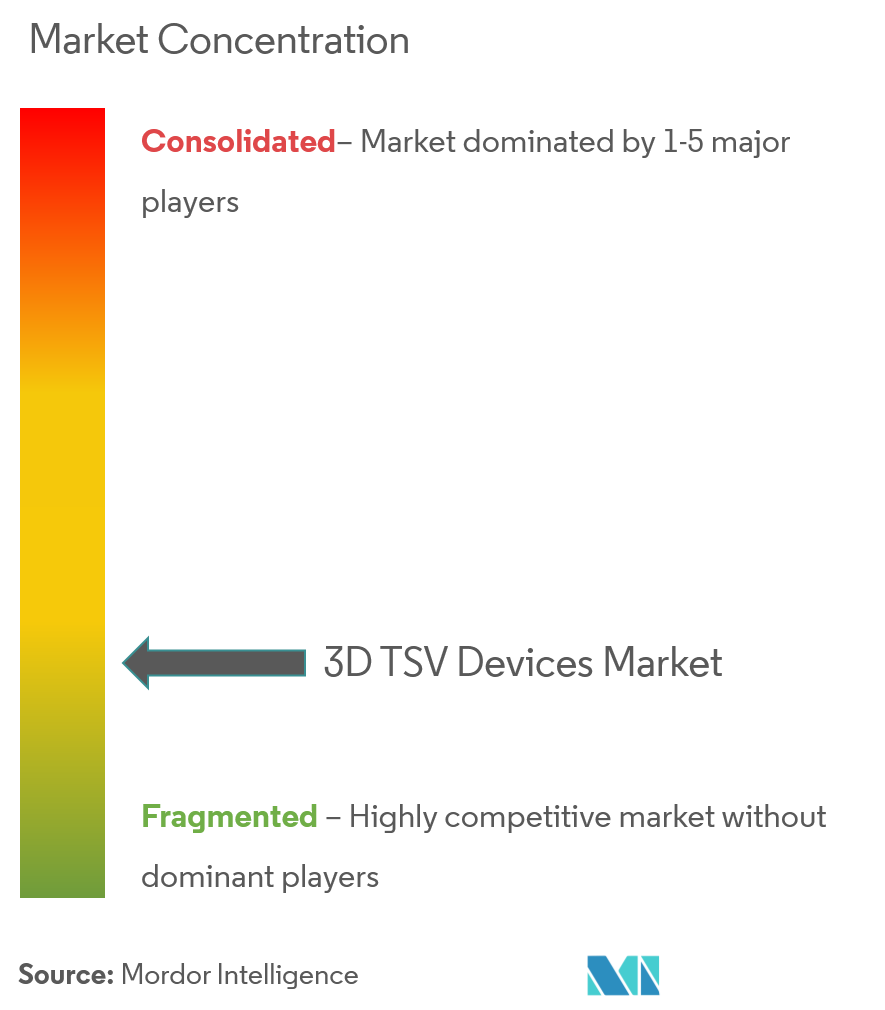
Сегментация отрасли устройств 3D TSV
Устройства 3D tsv — это высокопроизводительная технология межсоединения, которая проходит через кремниевую пластину посредством вертикального электрического соединения, что снижает энергопотребление и обеспечивает лучшие электрические характеристики. В зависимости от продукта субрынки включают в себя мемы, изображения и оптоэлектронику, память, усовершенствованную светодиодную упаковку, CMOS-датчики изображения и другие, которые движут рынком.
| Визуализация и оптоэлектроника |
| Память |
| МЭМС/датчики |
| ВЕЛ |
| Другие продукты |
| Бытовая электроника |
| Автомобильная промышленность |
| ИТ и Телеком |
| Здравоохранение |
| Другие отрасли конечных пользователей |
| Северная Америка | Соединенные Штаты |
| Канада | |
| Европа | Германия |
| Франция | |
| Великобритания | |
| Остальная Европа | |
| Азиатско-Тихоокеанский регион | Китай |
| Япония | |
| Индия | |
| Остальная часть Азиатско-Тихоокеанского региона | |
| Остальной мир |
| По типу продукта | Визуализация и оптоэлектроника | |
| Память | ||
| МЭМС/датчики | ||
| ВЕЛ | ||
| Другие продукты | ||
| По отраслям конечных пользователей | Бытовая электроника | |
| Автомобильная промышленность | ||
| ИТ и Телеком | ||
| Здравоохранение | ||
| Другие отрасли конечных пользователей | ||
| География | Северная Америка | Соединенные Штаты |
| Канада | ||
| Европа | Германия | |
| Франция | ||
| Великобритания | ||
| Остальная Европа | ||
| Азиатско-Тихоокеанский регион | Китай | |
| Япония | ||
| Индия | ||
| Остальная часть Азиатско-Тихоокеанского региона | ||
| Остальной мир | ||
Часто задаваемые вопросы по исследованию рынка устройств 3D TSV
Каков текущий размер рынка 3D-устройств TSV?
По прогнозам, среднегодовой темп роста рынка 3D TSV-устройств составит 6,20% в течение прогнозируемого периода (2024-2029 гг.).
Кто являются ключевыми игроками на рынке 3D TSV устройства?
Taiwan Semiconductor Manufacturing Company Limited (TSMC), Samsung Group, Toshiba Corporation, Pure Storage Inc., ASE Group — основные компании, работающие на рынке 3D-устройств TSV.
Какой регион на рынке 3D TSV устройства является наиболее быстрорастущим?
По оценкам, Азиатско-Тихоокеанский регион будет расти с самым высоким среднегодовым темпом роста за прогнозируемый период (2024-2029 гг.).
Какой регион имеет самую большую долю на рынке 3D TSV Devices?
В 2024 году на Северную Америку будет приходиться наибольшая доля рынка 3D-устройств TSV.
Какие годы охватывает рынок 3D-устройств TSV?
В отчете рассматривается исторический размер рынка 3D-устройств TSV за годы 2019, 2020, 2021, 2022 и 2023 годы. В отчете также прогнозируется размер рынка 3D-устройств TSV на годы 2024, 2025, 2026, 2027, 2028 и 2029 годы.
Последнее обновление страницы:
Отчет об отрасли устройств 3D TSV
Статистические данные о доле рынка, размере и темпах роста доходов 3D TSV Devices в 2024 году, предоставленные Mordor Intelligence™ Industry Reports. Анализ 3D TSV Devices включает прогноз рынка до 2029 года и исторический обзор. Получите образец этого отраслевого анализа в виде бесплатного отчета в формате PDF, который можно загрузить.



