
Análise de mercado de equipamentos de fixação de moldes da APAC
Espera-se que o mercado de equipamentos Die Attach registre um CAGR de 15,3% durante o período de previsão. Espera-se que o mercado se beneficie das oportunidades de montagem e embalagem criadas pelas tendências mencionadas abaixo.
- Um foco significativo para a próxima rodada de investimentos por parte dos fornecedores do mercado é o desenvolvimento de soluções de colagem e embalagem de matrizes para smartphones compatíveis com 5G menores e altamente complexos. 5G é uma plataforma de conectividade unificadora para inovação futura, permitindo acesso contínuo e seguro à nuvem com velocidades de transmissão de dados e vídeo significativamente mais altas.
- A adoção dos recursos 5G pelos usuários expande as atividades de banda larga móvel e acelera o uso da inteligência artificial para a Internet de Todas as Coisas. Da mesma forma, os processos de empacotamento em nível de substrato e wafer para internet móvel, computação, 5G e aplicações automotivas para usuários finais levaram a indústria de semicondutores a ver uma recuperação no investimento de capital em memórias e lógica.
- A empresa compartilhou planos para um aumento de médio a longo prazo no investimento de capital para expansão de aplicações de semicondutores e FPD. Considerando que, de acordo com Shibaura, o desenvolvimento ativo de equipamentos de ligação de alta velocidade e alta precisão para FOWLP/PLP e μLED está sendo procurado em equipamentos de montagem de semicondutores.
- BESI compartilhou planos para investir em novas tecnologias de montagem, como FOWLP, TCB, TSV, matrizes ultrafinas, ligação híbrida, grande área, moldagem em nível de wafer, solar e revestimento de bateria de íon de lítio 3D para a nova sociedade digital. Sua linha de equipamentos Die Attach inclui um único chip, multi-chip, multi-módulo, flip chip, TCB, FOWLP, sistemas híbridos de colagem de matrizes e sistemas de classificação de matrizes.
- No entanto, uma fonte de preocupação é a persistência de perspectivas incertas devido ao impacto da propagação global da COVID-19. Os bloqueios e as paralisações da produção em toda a Ásia-Pacífico devido ao surto de COVID-19 tiveram um impacto significativo na produção e no consumo de semicondutores. Com a maioria dos IDS e fundições localizadas na região, o impacto das paralisações levou à redução dos gastos em investimentos de capital. É provável que isto tenha impacto no mercado estudado, com uma recuperação mais lenta esperada ao longo de 2021.
Tendências de mercado de equipamentos de fixação de matrizes da APAC
Espera-se que a CEI testemunhe um crescimento significativo
- Os sensores de imagem CMOS oferecem funções de câmera em smartphones e outros produtos e, à medida que a demanda aumenta, surgem problemas de fabricação relacionados na fábrica.
- O desempenho de dados com maior largura de banda progrediu do 3G para o 4G e, atualmente, para o 5G, a demanda por câmeras de maior qualidade cresceu. Essa tendência impulsionou as técnicas de empilhamento de sensores de imagem CMOS com base na necessidade de contagens de pixels mais altas e melhor resolução. Além dessas tendências, as áreas de identificação biométrica, detecção 3D e aplicações aprimoradas de visão humana aumentaram o crescimento do segmento.
- A demanda dos clientes por câmeras maiores e melhores resulta em mais sensores com tamanhos de matrizes maiores. Além do dimensionamento de pixels, os sensores de imagem CMOS estão passando por outras inovações, como o empilhamento de matrizes. Os fornecedores no mercado estudado também estão usando diferentes tecnologias de interconexão, como vias através de silício (TSVs), ligação híbrida e pixel a pixel para o mesmo.
- Na ligação híbrida, por exemplo, as matrizes são conectadas usando interconexões cobre-cobre. Para isso, dois wafers são processados em uma fábrica. Um é o wafer lógico, enquanto o outro é o wafer de matriz de pixels. Os dois wafers são unidos por meio de uma ligação dielétrica com dielétrica, seguida por uma conexão metal com metal.
- As tecnologias DBI de ligação híbrida, tecnologia proprietária da Xperi, estão sendo usadas significativamente pela Samsung na fabricação de sensores de imagem CMOS para seus telefones. Esta tecnologia para sensores de imagem CMOS facilita a ligação permanente de Cu-Cu à temperatura ambiente, o recozimento em baixa temperatura (cerca de 300°C) e nenhum processo de ligação por pressão externa (dielétrico/metal).
- Antes disso, a tecnologia de ligação direta desempenhou um papel facilitador na realização de BSI de escala de pixel (iluminação traseira) e BSI empilhado com múltiplas variações geracionais lideradas pela Xperifor ao longo de 15 anos.

LED dominará participação de mercado
- O material de fixação da matriz representa um papel fundamental no desempenho e na confiabilidade de LEDs de média, alta e superalta potência. A demanda por equipamentos de fixação de matriz está aumentando com o aumento da taxa de penetração do LED. A seleção de material de fixação de matriz adequado para uma estrutura e aplicação de chip específicas depende de várias considerações, que incluem o processo de empacotamento (rendimento e rendimento), desempenho (saída de dissipação térmica e saída de luz), confiabilidade (manutenção de lúmen) e custo. Estanho dourado eutético, epóxis preenchidos com prata, solda, silicones e materiais sinterizados têm sido usados para fixação de matrizes de LED.
- A SFE fornece um método de colagem de adesivo epóxi onde sua máquina LED Epoxy Die Bonder apresenta um tempo de índice de 0,2 segundos/ciclo (taxa de operação de 90 por cento) com um tamanho de chip de padrões 250 * 250, fornecendo reconhecimento de quadro de chumbo por meio de 2 câmeras. Sua função de software fornece funções de ensino de nível de montagem automática e nível de captação.
- Além disso, os adesivos condutores (principalmente epóxis preenchidos com prata) constituem a maior classe de materiais de fixação térmica (por número de unidade) para LEDs. Eles são compatíveis com equipamentos de empacotamento de back-end existentes e fornecem um equilíbrio atraente entre custo e desempenho (normalmente até 50 W/mK térmicas com compatibilidade de refluxo secundário). Como aderem ao silício puro, eles são o material preferido para matrizes sem metalização final, como GaN em silício.
- Além disso, no mercado de LED, existem muitos concorrentes rivais, e a ASM é um dos participantes proeminentes neste mercado; seu LED Epoxy High Speed Die Bonder AD830 domina o mercado de LED. É rápido, confiável e preciso, com precisão de posicionamento da matriz de +/- 1 mil e +/- 3 graus, o tempo de ciclo para um chip pequeno como 10mil x 10mil é de 180 ms, o que equivale a um UPH equivalente a 18.000. É equipado com um sistema de inspeção Post bond que monitora a unidade colada na faixa de colocação predefinida.

Visão geral da indústria de equipamentos de fixação de matrizes da APAC
O mercado de equipamentos APAC Die Attach é moderadamente competitivo, com um grande número de participantes com uma pequena participação de mercado. As empresas continuam inovando e firmando parcerias estratégicas para manter sua participação no mercado.
- Abril de 2022 - Impulsionando o Centro de Industrialização da Revolução Elétrica (DER-IC) O Nordeste recebeu equipamentos da Inseto, um importante distribuidor técnico de ferramentas e materiais, para melhorar suas capacidades de eletrônica de potência, máquinas e acionamentos (PEMD). A primeira microperfuradora a ser instalada no Reino Unido é uma prensa de sinterização AMX P100, que faz parte do equipamento fornecido e permitirá a produção de módulos de alta confiabilidade e alta potência.
- Junho de 2022 – A nova série 7KF Bonder foi desenvolvida pela West Bond. Esta conhecida empresa projeta e fabrica uma linha de máquinas para colagem de fios e matrizes para fixação, equipamentos para teste de tração e cisalhamento de fios, componentes ultrassônicos e acessórios para a indústria de embalagens microeletrônicas. Esta excelente ferramenta é feita para lidar com as difíceis aplicações de ligação encontradas nos campos de RF, micro-ondas, semicondutores, híbridos e dispositivos médicos.
Líderes de mercado de equipamentos de fixação de moldes da APAC
Palomar Technologies, Inc.
Shinkawa Ltd.
Panasonic Corporation
ASM Pacific Technology Limited
Be Semiconductor Industries N.V.
- *Isenção de responsabilidade: Principais participantes classificados em nenhuma ordem específica
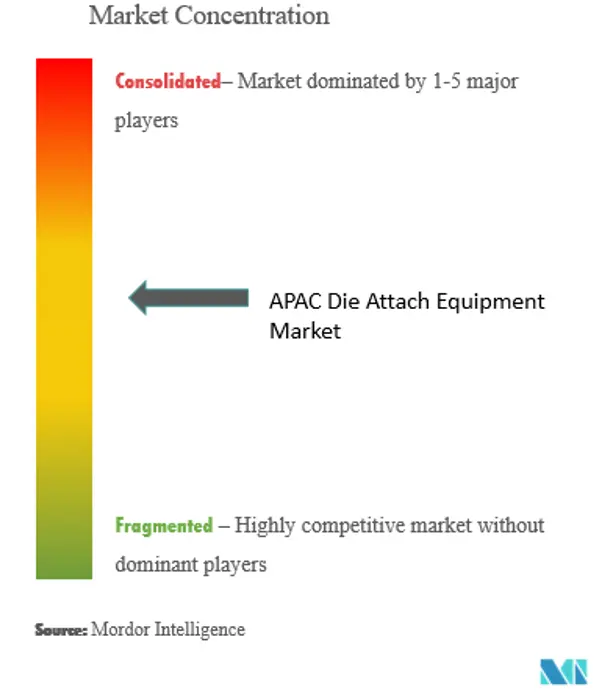
Notícias do mercado de equipamentos Die Attach da APAC
- Julho de 2022 - Um grande avanço na fusão die-to-wafer (D2W) e ligação híbrida foi feito, de acordo com o EV Group (EVG), um fornecedor de ligação de wafer e equipamentos de litografia para os mercados de MEMS, nanotecnologia e semicondutores. Isso foi conseguido demonstrando com sucesso o rendimento de ligação 100% livre de vazios de múltiplas matrizes de vários tamanhos a partir de um sistema em um chip (SoC) 3D completo em um único processo de transferência usando o GEMINI da EVG. Até agora, alcançar tal feito tinha sido uma enorme dificuldade para a ligação D2W e um obstáculo significativo para reduzir o custo da implementação de integração heterogénea.
- Julho de 2022 - Usando as primeiras amostras HBM3 divulgadas pela SK Hynix, a Global Unichip Corp. (GUC), uma líder em ASIC avançado, revelou que sua solução HBM3 de 7,2 Gbps foi comprovada em silício. A plataforma foi exibida no Partner Pavilion no TSMC 2022 North America Technology Symposium. Ele apresentava um controlador HBM3, um PHY, uma interface GLink-2.5D die-to-die e um SerDes 112G. Tanto a plataforma avançada TSMC CoWoS-S (interposer de silício) quanto a CoWoS-R (interposer orgânico) suportam tecnologias de embalagem.
Segmentação da indústria de equipamentos de fixação de matriz APAC
Die Attach é um processo crucial em embalagens de semicondutores. Abrange todos os dispositivos em diversas aplicações e contribui para os custos de montagem. Die bonding é um processo de fabricação usado na embalagem de semicondutores. É o ato de fixar uma matriz (ou chip) a um substrato ou embalagem por epóxi ou solda, também conhecido como colocação de matriz ou fixação de matriz.
O mercado é segmentado por Técnica (Die bonder (Epóxi/Adesivo, Eutético, Solda, Sinterização), Flip chip bonder (Pick and Place/reflow soldering, Thermocompression, Thermosonic Bonding, Hybrid Bonding)), Aplicação (Memória, LED, Lógica, Sensor de imagem CMOS (CIS), optoeletrônica/fotônica, dispositivos de energia discretos, MEMS e sensores, memória empilhada e RF) e país (Taiwan, China, Japão, Coréia, Sudeste Asiático).
| O Bonder | Epóxi/adesivo (pasta/filme) |
| Eutético | |
| Solda | |
| Sinterização | |
| Flip Chip Bonder | Escolha e coloque / soldagem por refluxo |
| Termocompressão (TCB) | |
| Ligação Termossônica | |
| Ligação Híbrida |
| Memória |
| LIDERADO |
| Lógica |
| Sensor de imagem CMOS |
| Optoeletrônica / Fotônica |
| Dispositivos de energia discretos |
| MEMS e sensores |
| Memória empilhada e RF |
| Taiwan |
| China |
| Japão |
| Coréia |
| Sudeste da Ásia |
| Por técnica de colagem | O Bonder | Epóxi/adesivo (pasta/filme) |
| Eutético | ||
| Solda | ||
| Sinterização | ||
| Flip Chip Bonder | Escolha e coloque / soldagem por refluxo | |
| Termocompressão (TCB) | ||
| Ligação Termossônica | ||
| Ligação Híbrida | ||
| Aplicativo | Memória | |
| LIDERADO | ||
| Lógica | ||
| Sensor de imagem CMOS | ||
| Optoeletrônica / Fotônica | ||
| Dispositivos de energia discretos | ||
| MEMS e sensores | ||
| Memória empilhada e RF | ||
| País | Taiwan | |
| China | ||
| Japão | ||
| Coréia | ||
| Sudeste da Ásia | ||
Perguntas frequentes sobre pesquisa de mercado de equipamentos Die Attach da APAC
Qual é o tamanho atual do mercado de equipamentos de fixação de moldes da APAC?
O mercado de equipamentos APAC Die Attach deve registrar um CAGR de 15,30% durante o período de previsão (2024-2029)
Quem são os principais atores do mercado de equipamentos APAC Die Attach?
Palomar Technologies, Inc., Shinkawa Ltd., Panasonic Corporation, ASM Pacific Technology Limited, Be Semiconductor Industries N.V. são as principais empresas que operam no mercado APAC Die Attach Equipment.
Que anos este mercado de equipamentos APAC Die Attach cobre?
O relatório abrange o tamanho histórico do mercado APAC Die Attach Equipment para os anos 2019, 2020, 2021, 2022 e 2023. O relatório também prevê o tamanho do mercado APAC Die Attach Equipment para os anos 2024, 2025, 2026, 2027, 2028 e 2029.
Página atualizada pela última vez em:
Relatório da indústria de equipamentos de fixação de moldes da APAC
Estatísticas para a participação de mercado, tamanho e taxa de crescimento de receita da APAC Die Attach Equipment em 2024, criadas por Mordor Intelligence™ Industry Reports. A análise do APAC Die Attach Equipment inclui uma perspectiva de previsão de mercado para 2029 e uma visão geral histórica. Obtenha uma amostra desta análise do setor como um download gratuito em PDF do relatório.



