
Mordor Intelligenceによるアジア太平洋地域ダイアタッチ装置市場分析
アジア太平洋地域ダイアタッチ装置市場は、予測期間中にCAGR 15.3%を記録すると予想されています。
- 市場ベンダーによる次回投資ラウンドの重要な焦点は、小型かつ高度に複雑な5G対応スマートフォン向けのダイボンディングおよびパッケージングソリューションの開発です。5Gは将来のイノベーションのための統合的な接続プラットフォームであり、大幅に高速なデータおよびビデオ伝送速度での継続的な安全なクラウドアクセスを可能にします。
- 5G機能のユーザー採用はモバイルブロードバンド活動を拡大し、あらゆるモノのインターネットにおける人工知能の利用を加速させます。同様に、モバイルインターネット、コンピューティング、5G、および自動車エンドユーザーアプリケーション向けの基板およびウェーハレベルパッケージングプロセスが、半導体業界においてメモリおよびロジックへの設備投資の回復をもたらしました。
- 同社は、拡大する半導体およびFPDアプリケーションに向けた設備投資の中長期的な増加計画を共有しています。一方、Shibauraによれば、半導体組立装置においてFOWLP / PLPおよびμLED向けの高速・高精度ボンディング装置の積極的な開発が求められています。
- BESIは、新しいデジタル社会に向けてFOWLP、TCB、TSV、超薄型ダイ、ハイブリッドボンディング、大面積、ウェーハレベルモールディング、太陽光発電、および3Dリチウムイオン電池メッキなどの新しい組立技術への投資計画を共有しています。ダイアタッチ装置のラインナップには、シングルチップ、マルチチップ、マルチモジュール、フリップチップ、TCB、FOWLP、ハイブリッドダイボンディングシステム、およびダイソーティングシステムが含まれます。
- しかしながら、懸念事項の一つは、COVID-19の世界的な感染拡大の影響による不確実な見通しが続いていることです。COVID-19の感染拡大によるアジア太平洋地域全体でのロックダウンおよび生産停止は、半導体の生産と消費に大きな影響を与えました。IDSおよびファウンドリの大部分が同地域に立地していることから、操業停止の影響により設備投資への支出が減少しました。これは調査対象市場に影響を与える可能性があり、2021年を通じて回復の鈍化が予想されます。
アジア太平洋地域ダイアタッチ装置市場のトレンドとインサイト
CISは大幅な成長が見込まれる
- CMOSイメージセンサーはスマートフォンやその他の製品にカメラ機能を提供してきており、スケーリング需要が高まるにつれて、ファブにおける関連する製造上の問題が生じています。
- 3Gから4G、そして現在の5Gへと高帯域幅データパフォーマンスが進化するにつれ、より高品質なカメラへの需要が高まっています。このトレンドは、より高いピクセル数と優れた解像度の必要性に基づいたCMOSイメージセンサーのスタッキング技術を推進しています。これらのトレンドを超えて、生体認証ID、3Dセンシング、および拡張人間視覚アプリケーションの分野がセグメントの成長を促進しています。
- より大きく優れたカメラに対する顧客需要は、より大きなダイサイズを持つより多くのセンサーをもたらします。ピクセルスケーリングに加えて、CMOSイメージセンサーはダイスタッキングなどの他のイノベーションも経験しています。調査対象市場のベンダーも、シリコン貫通ビア(TSV)、ハイブリッドボンディング、ピクセル間接続などの異なるインターコネクト技術を使用しています。
- 例えばハイブリッドボンディングでは、ダイは銅対銅インターコネクトを使用して接続されます。このために、2枚のウェーハがファブで処理されます。一方はロジックウェーハであり、もう一方はピクセルアレイウェーハです。2枚のウェーハは誘電体対誘電体ボンドを使用して接合され、続いて金属対金属接続が行われます。
- Xperi社の独自技術であるハイブリッドボンディングDBI技術は、CMOSイメージセンサー製造に向けてSamsungによって大幅に使用されています。CMOSイメージセンサー向けのこの技術は、室温での銅対銅永久ボンディング、低温アニーリング(約300℃)、および外部圧力なしのボンディングプロセス(誘電体/金属)を実現します。
- これに先立ち、ダイレクトボンド技術は、Xperi社が15年以上にわたって主導してきた複数世代にわたるバリエーションを持つピクセルスケーリング(裏面照射型)BSIおよびスタックドBSIの実現において重要な役割を果たしてきました。

LEDが市場シェアを支配
- ダイアタッチ材料は、中出力、高出力、超高出力LEDの性能と信頼性において重要な役割を果たしています。LED普及率の上昇に伴い、ダイアタッチ装置への需要が増加しています。特定のチップ構造およびアプリケーションに適したダイアタッチ材料の選択は、パッケージングプロセス(スループットおよび歩留まり)、性能(熱放散出力および光出力)、信頼性(光束維持)、およびコストなど様々な考慮事項に依存します。共晶金錫、銀充填エポキシ、はんだ、シリコーン、および焼結材料はすべてLEDダイアタッチに使用されてきました。
- SFEは、エポキシ接着剤ボンディング方式を提供しており、そのLEDエポキシダイボンダーマシンは、250×250標準のチップサイズで2台のカメラによるリードフレーム認識を提供し、インデックスタイム0.2秒/サイクル(稼働率90%)を特徴としています。そのソフトウェア機能は、自動マウントレベルおよびピックアップレベルのティーチング機能を提供します。
- さらに、導電性接着剤(主に銀充填エポキシ)はLED向けの熱ダイアタッチ材料の最大のクラス(ユニット数による)を構成しています。これらは既存のバックエンドパッケージング装置と互換性があり、魅力的なコスト/性能バランスを提供します(通常、二次リフロー互換性を持つ最大50 W/mKの熱特性)。ベアシリコンに接着するため、GaN on siliconのようなバックエンドメタライゼーションのないダイに最も好まれる材料です。
- さらに、LED市場には多くの競合他社が存在し、ASMはこの市場の著名なプレーヤーの一つです。そのLEDエポキシ高速ダイボンダーAD830はLED市場で優位を占めています。ダイ配置精度±1ミル、±3度で高速、信頼性が高く、正確であり、10ミル×10ミルのような小型チップのサイクルタイムは180ミリ秒で、これは18,000の同等UPHに相当します。事前設定された配置範囲でボンディングされたユニットを監視するポストボンド検査システムを搭載しています。

競合状況
アジア太平洋地域ダイアタッチ装置市場は、小さな市場シェアを持つ多数のプレーヤーが存在し、中程度の競争状態にあります。各企業は市場シェアを維持するために革新を続け、戦略的パートナーシップを締結しています。
- 2022年4月 - 電動革命産業化センター(DER-IC)ノースイーストは、工具および材料の大手技術ディストリビューターであるInsetoから、パワーエレクトロニクス、機械、ドライブ(PEMD)能力を向上させるための装置を受領しました。提供された装置の一部であるAMX P100焼結プレスは、英国に設置される最初のマイクロパンチマシンであり、高信頼性・高出力モジュールの生産を可能にします。
- 2022年6月 - 新しい7KFボンダーシリーズがWest Bondによって開発されました。この著名な企業は、マイクロエレクトロニクスパッケージング産業向けのワイヤーボンディングおよびダイアタッチマシン、ワイヤープルおよびシェアテスト装置、超音波コンポーネント、およびアクセサリーのラインを設計・製造しています。この優れたツールは、RF、マイクロ波、半導体、ハイブリッド、および医療機器分野で見られる困難なボンディングアプリケーションに対応するために作られています。
アジア太平洋地域ダイアタッチ装置業界リーダー
Palomar Technologies, Inc.
Shinkawa Ltd.
Panasonic Corporation
ASM Pacific Technology Limited
Be Semiconductor Industries N.V.
- *免責事項:主要選手の並び順不同
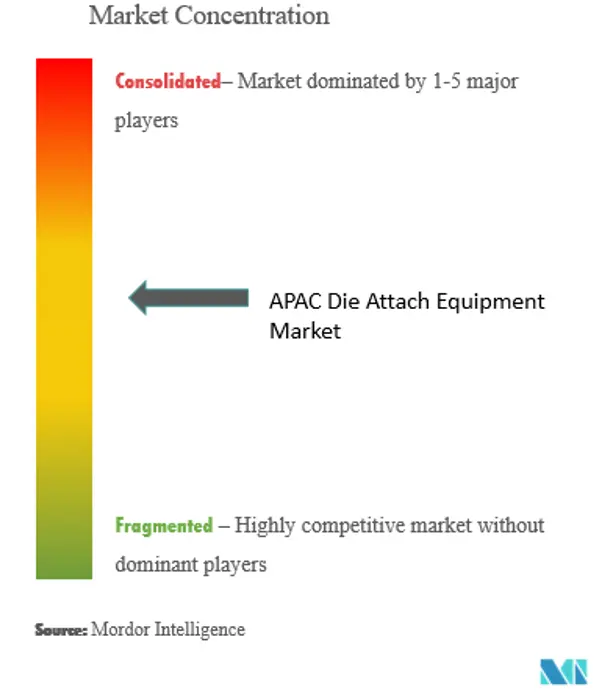
最近の業界動向
- 2022年7月 - MEMS、ナノテクノロジー、および半導体市場向けのウェーハボンディングおよびリソグラフィー装置のプロバイダーであるEV Group(EVG)によると、ダイ対ウェーハ(D2W)融合およびハイブリッドボンディングにおける重要な進歩が達成されました。これは、EVGのGEMINIを使用した単一転写プロセスにおいて、完全な3Dシステムオンチップ(SoC)からの様々なサイズの複数ダイの100%ボイドフリーボンディング歩留まりのデモンストレーションに成功することで達成されました。これまで、このような偉業を達成することはD2Wボンディングにとって大きな困難であり、ヘテロジニアスインテグレーション実装のコスト削減への重大な障壁でした。
- 2022年7月 - SK Hynixが公開した最初のHBM3サンプルを使用して、先進ASICの大手であるGlobal Unichip Corp.(GUC)は、7.2 GbpsのHBM3ソリューションがシリコン実証済みであることを発表しました。このプラットフォームはTSMC 2022北米テクノロジーシンポジウムのパートナーパビリオンで展示されました。HBM3コントローラー、PHY、GLink-2.5Dダイ間インターフェース、および112G SerDesを搭載していました。TSMCのCoWoS-S(シリコンインターポーザー)およびCoWoS-R(有機インターポーザー)の両先進プラットフォームがパッケージング技術をサポートしています。
アジア太平洋地域ダイアタッチ装置市場レポートの調査範囲
ダイアタッチは半導体パッケージングにおける重要なプロセスです。様々なアプリケーションにわたるすべてのデバイスをカバーし、組立コストに貢献します。ダイボンディングは半導体のパッケージングに使用される製造プロセスです。これはエポキシまたははんだによってダイ(またはチップ)を基板またはパッケージに取り付ける行為であり、ダイプレースメントまたはダイアタッチとも呼ばれます。
市場はボンディング技術(ダイボンダー(エポキシ/接着剤、共晶、はんだ、焼結)、フリップチップボンダー(ピック・アンド・プレース/リフローはんだ付け、熱圧着、熱超音波ボンディング、ハイブリッドボンディング))、アプリケーション(メモリ、LED、ロジック、CMOSイメージセンサー(CIS)、オプトエレクトロニクス/フォトニクス、ディスクリートパワーデバイス、MEMS&センサー、スタックドメモリ&RF)、および国(台湾、中国、日本、韓国、東南アジア)によってセグメント化されています。
| ダイボンダー | エポキシ/接着剤(ペースト/フィルム) |
| 共晶 | |
| はんだ | |
| 焼結 | |
| フリップチップボンダー | ピック・アンド・プレース / リフローはんだ付け |
| 熱圧着(TCB) | |
| 熱超音波ボンディング | |
| ハイブリッドボンディング |
| メモリ |
| LED |
| ロジック |
| CMOSイメージセンサー |
| オプトエレクトロニクス / フォトニクス |
| ディスクリートパワーデバイス |
| MEMS&センサー |
| スタックドメモリ&RF |
| 台湾 |
| 中国 |
| 日本 |
| 韓国 |
| 東南アジア |
| ボンディング技術別 | ダイボンダー | エポキシ/接着剤(ペースト/フィルム) |
| 共晶 | ||
| はんだ | ||
| 焼結 | ||
| フリップチップボンダー | ピック・アンド・プレース / リフローはんだ付け | |
| 熱圧着(TCB) | ||
| 熱超音波ボンディング | ||
| ハイブリッドボンディング | ||
| アプリケーション | メモリ | |
| LED | ||
| ロジック | ||
| CMOSイメージセンサー | ||
| オプトエレクトロニクス / フォトニクス | ||
| ディスクリートパワーデバイス | ||
| MEMS&センサー | ||
| スタックドメモリ&RF | ||
| 国 | 台湾 | |
| 中国 | ||
| 日本 | ||
| 韓国 | ||
| 東南アジア | ||
レポートで回答される主要な質問
現在のアジア太平洋地域ダイアタッチ装置市場規模は?
アジア太平洋地域ダイアタッチ装置市場は、予測期間(2025年~2030年)中にCAGR 15.3%を記録する見込みです。
アジア太平洋地域ダイアタッチ装置市場の主要プレーヤーは誰ですか?
Palomar Technologies, Inc.、Shinkawa Ltd.、Panasonic Corporation、ASM Pacific Technology Limited、およびBe Semiconductor Industries N.V.がアジア太平洋地域ダイアタッチ装置市場で事業を展開している主要企業です。
このアジア太平洋地域ダイアタッチ装置市場レポートはどの年をカバーしていますか?
本レポートは、アジア太平洋地域ダイアタッチ装置市場の過去市場規模として2019年、2020年、2021年、2022年、2023年、2024年をカバーしています。また、2025年、2026年、2027年、2028年、2029年、2030年のアジア太平洋地域ダイアタッチ装置市場規模の予測も提供しています。
最終更新日:
アジア太平洋地域ダイアタッチ装置業界レポート
Mordor Intelligence™ 業界レポートが作成した、2025年のアジア太平洋地域ダイアタッチ装置市場シェア、規模、および収益成長率の統計。アジア太平洋地域ダイアタッチ装置分析には、2025年から2030年の市場予測見通しおよび過去の概要が含まれています。この業界分析のサンプルを無料レポートPDFダウンロードとして入手してください。



