半導体パッケージング市場規模とシェア

Mordor Intelligenceによる半導体パッケージング市場分析
半導体パッケージング市場規模は2025年に498億8,000万米ドルとなり、2025年〜2030年にかけて年平均成長率10.24%で推移し、2030年には812億2,000万米ドルに達すると予測されている。[1]Cheng Ting-Fang, "TSMC moves closer to next-gen packaging for Nvidia, Google AI chips," Nikkei Asia, asia.nikkei.comコスト重視の組み立てから性能重視の統合への移行がこの成長を支えている。AIワークロードが高帯域幅メモリと優れた熱経路を求めるため、2.5Dおよび3Dアーキテクチャの需要が急激に増加している。従来のワイヤーボンドやリードフレーム形式で数量は維持されているものの、価値創出はファンアウトウエハーレベルパッケージング(WLP)やチップレット対応インターポーザーに移行している。自動車の電動化により、電力密度の高いモジュールにおいて2桁の拡大が支えられ、スマートフォンとPCのリフレッシュサイクルが民生用セグメントにおけるベースライン数量を維持している。地域的には、アジアが世界生産の半分以上を占めているが、新しいバックエンドファブに資金を提供するCHIPS法インセンティブにより、北米が最も高いCAGRを記録している。[2]U.S. Department of Commerce, "CHIPS for America Announces up to $300 million in Funding to Boost U.S. Semiconductor Packaging," commerce.govABF基板の供給ボトルネックと先端ツールの輸出規制により、地理的多様化と材料革新が促進されている。
主要レポートポイント
- パッケージングプラットフォーム別では、従来形式が2024年の半導体パッケージング市場シェアの52.5%を占めたが、ファンアウトWLPは2030年まで年平均成長率12.3%で拡大すると予測される。
- エンドユーザー業界別では、民生用電子機器が2024年の半導体パッケージング市場規模の収益シェア43.8%でトップを占め、自動車が2030年まで年平均成長率10.3%で最も速い成長を示している。
- ウエハーサイズ別:300mmが効率を推進し、2024年の半導体パッケージング市場シェアの74.0%を獲得。一方、パネル形式が登場し、450mm以上の基板でのパネルレベル処理が2030年まで年平均成長率12.5%で最も急成長セグメントとなっている
- ビジネスモデル別では、OSATセグメントが2024年の世界半導体パッケージング市場シェアの62.0%を支配する一方、ファウンドリバックエンドサービスは年平均成長率10.9%で上昇している。
- パッケージング材料別では、有機ABF基板が2024年に収益の41.5%を占め、主流フリップチップエコシステムを支えている
- 地域別では、アジアが2024年の半導体パッケージング市場の53.0%を占め、北米は2030年まで年平均成長率11.1%が見込まれている。
- ASE、AmkorおよびJCETが合わせて2024年の先進技術収益の30%超のシェアを占め、ハイブリッドボンディングやSiP生産における規模の優位性を反映している
世界半導体パッケージング市場のトレンドと洞察
推進要因影響分析
| 推進要因 | CAGR予測への影響(~%) | 地理的関連性 | 影響タイムライン |
|---|---|---|---|
| AI加速器ブームによる2.5D/3Dインターポーザーの牽引 | +2.8% | 世界(台湾、米国、中国) | 中期(2〜4年) |
| 電動車両パワーパッケージ | +1.9% | 北米・APAC | 長期(≥4年) |
| 米国・EU CHIPS インセンティブによる現地バックエンドファブ創設 | +1.4% | 北米・EU | 長期(≥4年) |
| 中国・韓国における5G RF-SiP需要 | +1.2% | APAC中核 | 短期(≤2年) |
| 低コストIoT向けパネルレベルパッケージング | +0.9% | 世界(APACハブ) | 中期(2〜4年) |
| 高密度インターポーザーを支えるチップレットアーキテクチャ | +1.6% | 世界(米国設計、台湾製造) | 中期(2〜4年) |
| 情報源: Mordor Intelligence | |||
AI加速器ブームによる2.5D/3Dインターポーザーの牽引
TSMCのCoWoS能力は2023年から2024年にかけて12万個から24万個に倍増しているが、それでもハイパースケーラーの需要を完全に満たすことはできない。能力ギャップが代替パネルレベルフローと、パッケージあたり6,000mm²を超えるシリコンを集約する3.5Dスタッキング試験を促進している。[3]James Morra, "Broadcom Bets on 3.5D Packaging Technology to Build Bigger AI Chips," Electronic Design, electronicdesign.comしたがって、先進パッケージングはコストセンターからAIシステム性能の戦略的レバーへと移行した
米国・アジアにおける電動車両パワーパッケージ
VolkswagenによりonsemiのEliteSiCプラットフォームが採用されたことは、優れた放熱性を持つ統合パワーモジュールへの移行を例示している。ROHMの6-in-1モールドSiCモジュールは、従来品の3倍の電力密度を実現している。これらの革新は、厳しい自動車認証を満たすことができる米国とアジアのサプライチェーンに集中している。
米国・EU CHIPS インセンティブによる現地バックエンドファブ創設
CHIPS法は先進パッケージングR&Dに専用で3億米ドルを割り当て、ジョージア州、カリフォルニア州、アリゾナ州のテストラインを補助している。IntelのニューメキシコにおけるFoverosサイトは35億米ドルを投じ、国内3D統合能力の拠点となっている。EUでも同様の資金により、自動車・防衛電子機器をアジア供給混乱から切り離すことを目指している。
中国・韓国における5G RF-SiP需要
JCETのパワーアンプ用ヘテロジーニアスRF-SiPは、従来ノードと比較して統合密度を1.5倍向上させている。プレミアムハンドセットが革新を維持する一方、大衆向けAndroid需要の軟化により単位成長が抑制され、サプライヤーはコスト構造の最適化を迫られている
制約要因影響分析
| 制約要因 | CAGR予測への影響(~%) | 地理的関連性 | 影響タイムライン |
|---|---|---|---|
| ABF基板供給逼迫 | -1.8% | 世界(APAC深刻) | 短期(≤2年) |
| 3D TSV/ハイブリッドボンディングの歩留まり課題 | -1.3% | 世界(台湾、韓国、米国) | 中期(2〜4年) |
| 中国への先進パッケージングツール輸出規制 | -0.9% | 中国中心 | 長期(≥4年) |
| <5nmにおけるファンアウトWLPの熱放散限界 | -0.7% | 世界先進ノード | 中期(2〜4年) |
| 情報源: Mordor Intelligence | |||
ABF基板供給逼迫
Nittoboの2025年8月の価格20%引き上げは、特にフリップチップBGAラインに影響を与える構造的材料逼迫を露呈している。台湾・日本の限定的な認定能力により納期が長期化し、OEMはガラスコアやシリコンコア代替品の検討を迫られている。
3D TSV/ハイブリッドボンディングの歩留まり課題
0.5nm未満の銅対銅ハイブリッドボンディング公差と10:1を超えるTSVアスペクト比により、積層全体での欠陥リスクが増大している。NVIDIAのBlackwellプログラムは、CoWoS-L熱機械ストレスに関連した歩留まり問題が報告されている。
セグメント分析
パッケージングプラットフォーム別:先進技術が価値移転を推進
従来のワイヤーボンドとリードフレーム製品は2024年の半導体パッケージング市場シェア52.5%で出荷量を依然として支配し、民生用電子機器と産業機器が手頃な部品表コストを維持することを確保している。しかし、ファンアウトWLPは年平均成長率12.3%で他のすべての形式を上回り、Z高さを縮小しI/O密度を向上させる基板フリー再分配層に向けた半導体パッケージング市場の動きを示している。フリップチップは、微細ピッチバンプと適度なコストを組み合わせることでギャップを埋め、SiPとPoP アーキテクチャは空間制約のあるハンドセット向けの垂直スタッキングを可能にしている。
先進分野では、2.5Dインターポーザーが高帯域幅メモリをAIロジックに隣接配置し、3Dスタックがレイテンシ向上を実現している。埋め込みダイとパネルレベルフローは、IoT価格帯に焦点を当てた新規参入者を引きつけ、半導体パッケージング市場がプレミアム性能ノードと超低コスト大量プレイに分かれていることを実証している。対照的に、パネルレベルラインはピンあたり0.10米ドル未満を実現し、この比率は異なるコスト構造を強調している。その結果、装置メーカーは自社ポートフォリオをセグメント化している:3μmアライメント用の高精度ボンダークラスターが、IoTタグを対象とした大型パネルMOLDラインと共存している。このような二極化により、半導体パッケージング市場における サプライヤーのポジショニングが再定義されている。

注記: 全個別セグメントのシェアはレポート購入時に利用可能
パッケージング材料別:革新圧力のもとで有機基板が支配
有機ABF基板は2024年に収益の41.5%を占め、主流フリップチップエコシステムを支えている。しかし、自動車・産業セクターが実績のあるアルミニウム・金ワイヤーパッケージの寿命を延長するため、ボンディングワイヤーの半導体パッケージング市場規模は年率11.4%の成長が見込まれている。リードフレームは、銅ヒートスプレッダー性能を重視するパワーアプリケーションで持続している。封止樹脂は高熱伝導率グレードに進歩し、次世代SiCおよびGaNモジュールを支援している。
ガラス基板は2027年以降に有機ビルドを置き換える可能性がある。IntelとSamsungのプロトタイプは、ビアピッチ40%削減とほぼゼロのCTE不整合を示し、3Dスタックにおける反りを低減している。熱界面材料は現在、ナノダイヤモンドフィラーを統合し、1,200Vトラクションインバーターにおいて接合部からケースまでの抵抗を30%削減している。2025年の金価格急騰により、ディスプレイドライバーICパッケージングのマージンが圧縮され、銅カラムバンプへの移行が促進されている
ウエハーサイズ別:300mmが効率を推進、パネル形式が登場
300mmウエハー形式は2024年の半導体パッケージング市場シェアの74.0%を獲得し、処理効率とフロントエンドツール互換性のバランスを取る先進バックエンドフローの優先選択としての地位を確認した。200mm以下の小型ウエハーは、変換コストが生産性向上を上回るレガシーアナログ、センサー、パワーラインでは依然として viable である。大型フォーマットは、スマートフォン、PC、産業IoTノードにおいてデバイス数が増加するにつれ、ますます重要になる規模の経済を可能にする。
450mm以上の基板でのパネルレベル処理は、2030年まで年平均成長率12.5%で最も急成長セグメントを代表し、単位あたり材料消費とサイクル時間を低減することで半導体パッケージング市場規模を拡大する態勢にある。反り制御、インライン歩留まり計測、装置標準化が主要なハードルであり、ツールメーカーと大量パッケージングハウス間の共同開発努力を必要としている。
ビジネスモデル別:OSATリーダーシップがファウンドリの挑戦に直面
OSATは幅広い顧客名簿と世界的足跡により、2024年の半導体パッケージング市場シェア62.0%を維持した。しかし、年平均成長率10.9%でのファウンドリバックエンド拡大は垂直統合を示している。TSMCのWafer Manufacturing 2.0は、リソグラフィ、テスト、CoWoSを一つの見積もりの下で融合し、OSATの境界を曖昧にしている。
これに対し、ASEは戦略的設備投資とシステムOEMとの共同設計により、2025年に先進パッケージング収益16億米ドルを目標としている reuters.com。Chipletzなどのスタートアップは、カスタムインターポーザー設計がAI推論カードと連携するサービス可能アクセス可能市場に焦点を当て、ニッチ浸透戦略を例示している。

注記: 全個別セグメントのシェアはレポート購入時に利用可能
エンドユーザー業界別:民生用電子機器がリード、自動車が加速
スマートフォン、タブレット、PCは、OEMがフォームファクターを刷新し、デバイス上生成AIキャパビリティを導入するため、2024年に半導体パッケージング市場の43.8%シェアを確保した。それにもかかわらず、自動車分野は、EVインバーターおよびADASドメインコントローラーコンテンツ成長を背景に、年平均成長率10.3%で最も高いCAGRを記録している。
自動車グレードパワーモジュールは、モバイルSoCの5倍のASPを達成し、単位ボリューム対比で半導体パッケージング市場規模を不釣り合いに拡大している。通信インフラはRF-SiP需要に貢献し、データセンターHPCは最先端アーキテクチャを主導し、AIアルゴリズムロードマップと物理統合選択の間のループを閉じている。
地域分析
アジアは2024年の半導体パッケージング市場の53.0%を獲得し、台湾のCoWoS独占と中国のワイヤーボンド組み立ての規模により確固たる地位を築いている。JCETの江蘇省における44億人民元の自動車工場は、SiCパワーパッケージにおける現地能力を向上させている。韓国はメモリ中心SiPの恩恵を受け、日本は重要な基板化学を制御し、緊密に結合した地域クラスターを強化している。
北米の半導体パッケージング市場は2030年まで年平均成長率11.1%を記録すると予測されている。CHIPS法インセンティブがR&Dライン向けに3億米ドルを集約し、アリゾナ州、ニューメキシコ州、カリフォルニア州にハブを生み出している。アリゾナ州のTSMC-Amkorなどのパートナーシップは、最先端ウエハーファブに近接した完全なバックエンドエコシステムを構築している。カナダはフォトニクスパッケージングを培い、メキシコは民生用ASICの低コスト最終テストを提供している。
ヨーロッパは自動車・産業力を中心にポジショニングしている。ドイツTier-1は9kW/Lインバーター密度を目標とする両面冷却SiCモジュールを共同開発し、ニッチOSAT投資を触媒している。オランダは垂直共振器面発光レーザー(VCSEL)採用に連携する高周波光トランシーバーパッケージングを推進している。中東・アフリカは新興地域のままで、主にアジアハブに組み立てを外注しているが、主権命令の下でセキュアIoTおよび防衛電子機器向け国内ラインを計画している。

競争環境
競争激化は価格から技術にピボットしている。TSMCはファウンドリのノウハウを活用して2.5Dインターポーザーを支配し、SamsungはH-cubeを用いてモバイルAI向けメモリとロジックを融合している。ASEとAmkorは40以上の施設にリスクを分散し、歩留まり学習と製造設計性サービスに焦点を当てている。JCETは自動車AEC-Q100フローを実行するSiPラインを拡張している。IntelのFoverosプラントは、クライアントおよびデータセンタープラットフォーム向けに50μmダイ間ピッチを提供し、パッケージングリーダーシップを奪還する戦略的飛躍を具現化している。
参入障壁には、設備投資の集約性、基板供給セキュリティ、顧客共同開発ロックインが含まれる。したがって、EmpyreanによるXpeedicの買収など、M&Aを通じた統合は、EDAとパッケージングIPを一つの傘下に集約する試みを反映している
半導体パッケージング業界リーダー
-
ASE Technology Holding Co., Ltd.
-
Amkor Technology, Inc.
-
JCET Group Co., Ltd.
-
Siliconware Precision Industries Co., Ltd.
-
Powertech Technology Inc.
- *免責事項:主要選手の並び順不同
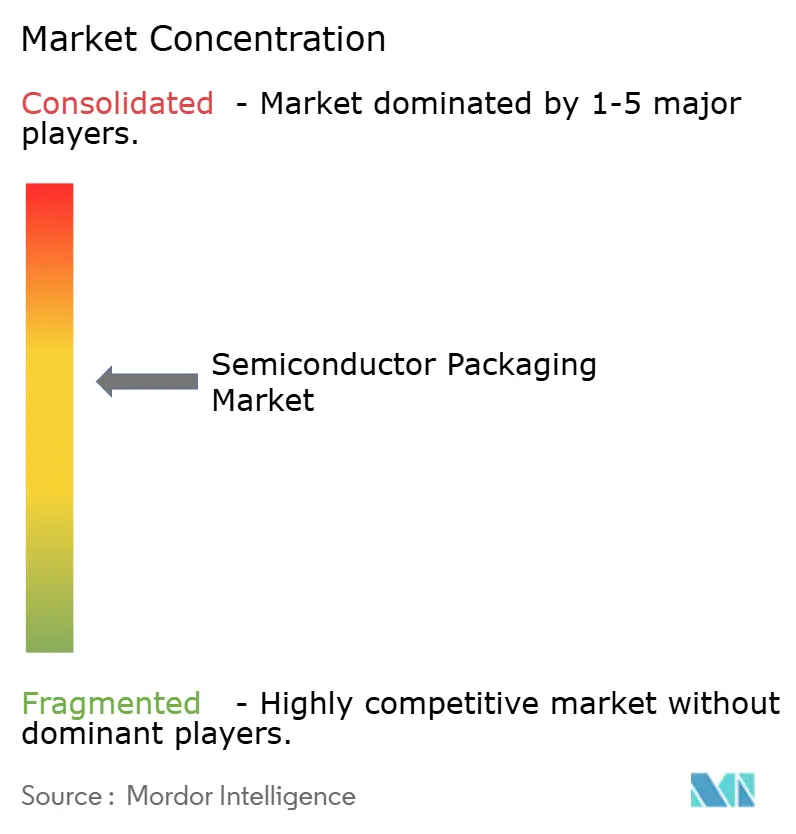
業界最新動向
- 2025年6月:ASEとAMDが、AIワークロード向けInstinct MI300 GPUを評価し、データセンター効率を50%向上させ、電力を6.5%削減するパートナーシップ締結
- 2025年6月:InfineonがトレンチベースSiC スーパージャンクションMOSFETを発表、ID-PAKパッケージで1,200V初回デバイスのトラクションインバーター向け
- 2025年5月:ROHMが電力密度を3倍向上、基板面積を52%縮小する4-in-1および6-in-1 SiCモールドモジュールをリリース
- 2025年4月:ASEが24.9%データセンター帯域幅CAGR予測の中、リンクエネルギーを<5pJ/bitに削減するCo-Packaged Opticsを実証
世界半導体パッケージング市場レポートスコープ
半導体パッケージングとは、プラスチック、セラミック、金属、またはガラス製筐体で作られた1つ以上の個別半導体デバイスまたは集積回路を含む筐体を指している。パッケージングは、電子システムを無線周波数ノイズ放射、静電放電、機械的損傷、冷却から保護している。世界的な半導体産業の台頭は、半導体パッケージング市場成長を牽引する主要要因の一つである。業界の様々なエンドユーザー分野における需要拡大により、統合、エネルギー効率、製品特性における継続的進歩、および電子システムの性能、信頼性、費用対効果の改善におけるパッケージングの使用が、市場成長を加速させている。
このレポートは、世界の半導体パッケージングの売上を追跡し、世界先進パッケージングおよび従来パッケージング市場の市場収益を評価している。レポートでは、フリップチップ、ファンイン、埋め込みダイ、3Dスタッキング、ファンアウトパッケージングを含む様々な先進パッケージングプラットフォームが考慮され、これらは民生用電子機器、医療機器、通信・電気通信、自動車などの複数のエンドユーザーアプリケーションで使用されている。競争環境は、パッケージング浸透を計算し、企業が有機・無機成長戦略にどのように関与しているかを評価するために採用されている。これらの企業は、市場シェアと収益性を向上させるため製品を革新している。さらに、レポートは市場におけるマクロ経済要因の分析に焦点を当てている。
半導体パッケージング市場は、パッケージングプラットフォーム(先進パッケージング[フリップチップ、SIP、2.5D/3D、埋め込みダイ、ファンインウエハーレベルパッケージング(FI-WLP)、ファンアウトウエハーレベルパッケージング(FO-WLP)]および従来パッケージング)、エンドユーザー業界(民生用電子機器、航空宇宙・防衛、医療機器、通信・電気通信、自動車、エネルギー・照明)、地域(米国、中国、台湾、韓国、日本、ヨーロッパ)別にセグメント化されている。レポートは、これらすべてのセグメントについて価値(米ドル)での市場規模と予測を提供している。
| 先進パッケージング | フリップチップ |
| ファンアウトWLP | |
| ファンインWLP | |
| 2.5D / 3D IC | |
| 埋め込みダイ | |
| SiP / PoP | |
| パネルレベルパッケージング | |
| 従来パッケージング | ワイヤーボンド |
| リードフレーム | |
| QFN / QFP / SOP |
| 有機基板 |
| リードフレーム |
| ボンディングワイヤー |
| 封止樹脂 |
| セラミックパッケージ |
| ソルダーボールとバンプ |
| ダイアタッチとTIM |
| ≤ 200 mm |
| 300 mm |
| ≥ 450 mm / パネル |
| OSAT |
| ファウンドリバックエンド |
| IDMインハウス |
| 民生用電子機器 | スマートフォンとウェアラブル | |
| コンピューティング/データセンター | ||
| 自動車・モビリティ | ADAS / EVパワー | |
| 通信・電気通信 | 5Gインフラ | |
| 航空宇宙・防衛 | ||
| 医療・ヘルスケアデバイス | ||
| 産業・エネルギー(LED/パワー) | ||
| 北米 | 米国 |
| カナダ | |
| メキシコ | |
| 南米 | ブラジル |
| 南米その他 | |
| ヨーロッパ | ドイツ |
| フランス | |
| 英国 | |
| イタリア | |
| オランダ | |
| 北欧 | |
| ヨーロッパその他 | |
| 中東・アフリカ | イスラエル |
| トルコ | |
| GCC | |
| 南アフリカ | |
| 中東・アフリカその他 | |
| APAC | 中国 |
| 台湾 | |
| 韓国 | |
| 日本 | |
| インド | |
| シンガポール | |
| オーストラリア | |
| ニュージーランド | |
| APACその他 |
| パッケージングプラットフォーム別 | 先進パッケージング | フリップチップ | |
| ファンアウトWLP | |||
| ファンインWLP | |||
| 2.5D / 3D IC | |||
| 埋め込みダイ | |||
| SiP / PoP | |||
| パネルレベルパッケージング | |||
| 従来パッケージング | ワイヤーボンド | ||
| リードフレーム | |||
| QFN / QFP / SOP | |||
| パッケージング材料別 | 有機基板 | ||
| リードフレーム | |||
| ボンディングワイヤー | |||
| 封止樹脂 | |||
| セラミックパッケージ | |||
| ソルダーボールとバンプ | |||
| ダイアタッチとTIM | |||
| ウエハーサイズ別 | ≤ 200 mm | ||
| 300 mm | |||
| ≥ 450 mm / パネル | |||
| ビジネスモデル別 | OSAT | ||
| ファウンドリバックエンド | |||
| IDMインハウス | |||
| エンドユーザー業界別 | 民生用電子機器 | スマートフォンとウェアラブル | |
| コンピューティング/データセンター | |||
| 自動車・モビリティ | ADAS / EVパワー | ||
| 通信・電気通信 | 5Gインフラ | ||
| 航空宇宙・防衛 | |||
| 医療・ヘルスケアデバイス | |||
| 産業・エネルギー(LED/パワー) | |||
| 地域別 | 北米 | 米国 | |
| カナダ | |||
| メキシコ | |||
| 南米 | ブラジル | ||
| 南米その他 | |||
| ヨーロッパ | ドイツ | ||
| フランス | |||
| 英国 | |||
| イタリア | |||
| オランダ | |||
| 北欧 | |||
| ヨーロッパその他 | |||
| 中東・アフリカ | イスラエル | ||
| トルコ | |||
| GCC | |||
| 南アフリカ | |||
| 中東・アフリカその他 | |||
| APAC | 中国 | ||
| 台湾 | |||
| 韓国 | |||
| 日本 | |||
| インド | |||
| シンガポール | |||
| オーストラリア | |||
| ニュージーランド | |||
| APACその他 | |||
レポートで回答される主要質問
半導体パッケージング市場の現在価値は何ですか?
半導体パッケージング市場は2025年に498億8,000万米ドルの価値で、2030年には812億2,000万米ドルに達すると予測されています。
最も急成長しているパッケージング技術は何ですか?
ファンアウトウエハーレベルパッケージングは最も急成長のプラットフォームで、2030年まで年平均成長率12.3%で進展しています。
ABF基板がボトルネックとなるのはなぜですか?
ABF基板は主に台湾と日本で生産されており、供給不足により20%の価格上昇が生じ、フリップチップ能力拡張が制限されています。
CHIPS法はパッケージングにどのような影響を与えますか?
CHIPS法は国内先進パッケージングR&Dに3億米ドルを配分し、アリゾナ州、カリフォルニア州、ニューメキシコ州における新ファブを促進し、北米のCAGRを11.1%に押し上げています。
最も高い成長を見込むエンドユースセクターはどれですか?
自動車アプリケーションが年平均成長率10.3%で最も高い成長を記録し、電気自動車パワーエレクトロニクスとADAS需要により牽引されています。
チップレットアーキテクチャはパッケージング設計にどのような影響を与えていますか?
UCIe 2.0のようなオープンスタンダードがヘテロジーニアスチップレットを可能にし、より高い帯域幅とより低いレイテンシのため、パッケージングを高密度インターポーザーとハイブリッドボンディングに押し進めています。
最終更新日:

