Taille et part du marché des substrats IC avancés

Analyse du marché des substrats IC avancés par Mordor Intelligence
La taille du marché des substrats IC avancés s'élevait à 10,66 milliards USD en 2025 et devrait grimper à 14,98 milliards USD d'ici 2030, se traduisant par un TCAC de 7,05%. La demande s'est résolument déplacée de l'informatique traditionnelle vers les charges de travail centrées sur l'IA qui nécessitent des nombres de couches plus élevés, des largeurs de ligne plus fines et un contrôle de déformation plus serré. Les fournisseurs de substrats basés en Asie-Pacifique ont bénéficié de ce pivot car ils possédaient déjà une capacité ABF à haut volume et des relations étroites avec les lignes d'emballage de fonderie. Les principaux fournisseurs de services cloud ont accéléré les accords d'achat à long terme en 2025 pour sécuriser un approvisionnement garanti en CoWoS et FC-BGA, inclinant davantage le pouvoir de fixation des prix vers les producteurs de substrats. Dans le même temps, l'innovation des noyaux en verre a mûri, créant une alternative stratégique à l'ABF pour les packages ultra-haute densité prévus pour une sortie commerciale dans la seconde moitié de la décennie.
Points clés du rapport
Par type de substrat, FC-BGA dominait avec 45% de part du marché des substrats IC avancés en 2024, tandis que les CSP rigides-flexibles ont affiché le TCAC le plus rapide de 8,1% jusqu'en 2030.
Par matériau de noyau, l'ABF représentait 61% de part de la taille du marché des substrats IC avancés en 2024 ; les substrats en verre devraient se développer à un TCAC de 14,1% jusqu'en 2030.
Par technologie d'emballage, le flip-chip 2D a conservé 38% de part de revenus en 2024, tandis que 3D-IC/SoIC progresse à un TCAC de 9,5% sur la période de prévision.
Par nœud de dispositif, les packages supportant des nœuds ≥28 nm ont capturé 47% de part en 2024 ; les substrats conçus pour 4 nm et en dessous devraient croître à un TCAC de 12,3% jusqu'en 2030.
Par industrie d'utilisation finale, l'électronique mobile et grand public détenait 43,5% de la taille du marché des substrats IC avancés en 2024, mais les applications de centres de données/IA & HPC se développent à un TCAC de 8,4% jusqu'en 2030.
Par géographie, l'Asie-Pacifique commandait une part de revenus de 69% en 2024 et devrait continuer comme la région à croissance la plus rapide à un TCAC de 10,8% jusqu'en 2030.
Tendances et insights du marché mondial des substrats IC avancés
Analyse d'impact des moteurs
| Moteur | (~) % Impact sur les prévisions TCAC | Pertinence géographique | Calendrier d'impact |
|---|---|---|---|
| Poussée de la demande de substrats ABF pour les accélérateurs IA/HPC | +1.8% | Mondial, concentré en Asie-Pacifique | Moyen terme (2-4 ans) |
| Miniaturisation et tendance d'intégration hétérogène | +1.2% | Mondial, mené par l'Amérique du Nord & Asie-Pacifique | Long terme (≥ 4 ans) |
| Déploiement 5G stimulant l'emballage RF haute fréquence | +0.9% | Mondial, adoption précoce en Asie-Pacifique & Amérique du Nord | Moyen terme (2-4 ans) |
| L'électrification automobile-VE nécessite des substrats haute fiabilité | +0.7% | Mondial, plus fort en Europe & Chine | Long terme (≥ 4 ans) |
| Les substrats à noyau de verre débloquent >2× nombre de couches | +0.6% | Noyau Asie-Pacifique, expansion vers l'Amérique du Nord | Long terme (≥ 4 ans) |
| Subventions de type CHIPS liées aux fabs de substrats | +0.5% | Amérique du Nord, Europe, Asie-Pacifique sélectionnée | Moyen terme (2-4 ans) |
| Source: Mordor Intelligence | |||
Poussée de la demande de substrats ABF pour les accélérateurs IA/HPC
Les déploiements massifs de serveurs d'IA générative en 2025 ont resserré les approvisionnements en film de construction Ajinomoto, poussant les délais de livraison des panneaux ABF au-delà de 35 semaines et déclenchant des primes de prix au comptant jusqu'à 25% au-dessus des niveaux de contrat 2024.[1]Diamond Editorial Team, "Ajinomoto's 'Secret Ingredient' Is Now Vital to Chipmaking Giants," Diamond, diamond.jp Les fournisseurs taïwanais Unimicron, Kinsus et Nan Ya PCB ont retrouvé une croissance de revenus à deux chiffres après avoir conclu une correction d'inventaire prolongée, mais fonctionnaient encore à 90% d'utilisation pour suivre le rythme de la demande. Samsung Electro-Mechanics a augmenté le volume ABF orienté IA au T2 2025 et a commencé des essais pilotes de noyaux en verre, reflétant une stratégie de double approvisionnement visant à atténuer le risque de matériau unique. TSMC a divulgué des plans pour doubler la production annuelle CoWoS, impliquant une demande de substrats bien au-dessus de la capacité existante. Collectivement, ces mouvements ont élargi un écart d'approvisionnement de 20% que les fabricants de substrats ne s'attendent pas à combler jusqu'à ce que de nouvelles lignes entrent en ligne en 2026.
Tendance de miniaturisation et d'intégration hétérogène
Les architectures de chiplets, les interposeurs sans noyau et les vias traversant le silicium ont redéfini les règles de conception de packages et poussé les largeurs de ligne de substrats en dessous de 10 µm dans les environnements de production. Applied Materials a souligné que l'intégration sur package de chiplets discrets offrait des performances supérieures par watt par rapport aux approches de puces monolithiques. TOPPAN a dévoilé un interposeur organique sans noyau avec un coefficient d'expansion thermique 45% plus faible que les solutions ABF héritées, soulageant le stress mécanique à l'intérieur des empilements multi-puces. La technologie 3.5D XDSiP de Broadcom a intégré plus de 6 000 mm² de silicium et 12 piles HBM, soulignant la demande pour des substrats qui peuvent router des milliers de signaux haute vitesse dans des empreintes confinées. TSMC et ASE ont investi dans des lignes d'emballage au niveau panel jusqu'à 310 × 310 mm pour gagner en efficacité de steppeur et réduire le coût par pouce carré. Ces changements positionnent le marché des substrats IC avancés comme un facilitateur pivot pour la densité de calcul de prochaine génération.
Déploiement 5G stimulant l'emballage RF haute fréquence
Les radios à ondes millimétriques nécessitaient des stratifiés avec de faibles constantes diélectriques et des tangentes de perte minimales, orientant les concepteurs vers des piles de substrats spécialisées qui diffèrent des panneaux de serveurs IA. Le stratifié CLTE-MW de Rogers Corporation supportait les réseaux d'antennes au-delà de 30 GHz, tandis que les amplificateurs de puissance avancés en nitrure de gallium de Qorvo exigeaient des substrats avec une conductivité thermique supérieure. CML Microcircuits a lancé un amplificateur de puissance 26,5-29,5 GHz qui s'appuyait sur des noyaux organiques ultra-plats pour maintenir le contrôle d'impédance. Les diélectriques reformulés de PolyOne ont raccourci les cycles de conception pour les fabricants de stations de base migrant vers des réseaux à montage en surface. Alors que les opérateurs ont terminé les déploiements sub-6 GHz et sont passés à la densification mmWave, les substrats RF multicouches ont représenté un flux de revenus supplémentaire pour les fabricants expédiant déjà des panneaux ABF pour les ASIC de centres de données.
L'électrification automobile-VE nécessite des substrats haute fiabilité
L'électrification des véhicules a contraint les OEM à spécifier des piles de substrats haute température, haute tension qui maintenaient la fiabilité à travers des cycles thermiques rapides. Les modules de puissance en carbure de silicium, autrefois limités aux voitures de sport de niche, sont entrés en production de masse pour les groupes motopropulseurs de 800 V, exigeant des solutions à noyau céramique ou métallique qui dissipaient plus de chaleur que les cartes ABF organiques. ROHM a introduit des modules moulés SiC 4-en-1 et 6-en-1 avec des substrats isolants qui ont réduit la température du dispositif de 38 °C par rapport aux assemblages discrets. Les substrats céramiques curamik de Rogers Corporation offraient un faible appariement d'expansion thermique et une isolation diélectrique élevée adaptée aux chargeurs embarqués et onduleurs de traction. Les investissements tels que l'installation SiC de 2 milliards USD d'OnSemi en République tchèque pointaient vers la sécurisation d'un approvisionnement local de substrats de dispositifs de puissance pour les plateformes VE européennes. Ces spécifications se traduisent par de nouveaux bassins de revenus en dehors du courant principal des dispositifs IA et mobiles.
Analyse d'impact des contraintes
| Contrainte | (~) % Impact sur les prévisions TCAC | Pertinence géographique | Calendrier d'impact |
|---|---|---|---|
| Pénurie de capacité de substrats ABF et pics de délais | -1.4% | Mondial, plus sévère en Asie-Pacifique | Court terme (≤ 2 ans) |
| Intensité capitalistique élevée et complexité de processus | -0.9% | Mondial, les barrières sont les plus élevées dans les marchés émergents | Long terme (≥ 4 ans) |
| Volatilité des prix des stratifiés plaqués cuivre | -0.6% | Chaîne d'approvisionnement mondiale concentrée en Asie | Moyen terme (2-4 ans) |
| Règles d'émission chimique plus strictes pour les films de construction | -0.4% | Amérique du Nord & Europe, expansion mondiale | Moyen terme (2-4 ans) |
| Source: Mordor Intelligence | |||
Pénurie de capacité de substrats ABF et pics de délais
Un déficit persistant dans la production de panneaux ABF a restreint la hausse pour le marché des substrats IC avancés pendant 2024-2025. Ajinomoto, le fournisseur quasi-monopole de résine ABF, a reconnu un écart demande-offre de 20% qui resterait jusqu'à ce que de nouveaux réacteurs de résine commencent en 2026.[2]Industry Tap Analysts, "How the Product of a Food Company Threatens to Extend Chip Shortages to 2026," Industry Tap, industrytap.com Les fonderies ont confirmé la contrainte quand TSMC a dit qu'elle ne pouvait satisfaire que 80% de la demande CoWoS. Les concurrents tels que Sekisui Chemical visaient à briser la dépendance aux chimies de construction alternatives, mais les cycles de qualification pour les packages IA haut de gamme ont ralenti l'adoption. Les pénuries parallèles de matériau de noyau T-Glass, prisé pour ses faibles coefficients d'expansion, ont retardé les expansions de capacité chez Nittobo, aggravant les pics de délais. Les fabricants de substrats ont déployé la métrologie en ligne pour augmenter le rendement de premier passage et étirer la capacité existante, mais la plupart des clients sont encore entrés dans des programmes d'allocation jusqu'en 2025.
Intensité capitalistique élevée et complexité de processus
Les fabs de substrats greenfield nécessitaient des dépenses de plusieurs milliards de dollars plus une conformité stricte avec les normes environnementales émergentes. L'évaluation environnementale du CHIPS Act a documenté des contrôles étendus de qualité de l'air et de matériaux dangereux pour les usines d'emballage américaines. Samsung Electro-Mechanics a dépensé 1,3 milliard USD pour moderniser son campus FCBGA pour gagner l'allocation de substrats IA des clients GPU. Les processus de noyaux en verre nécessitaient des outils laser via-traversant-verre dédiés dont les courbes d'apprentissage ajoutaient un risque technique ; Philoptics a embauché un ancien leadership Samsung pour accélérer la qualification des outils. La décision d'Intel d'externaliser les substrats en verre plutôt que d'internaliser le flux a mis en évidence le coût de rester trop en avance sur la demande prouvée. Le resserrement des règles d'émission américaines pour les films de construction a ajouté des coûts de conformité récurrents qui pesaient sur les TRI de projet.
Analyse des segments
Par type de substrat : la dominance FC-BGA fait face à la disruption de l'emballage flexible
Les substrats FC-BGA représentaient 45% de la part du marché des substrats IC avancés en 2024. Leur avance provient des performances électriques éprouvées requises par les accélérateurs IA et les CPU de serveurs. L'utilisation est restée élevée jusqu'en 2025 alors que les fabricants de GPU se précipitaient pour sécuriser la capacité. La croissance, cependant, s'est déplacée vers les lignes CSP rigides-flexibles qui servaient les contrôleurs de domaine automobile et les dispositifs mobiles pliables. Le volume rigide-flexible a augmenté à un TCAC de 8,1%, attirant de nouveaux fournisseurs de stratifiés capables d'équilibrer le rayon de courbure avec l'impédance contrôlée. FC-CSP a continué à servir les processeurs mobiles de niveau intermédiaire, mais ses pressions de coût ont limité la hausse des prix de vente moyens. Les BGA/LGA organiques sont restés pertinents pour les plateformes de bureau héritées, mais ont cédé les victoires de conception aux options flip-chip. Les substrats FC au niveau panel, encore comptés sous ' Autres ', ont émergé en volumes pilotes chez TSMC et ASE, promettant 7× la zone utilisable par panel et ouvrant de nouvelles économies d'échelle.
FC-BGA est resté le cheval de bataille pour les constructions CoWoS. Les concepteurs exigeaient 14-26 nombres de couches, forçant des tolérances d'enregistrement plus serrées. En réponse, les fabricants de substrats ont installé une inspection optique alimentée par IA pour attraper les violations via-à-trace tôt dans la pile. Les CSP rigides-flexibles ont bénéficié quand les constructeurs automobiles ont migré les unités d'infodivertissement vers des écrans courbes de 15 pouces qui nécessitaient une flexibilité axe Z. L'intégration accrue de caméras dans les pliables a présenté une traction supplémentaire. Ces dynamiques soutiennent une pénétration soutenue pour le rigide-flexible jusqu'en 2030 tandis que FC-BGA continue d'ancrer des positions de haute valeur dans le marché des substrats IC avancés.

Note: Parts de segments de tous les segments individuels disponibles à l'achat du rapport
Par matériau de noyau : l'hégémonie ABF défiée par l'innovation du verre
L'ABF représentait 61% de la taille du marché des substrats IC avancés en 2024. La recette de résine exclusive d'Ajinomoto a établi des performances diélectriques et une forabilité cohérentes que les clients faisaient confiance pour les piles 2.5D et 3D. Les fournisseurs ont élargi les salles de mélange ABF en 2025, mais les gains de production ont traîné la croissance de la demande, renforçant l'effet de levier du vendeur. Les substrats en verre, bien que moins de 2% des expéditions 2024, ont enregistré un TCAC prévu de 14,1%. La planéité dans ±5 µm sur des plaques de 200 mm x 200 mm permettait des couches de redistribution plus fines et une densité I/O plus élevée que l'ABF. La sortie d'Intel du développement interne a validé les fournisseurs de verre tiers et accéléré la préparation de l'écosystème.
La résine BT a préservé sa pertinence dans les unités de contrôle automobile où les températures de carte de 150 °C étaient courantes. Les segments céramiques et LTCC ont fourni des dispositifs de puissance exposés au cyclage thermique continu et offert des tampons de revenus supplémentaires lorsque les lignes ABF étaient survendues. La qualification des noyaux en verre a fait face à des obstacles dans l'uniformité de formation des vias, mais les premières constructions ont livré des métriques de déformation prometteuses au reflux. AMD a signalé son intention de basculer ses plateformes CPU 2026 vers le verre, encourageant les fabricants de substrats à verrouiller les créneaux de capacité bien avant les rampes de volume. Si les rendements tiennent, le verre pourrait égaler ou dépasser 5% de part de revenus d'ici 2030.
Par technologie d'emballage : la maturité 2D cède à l'intégration 3D
Les packages flip-chip 2D contrôlaient 38% des revenus 2024. Les flux d'assemblage matures, le support OSAT large et les courbes d'apprentissage de rendement robustes ont assuré un positionnement de coût attractif pour les smartphones et ordinateurs portables grand public. Les packages 3D-IC/SoIC, bien que seulement 11% des expéditions en 2024, ont atteint le TCAC le plus élevé de 9,5% parce que les accélérateurs IA et les CPU lourds en cache exigeaient l'intégration verticale pour surmonter les limites de réticule. Les solutions d'interposeur 2.5D ont maintenu la demande de milieu de gamme, pontant les puces mémoire et logique avec des ponts silicium passifs à large bande passante.
L'emballage fan-out au niveau wafer a progressé dans les portables premium, où l'élimination du substrat a amélioré la z-hauteur et les performances acoustiques. Les lignes SiP/module ont évolué pour les modules radar automobile et télécom, avec des passifs intégrés dans le package réduisant la zone de carte. Le 3.5D XDSiP de Broadcom a exemplifié la convergence de ces tendances en fusionnant la liaison wafer-à-wafer avec des couches de redistribution fan-out au pitch de package. Les feuilles de route de fonderie ont mis en évidence l'empilage SoIC aux nœuds N3 et N4, signalant un changement durable vers le leadership d'emballage 3D dans le marché des substrats IC avancés.
Par nœud de dispositif : les nœuds hérités soutiennent le volume tandis que les nœuds avancés conduisent l'innovation
Les packages supportant des nœuds ≥28 nm possédaient 47% des expéditions 2024 et maintenaient des marges prévisibles pour les fabricants de substrats. Les microcontrôleurs automobiles, les PLC industriels et les puces de connectivité grand public sont restés verrouillés sur ces géométries stables. Cependant, le TCAC le plus raide de 12,3% résidait dans les substrats pour 4 nm et en dessous parce que les smartphones phares et les accélérateurs de centres de données ont migré vers les nœuds de pointe. Ces conceptions exigeaient 18-26 couches métalliques et des structures via-in-pad à l'intérieur des substrats, augmentant les prix de vente moyens plus rapidement que les gains de volume.
Les plateformes 16/14-10 nm de milieu de gamme ont sécurisé les affaires de bande de base télécom et GPU de niveau intermédiaire, équilibrant les performances progressives avec le rendement connu. Les substrats 7-5 nm ont alimenté les SoC Android premium et les mises à niveau de CPU d'ordinateurs portables, absorbant le coût de caractéristiques cuivre plus fines. La feuille de route 18A RibbonFET d'Intel et le lancement 2 nm Gate-All-Around de Samsung ont tous deux spécifié des rails d'alimentation arrière, déplaçant la connectivité puissance-masse de la carte au package et élevant à nouveau la complexité du substrat.

Par industrie d'utilisation finale : la fondation mobile soutient l'accélération IA
Les dispositifs mobiles et grand public ont contribué 43,5% des revenus 2024 et ont souscrit l'utilisation de capacité de base de nombreuses lignes de packages organiques. La pression sur les prix de vente moyens a persisté, mais le volume d'unités pur a maintenu le canal en bonne santé. Le TCAC le plus rapide de 8,4% a tracé vers les centres de données/IA et HPC, où les opérateurs cloud hyperscale ont consommé des GPU multi-chiplets à des taux sans précédent. Ces conceptions utilisaient quatre à six puces logiques et plusieurs piles HBM par package, multipliant l'immobilier de substrat.
L'automobile et le transport ont grimpé en valeur alors que les onduleurs VE et contrôleurs de domaine ont été mis à niveau vers des étages de puissance SiC avec des dissipateurs thermiques céramiques. L'infrastructure IT et télécom a bénéficié des déploiements RAN ouverts et 5G privés nécessitant des modules antenne-dans-package à ondes millimétriques. Les secteurs industriels, médicaux et divers sont restés de niche mais rentables lorsqu'ils sont liés aux spécifications de performance réglementaires telles que la tolérance aux radiations ou la température extrême.
Analyse géographique
L'Asie-Pacifique a capturé 69% du marché des substrats IC avancés en 2024. Les Unimicron, Kinsus et Nan Ya PCB de Taïwan ont retrouvé une croissance à deux chiffres en 2025 alors que la demande de serveurs IA remplaçait la correction d'inventaire qui pesait sur les expéditions 2023. La résurgence du Japon, soutenue par 3,9 trillions JPY (25,5 milliards USD) de subventions, a rétabli Kyushu comme un hub d'emballage ancré par la fab Kumamoto de TSMC. La Corée du Sud a annoncé un plan de cluster intégré de 471 milliards USD conçu pour livrer 7,7 millions de démarrages de wafers par mois d'ici 2030, intégrant des lignes ABF-CoWoS adjacentes aux fabs logiques.[3]Julie Zaugg, "South Korea Lays Out USD 470 Billion Plan to Build Chipmaking Hub," South China Morning Post, scmp.com La Chine a déployé des incitations régionales pour construire la capacité flip-chip et SiP, mais les restrictions d'exportation ont réduit l'accès aux outils, ralentissant l'adoption des noyaux en verre.
Les efforts de localisation avancée de l'Amérique du Nord sous le CHIPS Act. Le campus Arizona de TSMC est passé à une vision de six fabs avec des lignes ABF potentielles colocalisées pour l'atténuation des risques. Entegris a sécurisé jusqu'à 75 millions USD de soutien fédéral pour les médias de filtration utilisés dans le placage cuivre de substrats. Les géants OSAT ont évalué l'expansion américaine pour satisfaire les mandats d'emballage de puces orientés défense, bien que l'inflation salariale reste une préoccupation.
L'Europe s'est concentrée sur les dispositifs automobiles et de puissance. L'installation SiC tchèque d'OnSemi a créé une chaîne d'approvisionnement de bout en bout pour les substrats d'onduleurs à l'intérieur du bloc. L'Allemagne et la France ont considéré des lignes pilotes ABF conjointes pour soutenir les expansions de fonderie par Intel et TSMC. Pendant ce temps, le Vietnam, l'Inde et la Malaisie ont poursuivi des subventions d'assemblage. Amkor a ouvert une usine de 1,6 milliard USD à Bac Ninh, et l'Inde a approuvé 7 600 crores INR (910 millions USD) pour une entreprise OSAT menée par CG Power et Renesas. Ces mouvements ont diversifié le risque géographique dans le marché des substrats IC avancés.

Paysage concurrentiel
Ibiden, Shinko Electric, ASE Technology, Unimicron et SEMCO ont formé le noyau de l'approvisionnement en substrats haut de gamme et détenu des contrats à long terme avec les leaders GPU et CPU. Le monopole virtuel d'Ajinomoto sur la résine ABF a renforcé la dépendance car tout hoquet de production se répercutait à travers toute la chaîne de valeur. Les concurrents ont répondu en finançant des résines alternatives et l'approvisionnement de noyaux en verre, créant une ' alliance anti-Ajinomoto ' informelle qui cherchait à diluer le risque de fournisseur unique. Les investissements stratégiques ont escaladé : ASE a alloué 200 millions USD pour des lignes de panneaux 310 mm pour attraper la demande d'emballage au niveau panel, tandis que SEMCO a équilibré l'expansion ABF avec des essais pilotes en verre.
Les nouveaux entrants émergents ont ciblé des segments de niche. Les entreprises compétentes en substrats céramiques et à noyau métallique ont gagné des design-ins pour les modules VE SiC. Les start-ups ont exploré la liaison directe cuivre-à-cuivre pour contourner les interconnexions de soudure et réduire la z-hauteur.[4]MDPI Editors, "Emerging Copper-to-Copper Bonding Techniques," Nanomaterials, mdpi.com Les fabricants d'outils ont commercialisé le perçage laser à rapport d'aspect élevé pour le verre, abaissant les barrières d'entrée pour les fabricants de substrats plus petits. Les portefeuilles de PI ont élargi autour de la modélisation du stress thermique et de la prédiction de déformation, signalant un passage de la concurrence de capacité vers le savoir-faire de processus.
La stratégie client a également évolué. Les fournisseurs de services cloud ont exécuté des accords-cadres pluriannuels avec les fournisseurs de substrats afin qu'ils puissent garantir l'approvisionnement CoWoS aux partenaires GPU. Les fournisseurs Tier-1 automobiles ont verrouillé des engagements de substrats céramiques cinq ans à l'avance pour sécuriser les lancements d'onduleurs VE. Pris ensemble, le marché des substrats IC avancés s'est déplacé d'une économie purement axée sur le volume vers un écosystème basé sur le partenariat où l'engagement technologique précoce se traduisait par une priorité d'allocation.
Leaders de l'industrie des substrats IC avancés
-
ASE Kaohsiung (ASE Inc.)
-
AT&S Austria Technologies & Systemtechnik AG
-
Siliconware Precision Industries Co. Ltd
-
TTM Technologies Inc.
-
Ibiden Co. Ltd
- *Avis de non-responsabilité : les principaux acteurs sont triés sans ordre particulier
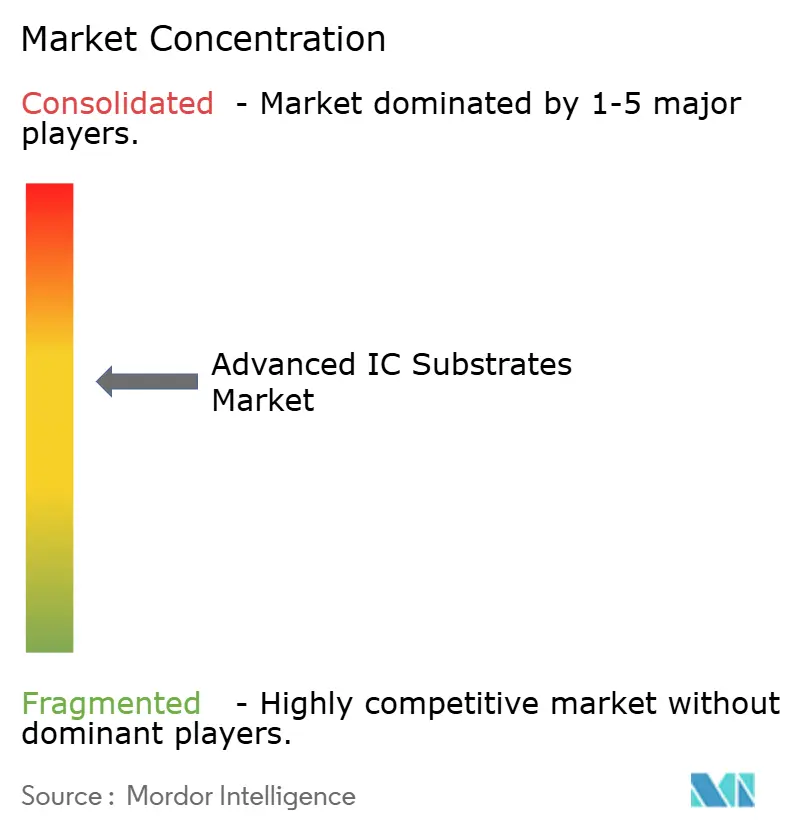
Développements récents de l'industrie
- Juillet 2025 : Intel a arrêté son programme interne de substrats en verre et a décidé de s'approvisionner à l'extérieur, visant à réduire les dépenses R&D et améliorer les marges de fonderie.
- Juin 2025 : ASE Technology a considéré une nouvelle capacité d'emballage avancé américaine et a réservé 2,5 milliards USD pour l'expansion 2025 pour satisfaire la demande de puces IA.
- Mai 2025 : Samsung Electro-Mechanics a commencé la production de masse de substrats ABF pour les accélérateurs IA et a initié des essais de substrats en verre.
- Mai 2025 : TSMC a décrit neuf nouvelles usines de fabrication et d'emballage et confirmé des plans pour doubler la capacité CoWoS.
Portée du rapport sur le marché mondial des substrats IC avancés
Les substrats IC servent de connexion entre la ou les puces IC et le PCB à travers un réseau conducteur de traces et de trous. Les substrats IC supportent des fonctions critiques, incluant le support et la protection de circuit, la dissipation thermique, et la distribution de signal et d'alimentation.
Le marché des substrats IC avancés est segmenté par type, application et géographie. Par type, le marché est divisé en FC BGA et FC CSP. Par application, le marché est segmenté en mobile et grand public, automobile et transport, IT et télécom, et autres applications telles que la santé, l'infrastructure, l'aérospatiale et la défense. Par géographie, le marché est segmenté en États-Unis, Chine, Japon, Corée du Sud, Taïwan, et reste du monde. Les tailles et prévisions de marché sont fournies en termes de valeur (USD) pour tous les segments.
| FC-BGA |
| FC-CSP |
| BGA/LGA organique |
| CSP rigide-flexible et flexible |
| Autres |
| ABF |
| BT |
| Verre |
| LTCC / HTCC |
| Céramique |
| Flip-chip 2D |
| Interposeur 2,5D |
| 3D-IC / SoIC |
| WLP fan-out |
| SiP / Module |
| ≥28 nm |
| 16/14-10 nm |
| 7-5 nm |
| 4 nm et en dessous |
| Mobile et grand public |
| Automobile et transport |
| Infrastructure IT et télécom |
| Centre de données / IA et HPC |
| Industriel, médical et autres |
| Amérique du Nord | États-Unis | |
| Canada | ||
| Amérique du Sud | Brésil | |
| Reste de l'Amérique du Sud | ||
| Europe | Allemagne | |
| France | ||
| Royaume-Uni | ||
| Italie | ||
| Espagne | ||
| Russie | ||
| Reste de l'Europe | ||
| Asie-Pacifique | Chine | |
| Japon | ||
| Corée du Sud | ||
| Taïwan | ||
| Inde | ||
| Reste de l'Asie-Pacifique | ||
| Moyen-Orient et Afrique | Moyen-Orient | Arabie saoudite |
| Émirats arabes unis | ||
| Turquie | ||
| Reste du Moyen-Orient | ||
| Afrique | Afrique du Sud | |
| Nigeria | ||
| Reste de l'Afrique | ||
| Par type de substrat | FC-BGA | ||
| FC-CSP | |||
| BGA/LGA organique | |||
| CSP rigide-flexible et flexible | |||
| Autres | |||
| Par matériau de noyau | ABF | ||
| BT | |||
| Verre | |||
| LTCC / HTCC | |||
| Céramique | |||
| Par technologie d'emballage | Flip-chip 2D | ||
| Interposeur 2,5D | |||
| 3D-IC / SoIC | |||
| WLP fan-out | |||
| SiP / Module | |||
| Par nœud de dispositif (nm) | ≥28 nm | ||
| 16/14-10 nm | |||
| 7-5 nm | |||
| 4 nm et en dessous | |||
| Par industrie d'utilisation finale | Mobile et grand public | ||
| Automobile et transport | |||
| Infrastructure IT et télécom | |||
| Centre de données / IA et HPC | |||
| Industriel, médical et autres | |||
| Par géographie | Amérique du Nord | États-Unis | |
| Canada | |||
| Amérique du Sud | Brésil | ||
| Reste de l'Amérique du Sud | |||
| Europe | Allemagne | ||
| France | |||
| Royaume-Uni | |||
| Italie | |||
| Espagne | |||
| Russie | |||
| Reste de l'Europe | |||
| Asie-Pacifique | Chine | ||
| Japon | |||
| Corée du Sud | |||
| Taïwan | |||
| Inde | |||
| Reste de l'Asie-Pacifique | |||
| Moyen-Orient et Afrique | Moyen-Orient | Arabie saoudite | |
| Émirats arabes unis | |||
| Turquie | |||
| Reste du Moyen-Orient | |||
| Afrique | Afrique du Sud | ||
| Nigeria | |||
| Reste de l'Afrique | |||
Questions clés auxquelles répond le rapport
Quelle était la taille du marché des substrats IC avancés en 2025 ?
La taille du marché des substrats IC avancés a atteint 10,66 milliards USD en 2025.
Quelle région a dominé les revenus en 2024 ?
L'Asie-Pacifique a mené avec une part de 69% des ventes mondiales en 2024.
Pourquoi les substrats en verre attirent-ils l'attention ?
Le verre offre une planéité et une stabilité thermique supérieures, permettant des nombres de couches plus élevés, et devrait croître à un TCAC de 14,1% jusqu'en 2030.
Comment les contraintes d'approvisionnement ABF affecteront-elles la croissance ?
Un écart d'approvisionnement ABF de 20% devrait plafonner la production à court terme jusqu'à ce que de nouvelles capacités entrent en ligne en 2026, réduisant le TCAC prévu d'environ 1,4%.
Quel segment d'utilisation finale croît le plus rapidement ?
Les applications de centres de données/IA et HPC se développent à un TCAC de 8,4% alors que les fournisseurs cloud déploient plus d'accélérateurs IA.
Quel est l'impact à long terme de l'intégration hétérogène ?
Les architectures de chiplets miniaturisées devraient ajouter 1,2% au TCAC du marché sur les quatre prochaines années en stimulant la demande de substrats multicouches complexes.
Dernière mise à jour de la page le:



