
Phân tích thị trường thiết bị gắn khuôn APAC
Thị trường thiết bị gắn khuôn dự kiến sẽ đạt tốc độ CAGR là 15,3% trong giai đoạn dự báo. Thị trường dự kiến sẽ được hưởng lợi từ các cơ hội lắp ráp và đóng gói được tạo ra bởi các xu hướng nêu dưới đây.
- Trọng tâm đáng kể cho vòng đầu tư tiếp theo của các nhà cung cấp trên thị trường là phát triển các giải pháp đóng gói và liên kết khuôn cho điện thoại thông minh tương thích 5G nhỏ hơn và có độ phức tạp cao. 5G là nền tảng kết nối thống nhất cho sự đổi mới trong tương lai, cho phép truy cập đám mây an toàn liên tục ở tốc độ truyền dữ liệu và video cao hơn đáng kể.
- Việc người dùng sử dụng khả năng 5G sẽ mở rộng các hoạt động băng thông rộng di động và tăng tốc việc sử dụng trí tuệ nhân tạo cho Internet Vạn Vật. Tương tự như vậy, quy trình đóng gói ở cấp độ nền và tấm wafer cho các ứng dụng người dùng cuối trong ô tô, điện toán, 5G và Internet di động đã thúc đẩy ngành công nghiệp bán dẫn chứng kiến sự phục hồi về vốn đầu tư cho bộ nhớ và logic.
- Công ty đã chia sẻ kế hoạch tăng vốn đầu tư trung và dài hạn hướng tới các ứng dụng bán dẫn và kiểm lâm mở rộng. Trong khi đó, theo Shibaura, việc tích cực phát triển thiết bị liên kết tốc độ cao, độ chính xác cao cho FOWLP / PLP và μLED đang được chú trọng trong thiết bị lắp ráp bán dẫn.
- BESI đã chia sẻ kế hoạch đầu tư vào các công nghệ lắp ráp mới như FOWLP, TCB, TSV, khuôn siêu mỏng, liên kết lai, diện tích lớn, đúc cấp wafer, năng lượng mặt trời và mạ pin 3D-lithium-ion cho xã hội kỹ thuật số mới. Dòng sản phẩm thiết bị gắn khuôn của nó bao gồm một chip đơn, nhiều chip, đa mô-đun, chip lật, TCB, FOWLP, hệ thống liên kết khuôn lai và hệ thống phân loại khuôn.
- Tuy nhiên, một điều đáng lo ngại là triển vọng tiếp tục không chắc chắn do ảnh hưởng của sự lây lan toàn cầu của dịch bệnh Covid-19. Việc phong tỏa và tạm dừng sản xuất trên khắp châu Á-Thái Bình Dương do sự bùng phát của dịch bệnh COVID-19 đã ảnh hưởng đáng kể đến việc sản xuất và tiêu thụ chất bán dẫn. Với phần lớn IDS và các xưởng đúc nằm trong khu vực, tác động của việc ngừng hoạt động đã dẫn đến việc giảm chi tiêu cho đầu tư vốn. Điều này có thể tác động đến thị trường được nghiên cứu và dự kiến sẽ có sự phục hồi chậm lại vào năm 2021.
Xu hướng thị trường thiết bị gắn khuôn APAC
CIS dự kiến sẽ chứng kiến sự tăng trưởng đáng kể
- Cảm biến hình ảnh CMOS đã và đang cung cấp các chức năng camera trong điện thoại thông minh và các sản phẩm khác, và khi nhu cầu mở rộng quy mô tăng lên, các vấn đề sản xuất liên quan trong nhà máy sẽ phát sinh.
- Hiệu suất dữ liệu băng thông cao hơn đã tăng từ 3G lên 4G và hiện tại, lên 5G, nhu cầu về máy ảnh chất lượng cao hơn đã tăng lên. Xu hướng này đã thúc đẩy các kỹ thuật xếp chồng cảm biến hình ảnh CMOS dựa trên nhu cầu về số lượng điểm ảnh cao hơn và độ phân giải tốt hơn. Ngoài những xu hướng này, các lĩnh vực ID sinh trắc học, cảm biến 3D và ứng dụng thị giác con người nâng cao đã thúc đẩy tăng trưởng phân khúc.
- Nhu cầu của khách hàng về máy ảnh lớn hơn và tốt hơn dẫn đến nhiều cảm biến hơn với kích thước khuôn lớn hơn. Bên cạnh việc chia tỷ lệ pixel, cảm biến hình ảnh CMOS đang trải qua những cải tiến khác như xếp chồng khuôn. Các nhà cung cấp trên thị trường được nghiên cứu cũng đang sử dụng các công nghệ kết nối khác nhau, chẳng hạn như vias xuyên silicon (TSV), liên kết lai và pixel-to-pixel cho cùng một loại.
- Ví dụ, trong liên kết lai, các khuôn được kết nối bằng cách sử dụng các kết nối đồng-đồng. Đối với điều này, hai tấm wafer được xử lý trong một nhà máy. Một là wafer logic, trong khi cái còn lại là wafer mảng pixel. Hai tấm wafer được nối với nhau bằng liên kết điện môi với điện môi, sau đó là kết nối kim loại với kim loại.
- Công nghệ DBI liên kết lai, công nghệ độc quyền của Xperi, đang được Samsung sử dụng đáng kể để chế tạo cảm biến hình ảnh CMOS cho điện thoại của mình. Công nghệ này dành cho Cảm biến hình ảnh CMOS tạo điều kiện cho việc liên kết vĩnh viễn Cu-Cu ở nhiệt độ phòng, ủ ở nhiệt độ thấp (khoảng 300°C) và không có quá trình liên kết áp suất bên ngoài (điện môi/kim loại).
- Trước đó, công nghệ liên kết trực tiếp đã đóng vai trò hỗ trợ trong việc hiện thực hóa BSI chia tỷ lệ pixel (chiếu sáng mặt sau) và BSI xếp chồng với nhiều biến thể thế hệ do Xperifor dẫn đầu trong hơn 15 năm.

LED chiếm lĩnh thị phần
- Vật liệu gắn khuôn đóng vai trò quan trọng trong hiệu suất và độ tin cậy của đèn LED công suất trung bình, cao và siêu cao. Nhu cầu về thiết bị gắn khuôn ngày càng tăng cùng với tỷ lệ thâm nhập của đèn LED ngày càng tăng. Việc lựa chọn vật liệu gắn khuôn phù hợp cho cấu trúc và ứng dụng chip cụ thể phụ thuộc vào nhiều cân nhắc khác nhau, bao gồm quy trình đóng gói (công suất và hiệu suất), hiệu suất (công suất tản nhiệt và công suất phát sáng), độ tin cậy (độ duy trì quang thông) và chi phí. Các vật liệu epoxies chứa đầy vàng, thiếc, bạc, chất hàn, silicon và thiêu kết đều đã được sử dụng để gắn khuôn LED.
- SFE cung cấp phương pháp liên kết Keo Epoxy trong đó máy LED Epoxy Die Bonder có thời gian chỉ số là 0,2 Giây /Chu kỳ (Tốc độ hoạt động 90%) với kích thước chip đạt tiêu chuẩn 250 * 250, cung cấp khả năng nhận dạng khung chì thông qua 2 Camera. Chức năng phần mềm của nó cung cấp chức năng giảng dạy cấp độ tự động gắn kết và nâng cấp.
- Hơn nữa, chất kết dính dẫn điện (chủ yếu là epoxies phủ bạc) tạo thành loại vật liệu gắn nhiệt lớn nhất (theo số đơn vị) cho đèn LED. Chúng tương thích với thiết bị đóng gói phía sau hiện có và mang lại sự cân bằng về chi phí/hiệu suất hấp dẫn (thường lên tới 50 W/mK bộ điều nhiệt có khả năng tương thích phản xạ thứ cấp). Vì chúng dính vào silicon trần nên chúng là vật liệu được ưa chuộng nhất cho khuôn không có quá trình kim loại hóa phía sau như GaN trên silicon.
- Hơn nữa, trên thị trường đèn LED có rất nhiều đối thủ cạnh tranh và ASM là một trong những công ty nổi bật trên thị trường này; Keo dán khuôn tốc độ cao LED Epoxy AD830 chiếm ưu thế trên thị trường đèn LED. Nó nhanh, đáng tin cậy và chính xác với độ chính xác của vị trí khuôn là +/- 1 mil và +/- 3 độ, thời gian chu kỳ cho một con chip nhỏ như 10mil x 10mil là 180 ms, tương đương UPH là 18.000. Nó được trang bị hệ thống kiểm tra sau dán để giám sát thiết bị được dán ở phạm vi vị trí đặt trước.

Tổng quan về ngành thiết bị gắn khuôn APAC
Thị trường thiết bị gắn khuôn APAC có tính cạnh tranh vừa phải, với số lượng lớn người chơi có thị phần nhỏ. Các công ty tiếp tục đổi mới và tham gia vào các quan hệ đối tác chiến lược để duy trì thị phần của mình.
- Tháng 4 năm 2022 - Thúc đẩy Trung tâm Công nghiệp Cách mạng Điện (DER-IC) North East đã nhận được thiết bị từ Inseto, nhà phân phối kỹ thuật công cụ và vật liệu hàng đầu, để cải thiện khả năng điện tử công suất, máy móc và truyền động (PEMD). Máy đục lỗ siêu nhỏ đầu tiên được lắp đặt ở Anh là máy ép thiêu kết AMX P100, là một phần của thiết bị được cung cấp và sẽ cho phép sản xuất các mô-đun công suất cao, có độ tin cậy cao.
- Tháng 6 năm 2022 - Dòng Bonder 7KF mới được West Bond phát triển. Công ty nổi tiếng này thiết kế và sản xuất một dòng máy liên kết dây và máy dập, thiết bị kiểm tra kéo và cắt dây, các bộ phận siêu âm và phụ kiện cho ngành đóng gói vi điện tử. Công cụ tuyệt vời này được tạo ra để xử lý các ứng dụng liên kết khó khăn trong lĩnh vực RF, lò vi sóng, chất bán dẫn, thiết bị lai và thiết bị y tế.
Dẫn đầu thị trường thiết bị gắn khuôn APAC
Palomar Technologies, Inc.
Shinkawa Ltd.
Panasonic Corporation
ASM Pacific Technology Limited
Be Semiconductor Industries N.V.
- * Tuyên bố miễn trừ trách nhiệm: Các Công Ty Thành Công và Quan Trọng được sắp xếp không theo yêu cầu cụ thể nào
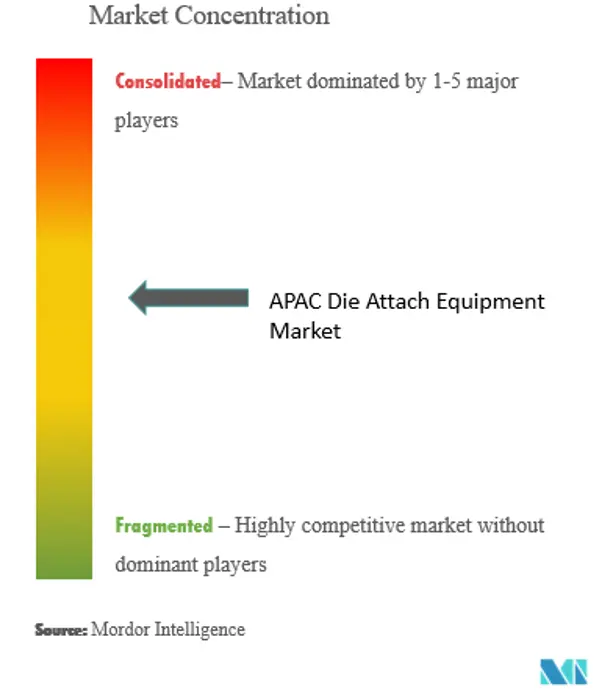
Tin tức thị trường thiết bị gắn khuôn APAC
- Tháng 7 năm 2022 - Theo EV Group (EVG), nhà cung cấp thiết bị in thạch bản và liên kết wafer cho thị trường MEMS, công nghệ nano và chất bán dẫn, một tiến bộ lớn trong liên kết lai và liên kết khuôn với wafer (D2W) đã được thực hiện. Điều này đã được thực hiện bằng cách chứng minh thành công hiệu suất liên kết không có khoảng trống 100% của nhiều khuôn có kích thước khác nhau từ hệ thống 3D trên chip (SoC) đầy đủ trong một quy trình truyền duy nhất bằng GEMINI của EVG. Cho đến nay, việc đạt được thành tích như vậy là một khó khăn lớn đối với liên kết D2W và là rào cản đáng kể để giảm chi phí triển khai tích hợp không đồng nhất.
- Tháng 7 năm 2022 - Sử dụng các mẫu HBM3 đầu tiên do SK Hynix công bố, Global Unichip Corp. (GUC), một ASIC nâng cao hàng đầu, đã tiết lộ rằng giải pháp HBM3 7,2 Gbps của họ đã được chứng minh bằng silicon. Nền tảng này đã được trưng bày trong Gian hàng đối tác tại Hội nghị chuyên đề công nghệ Bắc Mỹ TSMC 2022. Nó có Bộ điều khiển HBM3, PHY, giao diện cố định GLink-2.5D và SerDes 112G. Cả nền tảng tiên tiến TSMC CoWoS-S (bộ chuyển đổi silicon) và CoWoS-R (bộ chuyển đổi hữu cơ) đều hỗ trợ các công nghệ đóng gói.
Phân khúc ngành công nghiệp thiết bị gắn khuôn APAC
Đính kèm khuôn là một quá trình quan trọng trong đóng gói chất bán dẫn. Nó bao gồm tất cả các thiết bị trên nhiều ứng dụng khác nhau và góp phần tăng chi phí lắp ráp. Liên kết khuôn là một quá trình sản xuất được sử dụng trong việc đóng gói chất bán dẫn. Đó là hành động gắn khuôn (hoặc chip) vào chất nền hoặc gói bằng epoxy hoặc chất hàn, còn được gọi là đặt khuôn hoặc gắn khuôn.
Thị trường được phân chia theo Kỹ thuật (Máy dán khuôn (Epoxy/Dính, Eutectic, Hàn, Thiêu kết), Máy dán chip lật (Hàn chọn và đặt/hàn nóng chảy, Nén nhiệt, Liên kết nhiệt âm, Liên kết lai)), Ứng dụng (Bộ nhớ, đèn LED, Logic, Cảm biến hình ảnh CMOS (CIS), Quang điện tử/Quang tử, Thiết bị điện rời rạc, MEMS Cảm biến, Bộ nhớ xếp chồng RF) và Quốc gia (Đài Loan, Trung Quốc, Nhật Bản, Hàn Quốc, Đông Nam Á).
| người yêu | Epoxy/Dính (dán/phim) |
| Eutectic | |
| Hàn | |
| Thiêu kết | |
| Máy dán chip lật | Chọn và đặt/hàn nóng chảy lại |
| Nén nhiệt (TCB) | |
| Liên kết nhiệt âm | |
| Liên kết lai |
| Ký ức |
| DẪN ĐẾN |
| Hợp lý |
| Cảm biến hình ảnh CMOS |
| Quang điện tử / Quang tử học |
| Thiết bị điện rời rạc |
| MEMS & Cảm biến |
| Bộ nhớ xếp chồng & RF |
| Đài Loan |
| Trung Quốc |
| Nhật Bản |
| Hàn Quốc |
| Đông Nam Á |
| Bằng kỹ thuật liên kết | người yêu | Epoxy/Dính (dán/phim) |
| Eutectic | ||
| Hàn | ||
| Thiêu kết | ||
| Máy dán chip lật | Chọn và đặt/hàn nóng chảy lại | |
| Nén nhiệt (TCB) | ||
| Liên kết nhiệt âm | ||
| Liên kết lai | ||
| Ứng dụng | Ký ức | |
| DẪN ĐẾN | ||
| Hợp lý | ||
| Cảm biến hình ảnh CMOS | ||
| Quang điện tử / Quang tử học | ||
| Thiết bị điện rời rạc | ||
| MEMS & Cảm biến | ||
| Bộ nhớ xếp chồng & RF | ||
| Quốc gia | Đài Loan | |
| Trung Quốc | ||
| Nhật Bản | ||
| Hàn Quốc | ||
| Đông Nam Á | ||
Câu hỏi thường gặp về nghiên cứu thị trường thiết bị gắn khuôn APAC
Quy mô Thị trường Thiết bị Đính kèm Khuôn APAC hiện tại là bao nhiêu?
Thị trường Thiết bị đính kèm khuôn APAC dự kiến sẽ đạt tốc độ CAGR là 15,30% trong giai đoạn dự báo (2024-2029)
Ai là người đóng vai trò chủ chốt trong Thị trường Thiết bị Đính kèm Khuôn APAC?
Palomar Technologies, Inc., Shinkawa Ltd., Panasonic Corporation, ASM Pacific Technology Limited, Be Semiconductor Industries N.V. là những công ty lớn hoạt động tại Thị trường Thiết bị Đính kèm Khuôn APAC.
Thị trường thiết bị gắn khuôn APAC này hoạt động trong những năm nào?
Báo cáo đề cập đến quy mô lịch sử thị trường của Thị trường Thiết bị Đính kèm Khuôn APAC trong các năm 2019, 2020, 2021, 2022 và 2023. Báo cáo cũng dự báo quy mô Thị trường Thiết bị Đính kèm Khuôn APAC trong các năm 2024, 2025, 2026, 2027, 2028 và 2029.
Trang được cập nhật lần cuối vào:
Báo cáo bán chạy nhất của chúng tôi
Báo cáo ngành thiết bị gắn khuôn APAC
Số liệu thống kê về thị phần, quy mô và tốc độ tăng trưởng doanh thu của Thiết bị gắn khuôn APAC năm 2024, do Mordor Intelligence™ Industry Report tạo ra. Phân tích Thiết bị đính kèm khuôn APAC bao gồm triển vọng dự báo thị trường đến năm 2029 và tổng quan về lịch sử. Nhận mẫu phân tích ngành này dưới dạng bản tải xuống báo cáo PDF miễn phí.



